Пороговое напряжение - Threshold voltage

В пороговое напряжение, обычно сокращенно Vth, из полевой транзистор (FET) - минимальное напряжение затвор-исток VGS (th) это необходимо для создания проводящего пути между выводами истока и стока. Это важный коэффициент масштабирования для поддержания энергоэффективности.
Обращаясь к переходной полевой транзистор (JFET) пороговое напряжение часто называют «напряжением отсечки». Это несколько сбивает с толку, поскольку отщипнуть применительно к полевой транзистор с изолированным затвором (IGFET) относится к защемление канала что приводит к насыщению тока при высоком смещении исток – сток, даже если ток никогда не отключен. В отличие от отщипнуть, период, термин пороговое напряжение однозначно и относится к той же концепции в любом полевом транзисторе.
Основные принципы
В n-канал режим улучшения устройств, проводящий канал внутри транзистора не существует, и для его создания необходимо положительное напряжение затвор-исток. Положительное напряжение привлекает свободно плавающие электроны внутри тела к затвору, образуя проводящий канал. Но сначала необходимо привлечь достаточное количество электронов около затвора, чтобы противодействовать ионам легирующей примеси, добавленным в тело полевого транзистора; это формирует регион без операторов мобильной связи, называемый область истощения, а напряжение, при котором это происходит, есть пороговое напряжение полевого транзистора. Дальнейшее увеличение напряжения затвор-исток привлечет к затвору еще больше электронов, которые могут создать токопроводящий канал от истока к стоку; этот процесс называется инверсия. Обратное верно для p-канального МОП-транзистора "улучшенного режима". Когда VGS = 0, устройство выключено и канал открыт / непроводящий. Приложение отрицательного (-ve) напряжения затвора к полевому МОП-транзистору p-типа «улучшенного режима» увеличивает проводимость каналов, включая его.
Напротив, n-канальный режим истощения устройства имеют токопроводящий канал, естественно существующий внутри транзистора. Соответственно, срок пороговое напряжение не всегда применяется к превращение такие устройства включены, но вместо этого используется для обозначения уровня напряжения, при котором канал достаточно широк, чтобы позволить электронам свободно течь. Этот порог легкости потока также применяется к р-канал режим истощения устройства, в которых отрицательное напряжение от затвора к телу / источнику создает слой обеднения, отталкивая положительно заряженные дырки от границы раздела затвор-изолятор / полупроводник, оставляя открытой без носителей область неподвижных отрицательно заряженных ионов-акцепторов.
Для n-канального обедненного МОП-транзистора отрицательное напряжение затвор-исток, -VGS будет истощать (отсюда и его название) проводящий канал своими свободными электронами, переключая транзистор в положение «ВЫКЛ». Точно так же для МОП-транзистора с p-каналом "обедненного режима" положительное напряжение затвор-исток, + VGS будет истощать канал своих свободных отверстий, переводя его в положение "OFF".
В широких планарных транзисторах пороговое напряжение практически не зависит от напряжения сток-исток и, следовательно, является четко определенной характеристикой, однако в современных полевых МОП-транзисторах нанометрового размера оно менее четкое из-за снижение барьера, вызванное дренажем.

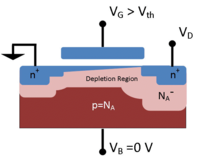
На рисунках исток (слева) и сток (справа) обозначены п + для обозначения сильно легированных (голубых) n-областей. Легирующая добавка обедненного слоя обозначена NА− чтобы указать, что ионы в (розовом) слое обеднения отрицательно заряжены и дырок очень мало. В (красной) части количество отверстий р = NА делая основной заряд нейтральным.
Если напряжение затвора ниже порогового напряжения (левый рисунок), транзистор "улучшенного режима" выключается и в идеале нет Текущий от стока до истока транзистора. Фактически, ток присутствует даже при смещении затвора ниже порога (подпороговая утечка ) ток, хотя он невелик и экспоненциально изменяется в зависимости от смещения затвора.
Если напряжение затвора выше порогового напряжения (правый рисунок), транзистор «улучшающего режима» включается из-за наличия большого количества электронов в канале на границе оксид-кремний, создавая канал с низким сопротивлением, в котором может происходить заряд. течь от слива к истоку. Для напряжений, значительно превышающих пороговое значение, такая ситуация называется сильной инверсией. Канал сужается, когда VD > 0 потому что падение напряжения из-за тока в резистивном канале уменьшает оксидное поле, поддерживающее канал, по мере приближения к стоку.
Эффект тела
В эффект тела - изменение порогового напряжения на величину, примерно равную изменению напряжения в объеме источника, , потому что тело влияет на пороговое напряжение (когда оно не привязано к источнику). Это можно рассматривать как вторые ворота, и иногда их называют задние ворота, и соответственно эффект тела иногда называют эффект заднего хода.[1]
Для полевого МОП-транзистора nMOS с расширенным режимом объемный эффект при пороговом напряжении вычисляется в соответствии с моделью Шичмана-Ходжеса,[2] что верно для старых технологических узлов,[требуется разъяснение ] используя следующее уравнение:
куда - пороговое напряжение при наличии смещения подложки, - смещение подложки от источника к телу, - поверхностный потенциал, а - пороговое напряжение для нулевого смещения подложки, - параметр эффекта тела, толщина оксида, оксид диэлектрическая проницаемость, - диэлектрическая проницаемость кремния, - концентрация допинга, является элементарный заряд.
Зависимость от толщины оксида
В данном технологическом узле, например 90-нм CMOS процесс, пороговое напряжение зависит от выбора оксида и от толщина оксида. Используя приведенные выше формулы тела, прямо пропорциональна , и , который является параметром толщины оксида.
Таким образом, чем меньше толщина оксида, тем ниже пороговое напряжение. Хотя это может показаться улучшением, оно не обходится без затрат; потому что чем тоньше толщина оксида, тем выше подпороговая утечка ток через устройство будет. Следовательно, спецификация конструкции для толщины оксида затвора 90 нм была установлена на уровне 1 нм, чтобы контролировать ток утечки.[3] Такой вид туннелирования называется туннелированием Фаулера-Нордхейма.[4]
куда и константы и - электрическое поле через оксид затвора.
До масштабирования конструктивных элементов до 90 нм обычным решением этой проблемы был подход с двумя оксидами для создания толщины оксида. При использовании техпроцесса 90 нм в некоторых случаях был принят подход тройного оксида.[5] Один стандартный тонкий оксид используется для большинства транзисторов, другой - для ячеек драйвера ввода-вывода, а третий - для транзисторных ячеек с памятью и проходом. Эти различия основаны исключительно на характеристиках толщины оксида на пороговом напряжении КМОП-технологий.
Температурная зависимость
Как и в случае, когда толщина оксида влияет на пороговое напряжение, температура влияет на пороговое напряжение КМОП-устройства. Раскладывая часть уравнения в эффект тела раздел
куда составляет половину контактного потенциала, является Постоянная Больцмана, это температура, это элементарный заряд, - параметр допирования и - собственный параметр легирования подложки.
Мы видим, что поверхностный потенциал имеет прямую зависимость от температуры. Выше видно, что пороговое напряжение не имеет прямой зависимости, но не зависит от эффектов. Это изменение обычно составляет от -4 мВ / К до -2 мВ / К в зависимости от уровня легирования.[6] Для изменения 30 ° C это приводит к значительному отклонению от проектного параметра 500 мВ, обычно используемого для 90-нм технологического узла.
Зависимость от случайного колебания примеси
Случайное колебание примеси (RDF) - это форма изменения процесса в результате изменения концентрации имплантированной примеси. В MOSFET-транзисторах RDF в области канала может изменять свойства транзистора, особенно пороговое напряжение. В более новых технологических процессах RDF имеет больший эффект, потому что общее количество легирующих добавок меньше.[7]
Проводятся исследовательские работы по подавлению флуктуации примеси, которая приводит к изменению порогового напряжения между устройствами, подвергающимися одинаковому производственному процессу.[8]
Смотрите также
Рекомендации
- ^ Марко Делауренти, кандидатская диссертация, Методы проектирования и оптимизации быстродействующих схем СБИС (1999)) В архиве 2014-11-10 на Wayback Machine
- ^ Отчет NanoDotTek NDT14-08-2007, 12 августа 2007 г.
- ^ Сугии, Ватанабэ и Сугатани. Конструкция транзисторов для поколений 90 нм и не только. (2002)
- ^ С. М. Зе, Физика полупроводниковых приборов, Второе издание, Нью-Йорк: Уайли и сыновья, 1981, стр. 496–504.
- ^ Анил Теликепалли, Xilinx Inc, Соображения по мощности при проектировании с 90 нм ПЛИС (2005))[1]
- ^ Весте и Эшрагян, Принципы проектирования CMOS VLSI: системная перспектива, Второе издание, (1993), стр.48. ISBN 0-201-53376-6
- ^ Асенов, А. Хуанг,Произвольное понижение порогового напряжения и флуктуации порогового напряжения, вызванные легирующими добавками, в полевых МОП-транзисторах с размером менее 0,1 мкм: исследование с использованием трехмерного «атомистического» моделирования, Электронные устройства, Транзакции IEEE, 45, выпуск: 12
- ^ Асенов, А. Хуанг,Подавление случайных флуктуаций порогового напряжения, вызванных легирующими добавками, в полевых МОП-транзисторах размером менее 0,1 мкм с эпитаксиальными и δ-легированными каналами, Электронные устройства, Транзакции IEEE, 46, выпуск: 8
внешняя ссылка
- Онлайн-лекция на тему: Пороговое напряжение и емкость MOSFET доктор Лундстрем






















