МОП-транзистор - MOSFET - Wikipedia

В полевой транзистор металл – оксид – полупроводник (МОП-транзистор, МОП-транзистор, или же МОП-транзистор), также известный как транзистор металл – оксид – кремний (МОП-транзистор, или же MOS),[1] это тип ворот с изоляцией полевой транзистор это сфабриковано контролируемое окисление из полупроводник обычно кремний. Напряжение крытые ворота определяет электрическая проводимость устройства; эта способность изменять проводимость в зависимости от приложенного напряжения может быть использована для усиление или переключение электронные сигналы.
MOSFET был изобретен Мохамед М. Аталла и Давон Канг в Bell Labs в 1959 году и впервые представлен в 1960 году. Это основной строительный блок современной электроники, а наиболее часто производимое устройство в истории, примерно 13 секстиллион (1.3×1022) МОП-транзисторы, произведенные в период с 1960 по 2018 год.[2] Это доминанта полупроводниковый прибор в цифровой и аналог интегральные схемы (ИС),[3] и самый распространенный силовое устройство.[4] Это компактный транзистор который был миниатюризирован и производился серийно для широкий спектр приложений, революционизирующий электронная промышленность и мировой экономики, а также центральное место в цифровая революция, кремниевый век и информационный век. Масштабирование и миниатюризация полевых МОП-транзисторов с 1960-х гг. Способствовали быстрому экспоненциальному росту электронных полупроводниковых технологий и позволяют ИС высокой плотности Такие как микросхемы памяти и микропроцессоры. MOSFET считается «рабочей лошадкой» электронной промышленности.
Ключевым преимуществом полевого МОП-транзистора является то, что он почти не требует входного тока для управления током нагрузки по сравнению с биполярные переходные транзисторы (БЮТ). В режим улучшения MOSFET, напряжение, приложенное к выводу затвора, может увеличить проводимость из состояния «нормально выключено». В режим истощения МОП-транзистор, напряжение, приложенное к затвору, может снизить проводимость от «нормально включенного» состояния.[5] МОП-транзисторы также обладают высокой масштабируемостью с увеличением миниатюризация, и его можно легко уменьшить до меньших размеров. Они также имеют более высокую скорость переключения (идеально для цифровые сигналы ), гораздо меньшего размера, потребляют значительно меньше энергии и обеспечивают гораздо более высокую плотность (идеально для крупномасштабная интеграция ) по сравнению с БЮТ. МОП-транзисторы также дешевле и имеют относительно простые этапы обработки, что приводит к высоким выход продукции.
МОП-транзисторы могут быть изготовлены как часть MOS интегральная схема микросхемы или как дискретные устройства MOSFET (например, силовой MOSFET ), и может иметь форму одностворчатого или мульти-ворота транзисторы. Поскольку полевые МОП-транзисторы могут быть изготовлены с р-тип или же полупроводники n-типа (PMOS или же Логика NMOS соответственно), дополнительные пары полевых МОП-транзисторов могут использоваться для создания схем переключения с очень низким потребляемая мощность: CMOS (Дополнительная MOS) логика.
Название «металл – оксид – полупроводник» (МОП) обычно относится к металлические ворота, оксидная изоляция и полупроводник (обычно кремний).[1] Однако «металл» в названии MOSFET иногда используется неверно, потому что материал затвора также может быть слоем поликремний (поликристаллический кремний). Вместе с окись, разные диэлектрик материалы также могут быть использованы для получения прочных каналов с меньшими приложенными напряжениями. В МОП конденсатор также является частью структуры MOSFET.


Ранняя история
Фон
Основной принцип полевой транзистор (FET) был впервые предложен австро-венгерским физиком Юлиус Эдгар Лилиенфельд в 1926 году, когда он подал первую патент для полевого транзистора с изолированным затвором.[6] В течение следующих двух лет он описал различные структуры полевых транзисторов. В его MOS-конфигурации алюминий обозначал M, оксид алюминия - O, а сульфид меди использовался как полупроводник. Однако он не смог построить практически работающее устройство на полевом транзисторе.[7] Концепция полевого транзистора позже была выдвинута немецким инженером. Оскар Хайль в 1930-е годы и американский физик Уильям Шокли в 1940-е гг.[8] В то время не существовало работающего практического полевого транзистора, и ни одно из этих ранних предложений полевого транзистора не касалось термически окисленный кремний.[7]
Полупроводниковые компании изначально ориентировались на биполярные переходные транзисторы (БЮТ) в первые годы полупроводниковая промышленность. Однако переходной транзистор был относительно громоздким устройством, которое было трудно изготовить на массовое производство основы, что ограничивало его рядом специализированных приложений. Полевые транзисторы теоретически рассматривались как потенциальная альтернатива переходным транзисторам, но исследователи не смогли создать практические полевые транзисторы, в основном из-за проблемного барьера поверхностного состояния, который препятствовал внешнему воздействию. электрическое поле от проникновения в материал.[9] В 1950-х годах исследователи в значительной степени отказались от концепции полевого транзистора и вместо этого сосредоточились на технологии BJT.[10]
В 1955 г. Карл Фрош и Линкольн Деррик случайно покрыл поверхность силиконом вафля со слоем диоксид кремния. Они показали, что оксидный слой предотвращает попадание одних примесей в кремниевую пластину, в то время как допускает другие, таким образом обнаружив пассивирующий эффект окисление на поверхности полупроводника. Их дальнейшая работа продемонстрировала, как вытравить небольшие отверстия в оксидном слое для диффузии легирующих примесей в выбранные области кремниевой пластины. В 1957 году они опубликовали исследовательскую работу и запатентовали свою методику, обобщающую их работу. Разработанный ими метод известен как маскирование диффузии оксидов, которое позже будет использоваться в изготовление устройств MOSFET. В Bell Labs сразу же осознали важность техники Фроша, поскольку оксиды кремния гораздо более стабильны, чем оксиды германия, имеют лучшие диэлектрические свойства и в то же время могут использоваться в качестве диффузионной маски. Результаты их работы распространились по Bell Labs в виде записок BTL до того, как были опубликованы в 1957 году. Shockley Semiconductor, Шокли разослал препринт своей статьи в декабре 1956 года всем своим руководящим сотрудникам, включая Жан Хорни.[9][11][12]
Изобретение


Мохамед М. Аталла в Bell Labs занимался проблемой поверхностных состояний в конце 1950-х годов. Он взял работу Фроша по окислению, пытаясь пассивировать поверхность из кремний сквозь образование оксидного слоя над ним. Он думал, что выращивание очень тонких качественных термически выращенных SiО2 поверх чистой кремниевой пластины нейтрализует поверхностные состояния в достаточной степени, чтобы создать практический рабочий полевой транзистор. Он написал свои открытия в своих записках по BTL в 1957 году, прежде чем представить свою работу на Электрохимическое общество встреча в 1958 г.[13][14][15][16][8] Это было важным событием, сделавшим возможным использование технологии МОП и кремния. Интегральная схема (IC) чипы.[17] В следующем году, Джон Л. Молл описал МОП конденсатор в Стэндфордский Университет.[18] Сотрудникам Аталлы J.R. Ligenza и W.G. Spitzer, изучавшим механизм термически выращенных оксидов, удалось получить высококачественный Si /SiO2 куча,[7] Аталла и Канг использовали свои открытия.[19][20]
MOSFET был изобретен, когда Мохамед Аталла и Давон Канг[14][13] успешно сфабрикованный первое работающее устройство MOSFET в ноябре 1959 года.[21] Устройство защищено двумя патентами, каждый из которых был подан Аталлой и Кангом в марте 1960 года.[22][23][24][25] Они опубликовали свои результаты в июне 1960 г.[26] на конференции по твердотельным устройствам, проходившей в Университет Карнеги Меллон.[27] В том же году Аталла предложил использовать полевые МОП-транзисторы для создания MOS интегральная схема (MOS IC), отмечая простоту изготовления MOSFET.[9]
Коммерциализация
Преимущество полевого МОП-транзистора состояло в том, что он был относительно компактным и простым в массовом производстве по сравнению с конкурирующим транзистором с плоским переходом.[28] но MOSFET представлял собой радикально новую технологию, внедрение которой потребовало бы отказа от прогресса, достигнутого Bell в разработке биполярный переходной транзистор (BJT). MOSFET изначально был медленнее и менее надежен, чем BJT.[29]
В начале 1960-х годов программы исследования МОП-технологий были созданы Fairchild Semiconductor, RCA лаборатории, General Microelectronics (во главе с бывшим инженером Fairchild Фрэнк Ванласс ) и IBM.[30] В 1962 году Стив Р. Хофштейн и Фред П. Хейман из RCA построили первый MOS интегральная схема чип. В следующем году они собрали все предыдущие работы по полевым транзисторам и представили теорию работы полевых транзисторов.[31] CMOS был разработан Чи-Тан Сах и Фрэнк Ванласс в Fairchild в 1963 году.[32] Первая интегральная схема CMOS была позже построена в 1968 г. Альберт Медвин.[33]
Первое официальное публичное объявление о существовании MOSFET в качестве потенциальной технологии было сделано в 1963 году. Впервые он был коммерциализирован General Microelectronics в мае 1964 года, а затем Fairchild в октябре 1964 года. Первый контракт GMe на MOS был заключен с НАСА, который использовал полевые МОП-транзисторы для космический корабль и спутники в Платформа межпланетного мониторинга (IMP) и Программа исследователей.[30] Первые полевые МОП-транзисторы, коммерциализированные General Microelectronics и Fairchild, были р-канал (PMOS ) устройства для логических и коммутационных приложений.[8] К середине 1960-х гг. RCA использовали полевые МОП-транзисторы в своих потребительских товарах, в том числе FM радио, телевидение и усилители.[34] В 1967 году исследователи Bell Labs Роберт Кервин, Дональд Кляйн и Джон Сарас разработал самовыравнивающиеся ворота (кремниевый затвор) МОП-транзистор, который исследователи Fairchild Федерико Фаггин и Том Кляйн адаптированы для интегральные схемы в 1968 г.[35]
MOS революция
Развитие MOSFET привело к революции в электроника технология, названная революцией MOS[36] или революция MOSFET,[37] подпитка технологического и экономического роста первых полупроводниковая промышленность.
Влияние MOSFET стало коммерчески значимым с конца 1960-х годов.[38] Это привело к революции в электронная промышленность, который с тех пор повлиял на повседневную жизнь почти во всех отношениях.[39] Изобретение полевого МОП-транзистора было названо рождением современного электроника[40] и был центральным в революции микрокомпьютеров.[41]
Важность
МОП-транзистор является основой современной электроники,[42] и является основным элементом большинства современных электронное оборудование.[43] Это самый распространенный транзистор в электронике,[13] и наиболее широко используемые полупроводниковый прибор в мире.[44] Его называют «рабочей лошадкой электронной промышленности».[45] и «базовая технология» конца 20 - начала 21 века.[10] Масштабирование MOSFET и миниатюризация (видеть Список примеров полупроводниковой шкалы ) были основными факторами быстрого экспоненциального роста электронных полупроводник технологии с 1960-х годов,[46] поскольку быстрая миниатюризация полевых МОП-транзисторов в значительной степени ответственна за увеличение плотность транзисторов, увеличивая производительность и уменьшая потребляемая мощность из Интегральная схема микросхемы и электронные устройства с 1960-х годов.[47]
МОП-транзисторы способны высокая масштабируемость (Закон Мура и Масштабирование Деннарда ),[48] с увеличением миниатюризация,[49] и может быть легко уменьшена до меньших размеров.[50] Они потребляют значительно меньше энергии и имеют гораздо более высокую плотность, чем биполярные транзисторы.[51] Таким образом, полевые МОП-транзисторы имеют гораздо меньший размер, чем БЮТ,[52] примерно в 20 раз меньше к началу 1990-х годов.[52] МОП-транзисторы также имеют более высокую скорость переключения,[4] с быстрым включением-выключением электронное переключение что делает их идеальными для создания импульсные поезда,[53] основа для цифровые сигналы.[54][55] в отличие от BJT, которые более медленно генерируют аналоговые сигналы, похожие на синусоидальные волны.[53] МОП-транзисторы также дешевле[56] и имеют относительно простые этапы обработки, в результате выход продукции.[50] Таким образом, полевые МОП-транзисторы позволяют крупномасштабная интеграция (LSI) и идеально подходят для цифровые схемы,[57] а также линейный аналоговые схемы.[53]
MOSFET был по-разному описан как наиболее важный транзистор,[3] самое важное устройство в электронной промышленности,[58] возможно, самое важное устройство в вычислительная промышленность,[59] одно из самых важных событий в полупроводник технологии,[60] и, возможно, самое важное изобретение в электронике.[61] MOSFET был фундаментальным строительным блоком современного цифровая электроника,[10] вовремя цифровая революция,[62] информационная революция, информационный век,[63] и кремниевый век.[64][65] МОП-транзисторы были движущей силой компьютерная революция, и технологии, на которые он способен.[66][67][68] Быстрый прогресс электронной промышленности в конце 20-го - начале 21-го веков был достигнут за счет быстрого Масштабирование MOSFET (Масштабирование Деннарда и Закон Мура ), вплоть до уровня наноэлектроника в начале 21 века.[69] MOSFET произвел революцию в мире в век информации, поскольку его высокая плотность позволила компьютер существовать на нескольких небольших микросхемах, а не заполнять комнату,[70] а позже сделав возможным цифровые коммуникационные технологии Такие как смартфоны.[66]
MOSFET - это наиболее широко производимое устройство в истории.[71][72] MOSFET обеспечивает годовой объем продаж 295 миллиардов долларов по состоянию на 2015 год.[73] В период с 1960 по 2018 гг. Всего 13 человек. секстиллион Изготовлены МОП-транзисторы, составляющие не менее 99,9% всех транзисторов.[71] Цифровые интегральные схемы, такие как микропроцессоры и запоминающие устройства содержат от тысяч до миллиардов интегрированных полевых МОП-транзисторов на каждом устройстве, обеспечивая основные функции переключения, необходимые для реализации логические ворота и хранение данных. Существуют также устройства памяти, содержащие не менее триллиона МОП-транзисторов, например, 256 ГБ microSD карта памяти, больше, чем количество звезды в Млечный Путь галактика.[45] По состоянию на 2010 год принципы работы современных полевых МОП-транзисторов остались в основном такими же, как и у оригинальных полевых МОП-транзисторов, впервые продемонстрированных Мохамед Аталла и Давон Канг в 1960 г.[74][75]
В Бюро патентов и товарных знаков США называет MOSFET «революционным изобретением, которое изменило жизнь и культуру во всем мире»[66] и Музей истории компьютеров приписывает ему «безвозвратное изменение человеческого опыта».[10] MOSFET также послужил основой для Нобелевская премия успешные прорывы, такие как квантовый эффект холла[76] и устройство с зарядовой связью (CCD),[77] хотя сам MOSFET никогда не присуждал Нобелевской премии.[78] В заметке 2018 г. Джек Килби с Нобелевская премия по физике за его участие в изобретении интегральной схемы Шведская королевская академия наук специально упомянул MOSFET и микропроцессор как другие важные изобретения в развитии микроэлектроника.[79] MOSFET также включен в список этапов IEEE в электронике,[80] и его изобретатели Мохамед Аталла и Давон Канг вошли в Национальный зал славы изобретателей в 2009.[13][14]
Сочинение

Обычно полупроводник выбор кремний. В последнее время некоторые производители микросхем, особенно IBM и Intel начали использовать химическое соединение кремния и германия (SiGe ) в каналах MOSFET. К сожалению, многие полупроводники с лучшими электрическими свойствами, чем кремний, такие как арсенид галлия, не образуют хороших интерфейсов полупроводник-изолятор и, следовательно, не подходят для полевых МОП-транзисторов. Исследования продолжаются[когда? ] по созданию изоляторов с приемлемыми электрическими характеристиками на других полупроводниковых материалах.
Чтобы преодолеть увеличение энергопотребления из-за утечки тока затвора, диэлектрик с высоким κ используется вместо диоксида кремния для изолятора затвора, в то время как поликремний заменен металлическими затворами (например, Intel, 2009[81]).
Затвор отделен от канала тонким изолирующим слоем, традиционно из диоксида кремния, а затем из оксинитрид кремния. Некоторые компании начали внедрять комбинацию диэлектрика с высоким значением k и металлического затвора в 45 нм узел.
Когда между выводом затвора и корпуса прикладывается напряжение, генерируемое электрическое поле проникает через оксид и создает инверсионный слой или же канал на границе полупроводник-изолятор. Инверсионный слой обеспечивает канал, по которому ток может проходить между выводами истока и стока. Изменение напряжения между затвором и корпусом модулирует проводимость этого слоя и тем самым контролирует ток между стоком и истоком. Это называется режимом улучшения.
Операция
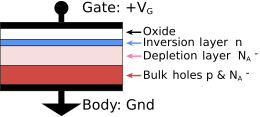
Структура металл – оксид – полупроводник.
Традиционная структура металл – оксид – полупроводник (МОП) получается путем выращивания слоя диоксид кремния (SiO
2) поверх кремний субстрат, обычно термическое окисление и нанесение слоя металла или поликристаллический кремний (обычно используется последний). Поскольку диоксид кремния является диэлектрик материал, его структура эквивалентна плоской конденсатор, с заменой одного из электродов на полупроводник.
Когда на МОП-структуру подается напряжение, оно изменяет распределение зарядов в полупроводнике. Если рассматривать полупроводник p-типа (с плотность акцепторы, п плотность отверстий; р = NА в нейтрали), положительное напряжение, , от ворот к корпусу (см. рисунок) создает слой истощения путем вытеснения положительно заряженных дырок от границы раздела затвор-изолятор / полупроводник, оставляя незащищенной свободную от носителей область неподвижных отрицательно заряженных ионов-акцепторов (см. легирование (полупроводник) ). Если достаточно высока, образуется высокая концентрация отрицательных носителей заряда в инверсионный слой расположен в тонком слое рядом с границей раздела между полупроводником и диэлектриком.
Обычно напряжение затвора, при котором объемная плотность электронов в инверсионном слое совпадает с объемной плотностью дырок в теле, называется напряжением. пороговое напряжение. Когда напряжение между затвором транзистора и истоком (VGS) превышает пороговое напряжение (Vth), разница известна как напряжение перегрузки.
Эта структура с корпусом p-типа является основой MOSFET n-типа, который требует добавления областей истока и стока n-типа.
МОП-конденсаторы и диаграммы полос
Структура МОП-конденсатора является сердцем МОП-транзистора. Рассмотрим МОП-конденсатор с кремниевой базой p-типа. Если на затвор прикладывается положительное напряжение, отверстия, которые находятся на поверхности подложки p-типа, будут отталкиваться электрическим полем, создаваемым приложенным напряжением. Сначала дырки будут просто отталкиваться, и то, что останется на поверхности, будет неподвижными (отрицательными) атомами акцепторного типа, что создаст на поверхности область обеднения. Помните, что дыра создается акцепторным атомом, например Бор, у которого на один электрон меньше, чем у кремния. Можно спросить, как можно отразить дыры, если они на самом деле не являются сущностями? Ответ заключается в том, что на самом деле происходит не то, что дырка отталкивается, а электроны притягиваются положительным полем и заполняют эти дырки, создавая область обеднения, в которой нет носителей заряда, потому что электрон теперь закреплен на атоме и неподвижен.
По мере увеличения напряжения на затворе будет точка, в которой поверхность над обедненной областью будет преобразована из p-типа в n-тип, так как электроны из основной области начнут притягиваться большим электрическим полем. Это известно как инверсия. Пороговое напряжение, при котором происходит это преобразование, является одним из наиболее важных параметров полевого МОП-транзистора.
В случае объема p-типа инверсия происходит, когда собственный уровень энергии на поверхности становится меньше, чем Уровень Ферми на поверхности. Это видно из ленточной диаграммы. Помните, что уровень Ферми определяет тип обсуждаемого полупроводника. Если уровень Ферми равен внутреннему уровню, полупроводник является внутренним или чистым типом. Если уровень Ферми расположен ближе к зоне проводимости (валентной зоне), то полупроводник будет типа n (p-тип). Следовательно, когда напряжение затвора увеличивается в положительном смысле (для данного примера), это «искривляет» полосу собственных энергетических уровней, так что она будет изгибаться вниз по направлению к валентной зоне. Если уровень Ферми находится ближе к валентной зоне (для p-типа), наступит момент, когда собственный уровень начнет пересекать уровень Ферми, и когда напряжение достигнет порогового напряжения, собственный уровень действительно пересечет уровень Ферми. , и это то, что называется инверсией. В этот момент поверхность полупроводника переходит из p-типа в n-тип. Помните, что, как сказано выше, если уровень Ферми лежит выше собственного уровня, полупроводник относится к n-типу, поэтому при инверсии, когда собственный уровень достигает и пересекает уровень Ферми (который находится ближе к валентной зоне), полупроводник Тип меняется на поверхности, что диктуется относительным положением уровней Ферми и собственной энергии.
Структура и формирование каналов

МОП-транзистор основан на модуляции концентрации заряда за счет емкости МОП между тело электрод и ворота электрод, расположенный над корпусом и изолированный от всех других частей устройства затвор диэлектрик слой. Если используются диэлектрики, отличные от оксида, устройство может называться полевым транзистором металл-диэлектрик-полупроводник (MISFET). По сравнению с МОП-конденсатором, МОП-транзистор включает два дополнительных вывода (источник и осушать), каждый из которых подключен к отдельным высоколегированным областям, разделенным областью тела. Эти области могут быть как p-, так и n-типа, но обе должны быть одного и того же типа и противоположного типа по отношению к области тела. Исток и сток (в отличие от корпуса) сильно легированы, что обозначено знаком «+» после типа легирования.
Если МОП-транзистор является n-канальным или n-МОП-транзистором, тогда исток и сток являются п + регионы и тело - это п область, край. Если MOSFET является p-каналом или pMOS FET, то исток и сток р + регионы и тело - это п область, край. Источник назван так потому, что он является источником носителей заряда (электроны для n-канала, дырки для p-канала), которые текут через канал; аналогично сток - это место, где носители заряда покидают канал.
Заполненность энергетических зон в полупроводнике задается положением Уровень Ферми относительно краев энергетических зон полупроводника.
При достаточном напряжении на затворе край валентной зоны отодвигается от уровня Ферми, а дырки от тела отводятся от затвора.
При еще большем смещении затвора вблизи поверхности полупроводника край зоны проводимости приближается к уровню Ферми, заполняя поверхность электронами в инверсионный слой или же n-канал на границе p-области и оксида. Этот проводящий канал проходит между истоком и стоком, и ток проходит через него, когда между двумя электродами подается напряжение. Увеличение напряжения на затворе приводит к более высокой плотности электронов в инверсионном слое и, следовательно, увеличивает ток между истоком и стоком. Для напряжений затвора ниже порогового значения канал заполняется слабо, и только очень маленький подпороговая утечка ток может течь между истоком и стоком.
Когда прикладывается отрицательное напряжение затвор-исток, он создает р-канал на поверхности n-области, аналогично случаю n-канала, но с противоположными полярностями зарядов и напряжений. Когда напряжение менее отрицательное, чем пороговое значение (отрицательное напряжение для p-канала), применяется между затвором и истоком, канал исчезает, и только очень небольшой подпороговый ток может течь между истоком и стоком. Устройство может содержать кремний на изоляторе устройство, в котором скрытый оксид образуется под тонким слоем полупроводника. Если область канала между диэлектриком затвора и скрытой оксидной областью очень тонкая, канал упоминается как сверхтонкая область канала с областями истока и стока, сформированными с обеих сторон в тонком полупроводниковом слое или над ним. Могут использоваться другие полупроводниковые материалы. Когда области истока и стока сформированы над каналом полностью или частично, они называются приподнятыми областями истока / стока.
| Параметр | nMOSFET | pMOSFET | |
|---|---|---|---|
| Тип источника / стока | n-тип | р-тип | |
| Тип канала (МОП-конденсатор) | n-тип | р-тип | |
| Ворота тип | Поликремний | п + | р + |
| Металл | φм ~ Si зона проводимости | φм ~ Si валентная зона | |
| Тип колодца | р-тип | n-тип | |
| Пороговое напряжение, Vth |
|
| |
| Гибка ленты | Вниз | Вверх | |
| Носители инверсионного слоя | Электроны | Отверстия | |
| Тип субстрата | р-тип | n-тип | |
Режимы работы

вверху слева: подпороговое значение, вверху справа: омический режим, внизу слева: активный режим в начале отсечки, внизу справа: активный режим в самом начале отсечки - модуляция длины канала очевидна

Работа полевого МОП-транзистора может быть разделена на три различных режима, в зависимости от напряжений на клеммах. В следующем обсуждении используется упрощенная алгебраическая модель.[84] Характеристики современных полевых МОП-транзисторов сложнее, чем представленная здесь алгебраическая модель.[85]
Для режим улучшения, n-канальный MOSFET, есть три режима работы:
- Отсечка, подпороговый режим и режим слабой инверсии
Когда VGS < Vth:
куда это смещение затвор-исток и это пороговое напряжение устройства.
Согласно базовой пороговой модели, транзистор выключен, и между стоком и истоком нет проводимости. Более точная модель учитывает влияние тепловой энергии на Распределение Ферми – Дирака энергии электронов, которые позволяют некоторым из более энергичных электронов в источнике проникать в канал и течь в сток. Это приводит к подпороговому току, который является экспоненциальной функцией напряжения затвор-исток. В то время как ток между стоком и истоком в идеале должен быть равен нулю, когда транзистор используется в качестве выключателя, существует слабый ток инверсии, иногда называемый подпороговой утечкой.
В слабой инверсии, когда источник привязан к объему, ток изменяется экспоненциально в зависимости от как указано приблизительно:[86][87]
куда = ток в , тепловое напряжение и коэффициент наклона п дан кем-то:
с = емкость обедненного слоя и = емкость оксидного слоя. Обычно используется это уравнение, но оно является лишь адекватным приближением для источника, привязанного к балке. Для источника, не привязанного к объему, подпороговое уравнение для тока стока в насыщении имеет вид[88][89]
где является делителем канала, который определяется по формуле:
с = емкость обедненного слоя и = емкость оксидного слоя. В длинноканальном устройстве отсутствует зависимость тока однократного тока от напряжения стока. , но по мере уменьшения длины канала снижение барьера, вызванное дренажем вводит зависимость напряжения стока, которая сложным образом зависит от геометрии устройства (например, легирование канала, легирование перехода и т. д.). Часто пороговое напряжение Vth для этого режима определяется как напряжение затвора, при котором выбранное значение тока яD0 происходит, например, яD0 = 1 мкА, что может не совпадать Vth-значение, используемое в уравнениях для следующих режимов.
Некоторые аналоговые схемы микромощностей предназначены для использования преимущества подпороговой проводимости.[90][91][92] Работая в области слабой инверсии, полевые МОП-транзисторы в этих схемах обеспечивают максимально возможное отношение крутизны к току, а именно: , почти что у биполярного транзистора.[93]
Подпорог ВАХ экспоненциально зависит от порогового напряжения, что приводит к сильной зависимости от любых производственных изменений, влияющих на пороговое напряжение; например: изменения толщины оксида, глубины перехода или легирования тела, которые изменяют степень снижения барьера, вызванного стоком. Результирующая чувствительность к производственным изменениям усложняет оптимизацию утечки и производительности.[94][95]
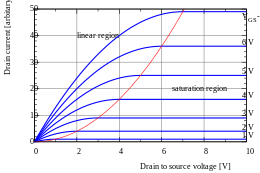


Когда VGS > Vth и VDS < VGS − Vth:
Транзистор включается, и создается канал, пропускающий ток между стоком и истоком. МОП-транзистор работает как резистор, управляемый напряжением затвора относительно напряжений истока и стока. Ток от стока к истоку моделируется как:
куда - эффективная подвижность носителей заряда, ширина ворот, длина ворот и это оксид ворот емкость на единицу площади. Переход от экспоненциальной подпороговой области к триодной области не такой резкий, как предполагают уравнения.
Когда VGS > Vth и VDS ≥ (VGS - Vth):
Переключатель включен, и был создан канал, который пропускает ток между стоком и истоком. Поскольку напряжение стока выше, чем напряжение истока, электроны распространяются, и проводимость осуществляется не через узкий канал, а через более широкое, двух- или трехмерное распределение тока, простирающееся от границы раздела в глубину подложки. Начало этой области также известно как отщипнуть для обозначения отсутствия области канала возле стока. Хотя канал не распространяется на всю длину устройства, электрическое поле между стоком и каналом очень велико, и проводимость сохраняется. Ток стока теперь слабо зависит от напряжения стока и контролируется в основном напряжением затвор-исток и моделируется примерно как:
Дополнительный фактор, включающий λ, параметр модуляции длины канала, моделирует зависимость тока от напряжения стока из-за модуляция длины канала, фактически аналогично Ранний эффект наблюдается в биполярных устройствах. Согласно этому уравнению, ключевым параметром конструкции, крутизной MOSFET является:
где комбинация Vов = VGS − Vth называется напряжение перегрузки,[100] и где VDSsat = VGS − Vth объясняет небольшой разрыв в которые иначе возникли бы при переходе между триодной областью и областью насыщения.
Еще одним ключевым параметром конструкции является выходное сопротивление полевого МОП-транзистора. предоставлено:
- .
риз является инверсией граммDS куда . яD - выражение в области насыщения.
Если λ принять равным нулю, результирующее бесконечное выходное сопротивление может упростить анализ схемы, однако это может привести к нереалистичным прогнозам схемы, особенно в аналоговых схемах.
Поскольку длина канала становится очень короткой, эти уравнения становятся неточными. Возникают новые физические эффекты. Например, транспортировка носителя в активном режиме может быть ограничена насыщение скорости. Когда преобладает насыщение скорости, ток стока насыщения более близок к линейному, чем к квадратичному по величине. VGS. На еще более коротких длинах носители транспортируются с почти нулевым рассеянием, известным как квази-баллистический транспорт. В баллистическом режиме носители движутся со скоростью впрыска, которая может превышать скорость насыщения и приближается к Скорость Ферми при высокой плотности инверсионного заряда. Кроме того, снижение барьера, вызванного стоком, увеличивает ток отключения (отсечки) и требует увеличения порогового напряжения для компенсации, что, в свою очередь, снижает ток насыщения.
Эффект тела

Заполненность энергетических зон в полупроводнике задается положением Уровень Ферми относительно краев энергетических зон полупроводника. Применение обратного смещения источник-подложка pn-перехода источник-тело вводит расщепление между уровнями Ферми для электронов и дырок, сдвигая уровень Ферми для канала дальше от края зоны, уменьшая заполненность канала. Эффект заключается в увеличении напряжения затвора, необходимого для установления канала, как показано на рисунке. Это изменение силы канала за счет применения обратного смещения называется «эффектом тела».
Проще говоря, используя пример nMOS, смещение затвор-тело VГБ позиционирует энергетические уровни зоны проводимости, в то время как смещение источника к телу VSB positions the electron Fermi level near the interface, deciding occupancy of these levels near the interface, and hence the strength of the inversion layer or channel.
The body effect upon the channel can be described using a modification of the threshold voltage, approximated by the following equation:
куда VТуберкулез is the threshold voltage with substrate bias present, and VT0 is the zero-VSB value of threshold voltage, is the body effect parameter, and 2φB is the approximate potential drop between surface and bulk across the depletion layer when VSB = 0 and gate bias is sufficient to ensure that a channel is present.[101] As this equation shows, a reverse bias VSB > 0 causes an increase in threshold voltage VТуберкулез and therefore demands a larger gate voltage before the channel populates.
The body can be operated as a second gate, and is sometimes referred to as the "back gate"; the body effect is sometimes called the "back-gate effect".[102]
Условные обозначения схем
A variety of symbols are used for the MOSFET. The basic design is generally a line for the channel with the source and drain leaving it at right angles and then bending back at right angles into the same direction as the channel. Sometimes three line segments are used for enhancement mode and a solid line for depletion mode (see depletion and enhancement modes ). Another line is drawn parallel to the channel for the gate.
В масса или же тело connection, if shown, is shown connected to the back of the channel with an arrow indicating pMOS or nMOS. Arrows always point from P to N, so an NMOS (N-channel in P-well or P-substrate) has the arrow pointing in (from the bulk to the channel). If the bulk is connected to the source (as is generally the case with discrete devices) it is sometimes angled to meet up with the source leaving the transistor. If the bulk is not shown (as is often the case in IC design as they are generally common bulk) an inversion symbol is sometimes used to indicate PMOS, alternatively an arrow on the source may be used in the same way as for bipolar transistors (out for nMOS, in for pMOS).
Comparison of enhancement-mode and depletion-mode MOSFET symbols, along with JFET символы. The orientation of the symbols, (most significantly the position of source relative to drain) is such that more positive voltages appear higher on the page than less positive voltages, implying current flowing "down" the page:[103][104][105]
| P-канал |  |  |  |  |  |
|---|---|---|---|---|---|
| N-канал |  |  |  |  |  |
| JFET | МОП-транзистор enh. | МОП-транзистор enh. (no bulk) | МОП-транзистор деп. | ||
In schematics where G, S, D are not labeled, the detailed features of the symbol indicate which terminal is source and which is drain. For enhancement-mode and depletion-mode MOSFET symbols (in columns two and five), the source terminal is the one connected to the arrowhead. Additionally, in this diagram, the gate is shown as an "L" shape, whose input leg is closer to S than D, also indicating which is which. However, these symbols are often drawn with a "T" shaped gate (as elsewhere on this page), so it is the arrowhead which must be relied upon to indicate the source terminal.
For the symbols in which the bulk, or body, terminal is shown, it is here shown internally connected to the source (i.e., the black arrowhead in the diagrams in columns 2 and 5). This is a typical configuration, but by no means the only important configuration. In general, the MOSFET is a four-terminal device, and in integrated circuits many of the MOSFETs share a body connection, not necessarily connected to the source terminals of all the transistors.
Types of MOSFET
PMOS and NMOS logic
P-channel MOS (PMOS) logic использует р-канал MOSFETs to implement логические ворота и другие digital circuits. N-channel MOS (NMOS) logic использует n-канал MOSFETs to implement logic gates and other digital circuits.
For devices of equal current driving capability, n-channel MOSFETs can be made smaller than p-channel MOSFETs, due to p-channel charge carriers (holes ) having lower мобильность than do n-channel charge carriers (электроны ), and producing only one type of MOSFET on a silicon substrate is cheaper and technically simpler. These were the driving principles in the design of Логика NMOS which uses n-channel MOSFETs exclusively. However, unlike CMOS logic (neglecting ток утечки ), NMOS logic consumes power even when no switching is taking place.
Мохамед Аталла и Давон Канг originally demonstrated both pMOS and nMOS devices with 20 µm а потом 10 µm gate lengths in 1960.[15][106] Their original MOSFET devices also had a оксид ворот толщина 100 нм.[107] Однако устройства nMOS были непрактичными, и только тип pMOS был практическими рабочими устройствами.[15] A more practical NMOS process was developed several years later. NMOS was initially faster than CMOS, thus NMOS was more widely used for computers in the 1970s.[108] With advances in technology, CMOS logic displaced NMOS logic in the mid-1980s to become the preferred process for digital chips.
Complementary MOS (CMOS)
The MOSFET is used in digital комплементарный металл – оксид – полупроводник (CMOS ) logic,[109] which uses p- and n-channel MOSFETs as building blocks. Overheating is a major concern in интегральные схемы since ever more transistors are packed into ever smaller chips. CMOS logic reduces power consumption because no current flows (ideally), and thus no мощность is consumed, except when the inputs to логические ворота are being switched. CMOS accomplishes this current reduction by complementing every nMOSFET with a pMOSFET and connecting both gates and both drains together. A high voltage on the gates will cause the nMOSFET to conduct and the pMOSFET not to conduct and a low voltage on the gates causes the reverse. During the switching time as the voltage goes from one state to another, both MOSFETs will conduct briefly. This arrangement greatly reduces power consumption and heat generation.
CMOS was developed by Чи-Тан Сах и Фрэнк Ванласс в Fairchild Semiconductor в 1963 г.[32] CMOS had lower power consumption, but was initially slower than NMOS, which was more widely used for computers in the 1970s. В 1978 г. Hitachi introduced the twin-well CMOS process, which allowed CMOS to match the performance of NMOS with less power consumption. The twin-well CMOS process eventually overtook NMOS as the most common процесс производства полупроводников for computers in the 1980s.[108] By the 1970s–1980s, CMOS logic consumed over 7 times less power than NMOS logic,[108] and about 100,000 times less power than bipolar транзисторно-транзисторная логика (TTL).[110]
Режим истощения
Есть режим истощения MOSFET devices, which are less commonly used than the standard режим улучшения devices already described. These are MOSFET devices that are doped so that a channel exists even with zero voltage from gate to source. To control the channel, a negative voltage is applied to the gate (for an n-channel device), depleting the channel, which reduces the current flow through the device. In essence, the depletion-mode device is equivalent to a normally closed (on) switch, while the enhancement-mode device is equivalent to a нормально открытый (off) switch.[111]
Due to their low коэффициент шума в РФ region, and better прирост, these devices are often preferred to bipolars в RF front-ends например, в телевидение sets.
Depletion-mode MOSFET families include BF960 by Сименс и Telefunken, and the BF980 in the 1980s by Philips (позже стать Полупроводники NXP ), whose derivatives are still used in AGC and RF Смеситель внешние интерфейсы.
Metal–insulator–semiconductor field-effect transistor (MISFET)
Metal–insulator–semiconductor field-effect-transistor,[112][113][114] или же MISFET, is a more general term than МОП-транзистор and a synonym to insulated-gate field-effect transistor (IGFET). All MOSFETs are MISFETs, but not all MISFETs are MOSFETs.
The gate dielectric insulator in a MISFET is диоксид кремния in a MOSFET, but other materials can also be employed. В gate dielectric lies directly below the gate electrode и выше канал of the MISFET. Период, термин металл is historically used for the gate material, even though now it is usually highly doped поликремний или какой-то другой неметалл.
Insulator types may be:
- Silicon dioxide, in MOSFETs
- Organic insulators (e.g., undoped trans-полиацетилен; cyanoethyl pullulan, CEP[115]), for organic-based FETs.[114]
Floating-gate MOSFET (FGMOS)
В МОП-транзистор с плавающим затвором (FGMOS) is a type of MOSFET where the gate is electrically isolated, creating a floating node in DC and a number of secondary gates or inputs are deposited above the floating gate (FG) and are electrically isolated from it. Первый отчет МОП-транзистор с плавающим затвором (FGMOS) was made by Давон Канг (co-inventor of the original MOSFET) and Simon Min Sze в 1967 г.[116]
The FGMOS is commonly used as a floating-gate ячейка памяти, the digital storage element in EPROM, EEPROM и flash memories. Other uses of the FGMOS include a neuronal computational element in нейронные сети, analog storage element, digital potentiometers and single-transistor ЦАП.
Силовой MOSFET


Power MOSFETs have a different structure.[117] As with most power devices, the structure is vertical and not planar. Using a vertical structure, it is possible for the transistor to sustain both high blocking voltage and high current. The voltage rating of the transistor is a function of the doping and thickness of the N-эпитаксиальный layer (see cross section), while the current rating is a function of the channel width (the wider the channel, the higher the current). In a planar structure, the current and breakdown voltage ratings are both a function of the channel dimensions (respectively width and length of the channel), resulting in inefficient use of the "silicon estate". With the vertical structure, the component area is roughly proportional to the current it can sustain, and the component thickness (actually the N-epitaxial layer thickness) is proportional to the breakdown voltage.[118]
Power MOSFETs with lateral structure are mainly used in high-end audio amplifiers and high-power PA systems. Their advantage is a better behaviour in the saturated region (corresponding to the linear region of a биполярный транзистор ) than the vertical MOSFETs. Vertical MOSFETs are designed for switching applications.[119]
The power MOSFET, which is commonly used in силовая электроника, was developed in the early 1970s.[120] The power MOSFET enables low gate drive power, fast switching speed, and advanced paralleling capability.[4]
Double-diffused metal–oxide–semiconductor (DMOS)
Есть VDMOS (vertical double-diffused metal oxide semiconductor) and LDMOS (lateral double-diffused metal oxide semiconductor). Most power MOSFETs are made using this technology.
МОП конденсатор
The MOS конденсатор is part of the MOSFET structure, where the MOS capacitor is flanked by two p-n переходы.[121] The MOS capacitor is widely used as a storage capacitor in микросхемы памяти, и как основной строительный блок устройство с зарядовой связью (CCD) в датчик изображений технологии.[122] В DRAM (динамический оперативная память ), каждый ячейка памяти обычно состоит из полевого МОП-транзистора и МОП-конденсатора.[123]
Thin-film transistor (TFT)
В тонкопленочный транзистор (TFT) is a type of MOSFET distinct from the standard bulk MOSFET.[124] The first TFT was invented by Paul K. Weimer в RCA in 1962, building on the earlier work of Atalla and Kahng on MOSFETs.[125]
The idea of a TFT-based жидкокристаллический дисплей (LCD) was conceived by Bernard Lechner of RCA Laboratories в 1968 г.[126] Lechner, F. J. Marlowe, E. O. Nester and J. Tults demonstrated the concept in 1968 with an 18x2 matrix динамическое рассеяние LCD that used standard discrete MOSFETs, as TFT performance was not adequate at the time.[127]
Bipolar–MOS transistors
BiCMOS является Интегральная схема that combines BJT and CMOS transistors on a single chip.[128]
В биполярный транзистор с изолированным затвором (IGBT) is a силовой транзистор with characteristics of both a MOSFET and биполярный переходной транзистор (BJT).[129]
MOS sensors
A number of MOSFET датчики have been developed, for measuring физический, химический, биологический и относящийся к окружающей среде параметры.[130] The earliest MOSFET sensors include the open-gate FET (OGFET) introduced by Johannessen in 1970,[130] то ion-sensitive field-effect transistor (ISFET) invented by Piet Bergveld в 1970 г.[131] то адсорбция FET (ADFET) запатентованный by P.F. Cox in 1974, and a водород -sensitive MOSFET demonstrated by I. Lundstrom, M.S. Shivaraman, C.S. Svenson and L. Lundkvist in 1975.[130] The ISFET is a special type of MOSFET with a gate at a certain distance,[130] и где металлические ворота заменяется ион -чувствительный мембрана, электролит решение и электрод сравнения.[132]
By the mid-1980s, numerous other MOSFET sensors had been developed, including the gas sensor FET (GASFET), surface accessible FET (SAFET), charge flow transistor (CFT), датчик давления FET (PRESSFET), chemical field-effect transistor (ChemFET), reference ISFET (REFET), biosensor FET (BioFET), enzyme-modified FET (ENFET) and immunologically modified FET (IMFET).[130] By the early 2000s, BioFET types such as the DNA field-effect transistor (DNAFET), gene-modified FET (GenFET) and cell-potential BioFET (CPFET) had been developed.[132]
The two main types of датчики изображения используется в цифровое изображение technology are the устройство с зарядовой связью (CCD) and the датчик с активным пикселем (CMOS sensor). Both CCD and CMOS sensors are based on MOS technology, with the CCD based on МОП-конденсаторы and the CMOS sensor based on MOS transistors.[77]
Multi-gate field-effect transistor (MuGFET)

В dual-gate MOSFET (DGMOS) has a тетрод configuration, where both gates control the current in the device. It is commonly used for small-signal devices in radio frequency applications where biasing the drain-side gate at constant potential reduces the gain loss caused by Эффект Миллера, replacing two separate transistors in каскод конфигурация. Other common uses in RF circuits include gain control and mixing (frequency conversion). В тетрод description, though accurate, does not replicate the vacuum-tube tetrode. Vacuum-tube tetrodes, using a screen grid, exhibit much lower grid-plate capacitance and much higher output impedance and voltage gains than triode vacuum tubes. These improvements are commonly an order of magnitude (10 times) or considerably more. Tetrode transistors (whether bipolar junction or field-effect) do not exhibit improvements of such a great degree.
В FinFET is a double-gate кремний на изоляторе device, one of a number of geometries being introduced to mitigate the effects of short channels and reduce drain-induced barrier lowering. В плавник refers to the narrow channel between source and drain. A thin insulating oxide layer on either side of the fin separates it from the gate. SOI FinFETs with a thick oxide on top of the fin are called double-gate and those with a thin oxide on top as well as on the sides are called triple-gate FinFETs.[133][134]
А double-gate MOSFET transistor was first demonstrated in 1984 by Electrotechnical Laboratory researchers Toshihiro Sekigawa and Yutaka Hayashi.[135][136] А GAAFET (gate-all-around MOSFET), a type of мульти-ворота non-planar 3D transistor, was first demonstrated in 1988 by a Toshiba исследовательская группа, включающая Фудзио Масуока, H. Takato and K. Sunouchi.[137][138] В FinFET (fin field-effect transistor), a type of 3D non-planar double-gate MOSFET, originated from the research of Digh Hisamoto and his team at Центральная исследовательская лаборатория Hitachi в 1989 г.[139][140] Развитие нанопроволока multi-gate MOSFETs have since become fundamental to наноэлектроника.[141]
Quantum field-effect transistor (QFET)
А quantum field-effect transistor (QFET) or квантовая яма field-effect transistor (QWFET) is a type of MOSFET[142][143][144] that takes advantage of квантовое туннелирование to greatly increase the speed of transistor operation.[145]
Radiation-hardened-by-design (RHBD)
Semiconductor sub-micrometer and nanometer electronic circuits are the primary concern for operating within the normal tolerance in harsh радиация среды, такие как космическое пространство. One of the design approaches for making a radiation-hardened-by-design (RHBD) device is enclosed-layout-transistor (ELT). Normally, the gate of the MOSFET surrounds the drain, which is placed in the center of the ELT. The source of the MOSFET surrounds the gate. Another RHBD MOSFET is called H-Gate. Both of these transistors have very low leakage current with respect to radiation. However, they are large in size and take more space on silicon than a standard MOSFET. In older STI (shallow trench isolation) designs, radiation strikes near the silicon oxide region cause the channel inversion at the corners of the standard MOSFET due to accumulation of radiation induced trapped charges. If the charges are large enough, the accumulated charges affect STI surface edges along the channel near the channel interface (gate) of the standard MOSFET. Thus the device channel inversion occurs along the channel edges and the device creates an off-state leakage path, causing the device to turn on. So the reliability of circuits degrades severely. The ELT offers many advantages. These advantages include improvement of надежность by reducing unwanted surface inversion at the gate edges that occurs in the standard MOSFET. Since the gate edges are enclosed in ELT, there is no gate oxide edge (STI at gate interface), and thus the transistor off-state leakage is reduced considerably. Low-power microelectronic circuits including computers, communication devices and monitoring systems in the space shuttle and satellites are very different to what is used on earth. They require radiation (high-speed atomic particles like протон и нейтрон, Солнечная вспышка magnetic energy dissipation in Earth's space, energetic космические лучи подобно рентгеновский снимок, гамма-луч etc.) tolerant circuits. These special electronics are designed by applying different techniques using RHBD MOSFETs to ensure safer journeys and space-walks for astronauts.
Приложения
The MOSFET generally forms the basis of modern электроника,[42] as the dominant transistor in digital circuits а также analog integrated circuits.[3] It is the basis for numerous modern technologies,[146] and is commonly used for a wide range of applications.[47] According to Jean-Pierre Colinge, numerous modern technologies would not exist without the MOSFET, such as the modern компьютерная промышленность, цифровая связь системы, видеоигры, карманные калькуляторы, и digital wristwatches, Например.[146]
Discrete MOSFET devices are widely used in applications such as импульсные источники питания, частотно-регулируемые приводы и другие силовая электроника applications where each device may be switching thousands of watts. Radio-frequency amplifiers up to the УВЧ spectrum use MOSFET transistors as analog signal and power amplifiers. Radio systems also use MOSFETs as oscillators, or смесители to convert frequencies. MOSFET devices are also applied in audio-frequency power amplifiers for public address systems, звукоусиление and home and automobile sound systems.[нужна цитата ]
MOSFETs in интегральные схемы are the primary elements of компьютерные процессоры, полупроводниковая память, датчики изображения, and most other types of integrated circuits.
MOS integrated circuit (MOS IC)
The MOSFET is the most widely used type of transistor and the most critical device component in Интегральная схема (IC) chips.[147] В монолитная интегральная схема chip was enabled by the surface passivation процесс, который электрически стабилизирован кремний поверхности через термическое окисление, что позволяет fabricate монолитные интегральные микросхемы с использованием кремния. The surface passivation process was developed by Мохамед М. Аталла в Bell Labs in 1957. This was the basis for the планарный процесс, разработан Жан Хорни в Fairchild Semiconductor in early 1959, which was critical to the invention of the monolithic integrated circuit chip by Роберт Нойс later in 1959.[148][149][17] В том же году,[8] Atalla used his surface passivation process to invent the MOSFET with Давон Канг в Bell Labs.[14][13] Затем последовала разработка clean rooms to reduce contamination to levels never before thought necessary, and coincided with the development of фотолитография[150] which, along with surface passivation and the planar process, allowed circuits to be made in few steps.
Mohamed Atalla first proposed the concept of the MOS integrated circuit (MOS IC) chip in 1960, noting that the MOSFET's ease of изготовление сделал его полезным для интегральных схем.[9] В отличие от биполярные транзисторы что потребовало ряда шагов для изоляция p – n перехода транзисторов на кристалле, полевые МОП-транзисторы не требовали таких шагов, но их можно было легко изолировать друг от друга.[29] Его преимущество для интегральных схем было повторено Давоном Кангом в 1961 году.[21] В Si –SiO2 system possessed the technical attractions of low cost of production (on a per circuit basis) and ease of integration. These two factors, along with its rapidly scaling miniaturization and low потребление энергии, led to the MOSFET becoming the most widely used type of transistor in IC chips.
The earliest experimental MOS IC to be demonstrated was a 16-transistor chip built by Fred Heiman and Steven Hofstein at RCA в 1962 г.[56] General Microelectronics later introduced the first commercial MOS integrated circuits in 1964, consisting of 120 р-канал транзисторы.[151] Это был 20-битный регистр сдвига, разработанный Робертом Норманом[56] и Фрэнк Ванласс.[152] В 1968 г. Fairchild Semiconductor исследователи Федерико Фаггин and Tom Klein developed the first кремниевый затвор MOS IC.[35]
MOS large-scale integration (MOS LSI)
С этими высокая масштабируемость,[48] and much lower power consumption and higher density than bipolar junction transistors,[51] the MOSFET made it possible to build высокая плотность IC chips.[1] К 1964 году MOS-чипы достигли более высокого уровня transistor density и более низкие производственные затраты, чем биполярный чипсы. Микросхемы МОП стали более сложными со скоростью, предсказанной Закон Мура, что приводит к крупномасштабная интеграция (LSI) with hundreds of MOSFETs on a chip by the late 1960s.[153] MOS technology enabled the integration of more than 10,000 transistors on a single LSI chip by the early 1970s,[154] before later enabling very large-scale integration (VLSI).[50][155]
Микропроцессоры
The MOSFET is the basis of every микропроцессор,[45] and was responsible for the invention of the microprocessor.[156] The origins of both the microprocessor and the микроконтроллер can be traced back to the invention and development of MOS technology. Применение микросхем MOS LSI для вычисление была основой для первых микропроцессоров, поскольку инженеры начали понимать, что полный компьютерный процессор может содержаться на одном кристалле MOS LSI.[153]
В самые ранние микропроцессоры were all MOS chips, built with MOS LSI circuits. Первые многочиповые микропроцессоры Четырехфазные системы AL1 в 1969 г. и Гаррет АйИсследование MP944 в 1970 году были разработаны микросхемы MOS LSI. The first commercial single-chip microprocessor, the Intel 4004, был разработан Федерико Фаггин, using his silicon-gate MOS IC technology, with Intel инженеры Марсиан Хофф и Стэн Мазор, и Бизиком инженер Масатоши Шима.[157] С приходом CMOS microprocessors in 1975, the term "MOS microprocessors" began to refer to chips fabricated entirely from PMOS logic or fabricated entirely from Логика NMOS, contrasted with "CMOS microprocessors" and "bipolar бит-ломтик processors".[158]
CMOS circuits
Цифровой
The growth of digital technologies like the микропроцессор has provided the motivation to advance MOSFET technology faster than any other type of silicon-based transistor.[159] A big advantage of MOSFETs for digital switching is that the oxide layer between the gate and the channel prevents DC current from flowing through the gate, further reducing power consumption and giving a very large input impedance. The insulating oxide between the gate and channel effectively isolates a MOSFET in one logic stage from earlier and later stages, which allows a single MOSFET output to drive a considerable number of MOSFET inputs. Bipolar transistor-based logic (such as TTL ) does not have such a high fanout capacity. This isolation also makes it easier for the designers to ignore to some extent loading effects between logic stages independently. That extent is defined by the operating frequency: as frequencies increase, the input impedance of the MOSFETs decreases.
Аналоговый
The MOSFET's advantages in digital circuits do not translate into supremacy in all analog circuits. The two types of circuit draw upon different features of transistor behavior. Digital circuits switch, spending most of their time either fully on or fully off. The transition from one to the other is only of concern with regards to speed and charge required. Analog circuits depend on operation in the transition region where small changes to VGS can modulate the output (drain) current. The JFET and биполярный переходной транзистор (BJT) are preferred for accurate matching (of adjacent devices in integrated circuits), higher крутизна and certain temperature characteristics which simplify keeping performance predictable as circuit temperature varies.
Nevertheless, MOSFETs are widely used in many types of analog circuits because of their own advantages (zero gate current, high and adjustable output impedance and improved robustness vs. BJTs which can be permanently degraded by even lightly breaking down the emitter-base).[нечеткий ] The characteristics and performance of many analog circuits can be scaled up or down by changing the sizes (length and width) of the MOSFETs used. By comparison, in bipolar transistors the size of the device does not significantly affect its performance.[нужна цитата ] MOSFETs' ideal characteristics regarding gate current (zero) and drain-source offset voltage (zero) also make them nearly ideal switch elements, and also make переключаемый конденсатор analog circuits practical. In their linear region, MOSFETs can be used as precision resistors, which can have a much higher controlled resistance than BJTs. In high power circuits, MOSFETs sometimes have the advantage of not suffering from тепловой разгон as BJTs do.[сомнительный ] Also, MOSFETs can be configured to perform as capacitors and gyrator circuits which allow op-amps made from them to appear as inductors, thereby allowing all of the normal analog devices on a chip (except for diodes, which can be made smaller than a MOSFET anyway) to be built entirely out of MOSFETs. This means that complete analog circuits can be made on a silicon chip in a much smaller space and with simpler fabrication techniques. MOSFETS are ideally suited to switch inductive loads because of tolerance to inductive kickback.
Some ICs combine analog and digital MOSFET circuitry on a single интегральная схема со смешанными сигналами, making the needed board space even smaller. This creates a need to isolate the analog circuits from the digital circuits on a chip level, leading to the use of isolation rings and кремний на изоляторе (ТАК ЧТО Я). Since MOSFETs require more space to handle a given amount of power than a BJT, fabrication processes can incorporate BJTs and MOSFETs into a single device. Mixed-transistor devices are called bi-FETs (bipolar FETs) if they contain just one BJT-FET and BiCMOS (bipolar-CMOS) if they contain complementary BJT-FETs. Such devices have the advantages of both insulated gates and higher current density.
В конце 1980-х гг. Асад Абиди пионер RF CMOS technology, which uses MOS СБИС circuits, while working at UCLA. This changed the way in which ВЧ схемы were designed, away from discrete bipolar transistors and towards CMOS integrated circuits. По состоянию на 2008 г. радиоприемопередатчики в целом беспроводная сеть devices and modern мобильные телефоны are mass-produced as RF CMOS devices. RF CMOS is also used in nearly all modern Bluetooth и Беспроводная сеть (WLAN) devices.[160]
MOS память
The advent of the MOSFET enabled the practical use of MOS transistors as ячейка памяти storage elements, a function previously served by магнитопроводы в память компьютера.[161] The first modern computer memory was introduced in 1965, when John Schmidt at Fairchild Semiconductor designed the first MOS полупроводниковая память, а 64-битный MOS SRAM (static оперативная память ).[162] SRAM became an alternative to магнитная память, but required six MOS transistors for each кусочек данных.[163]
MOS technology is the basis for DRAM (динамический оперативная память ). В 1966 г. Роберт Х. Деннард на IBM Исследовательский центр Томаса Дж. Уотсона работал над MOS память. Изучая характеристики технологии МОП, он обнаружил, что она способна создавать конденсаторы и что сохранение заряда или отсутствие заряда на МОП-конденсаторе может представлять 1 и 0 бита, в то время как МОП-транзистор может управлять записью заряда в конденсатор. Это привело к его разработке ячейки памяти DRAM с одним транзистором.[163] In 1967, Dennard filed a patent under IBM for a single-transistor DRAM (dynamic random-access memory) memory cell, based on MOS technology.[164] MOS memory enabled higher performance, was cheaper, and consumed less power, than магнитная память, leading to MOS memory overtaking magnetic core memory as the dominant память компьютера technology by the early 1970s.[165]
Фрэнк Ванласс, while studying MOSFET structures in 1963, noted the movement of charge through окись на ворота. While he did not pursue it, this idea would later become the basis for EPROM (erasable программируемая постоянная память ) технологии.[166] В 1967 г. Давон Канг и Simon Min Sze предложил, чтобы плавающий затвор memory cells, consisting of floating-gate MOSFETs (FGMOS), could be used to produce reprogrammable ROM (только для чтения памяти ).[167] Ячейки памяти с плавающим затвором впоследствии стали основой для энергонезависимая память (NVM) technologies including EPROM, EEPROM (электрически стираемое программируемое ПЗУ) и флэш-память.[168]
Бытовая электроника
MOSFETs are widely used in бытовая электроника. One of the earliest influential consumer electronic products enabled by MOS LSI circuits was the electronic pocket calculator,[154] as MOS LSI technology enabled large amounts of вычислительный capability in small packages.[169] В 1965 г. Виктор 3900 desktop calculator was the first MOS калькулятор, with 29 MOS chips.[170] В 1967 г. Инструменты Техаса Cal-Tech was the first prototype electronic handheld calculator, with three MOS LSI chips, and it was later released as the Canon Pocketronic in 1970.[171] В Sharp QT-8D desktop calculator was the first mass-produced LSI MOS calculator in 1969,[172] и Sharp EL-8 which used four MOS LSI chips was the first commercial electronic handheld calculator in 1970.[171] The first true electronic pocket calculator was the Бизиком LE-120A HANDY LE, which used a single MOS LSI calculator-on-a-chip из Mostek, and was released in 1971.[171] By 1972, MOS LSI circuits were commercialized for numerous other applications.[173]
MOSFETs are fundamental to информационные и коммуникационные технологии (ИКТ),[66][79] включая современные компьютеры,[174][146][155] современное вычисление,[175] телекоммуникации, то инфраструктура связи,[174][176] то Интернет,[174][72][177] цифровая телефония,[178] беспроводной telecommunications,[179][180] и мобильные сети.[180] According to Colinge, the modern компьютерная промышленность и цифровая связь Системы не существовали бы без MOSFET.[146] Достижения в области технологии МОП были наиболее важным фактором быстрого роста пропускная способность сети в телекоммуникационные сети, с удвоением пропускной способности каждые 18 месяцев, от бит в секунду к терабит в секунду (Закон Эдхольма ).[181]
МОП-сенсоры
MOS датчики, также известные как датчики MOSFET, широко используются для измерения физический, химический, биологический и относящийся к окружающей среде параметры.[130] В ионно-чувствительный полевой транзистор (ISFET), например, широко используется в биомедицинский Приложения.[132]
МОП-транзисторы также широко используются в микроэлектромеханические системы (MEMS), поскольку кремниевые МОП-транзисторы могут взаимодействовать и взаимодействовать с окружающей средой и обрабатывать такие вещи, как химикаты, движения и свет.[182] Ранним примером устройства MEMS является транзистор с резонансным затвором, адаптация полевого МОП-транзистора, разработанный Харви С. Натансон в 1965 г.[183]
МОП-технология - основа современных датчики изображения, в том числе устройство с зарядовой связью (CCD) и CMOS датчик с активным пикселем (Датчик CMOS), используемый в цифровое изображение и цифровые фотоаппараты.[77] Уиллард Бойл и Джордж Э. Смит разработали ПЗС-матрицу в 1969 году. Изучая процесс МОП, они поняли, что электрический заряд является аналогом магнитного пузыря и что он может храниться на крошечном МОП-конденсаторе. Поскольку было довольно просто изготовить серию МОП-конденсаторов в ряд, они подключали к ним подходящее напряжение, чтобы заряд мог переходить от одного к другому.[77] ПЗС-матрица - это полупроводниковая схема, которая позже использовалась в первом цифровые видеокамеры за телевизионное вещание.[184]
Мос датчик с активным пикселем (APS) был разработан Цутому Накамура в Олимп в 1985 г.[185] Датчик CMOS с активными пикселями позже был разработан Эрик Фоссум и его команда в НАСА с Лаборатория реактивного движения в начале 1990-х гг.[186]
МОП-датчики изображения широко используются в Оптическая мышь технологии. Первая оптическая мышь, изобретенная Ричард Ф. Лайон в Ксерокс в 1980 году использовали 5 мкм NMOS сенсорный чип.[187][188] Начиная с первой коммерческой оптической мыши, IntelliMouse представленные в 1999 году, большинство оптических мышей используют датчики CMOS.[189]
Силовые МОП-транзисторы
В силовой MOSFET это наиболее широко используемый силовое устройство в мире.[4] Преимущества перед биполярные переходные транзисторы в силовая электроника включают в себя полевые МОП-транзисторы, не требующие непрерывного потока управляющего тока, чтобы оставаться во включенном состоянии, предлагая более высокие скорости переключения, более низкие потери мощности переключения, меньшее сопротивление в открытом состоянии и пониженную подверженность тепловому разгоне.[190] Силовой MOSFET оказал влияние на Источники питания, что позволяет увеличить рабочие частоты, уменьшить размер и вес, а также увеличить объемы производства.[191]
Импульсные источники питания являются наиболее распространенными приложениями для силовых полевых МОП-транзисторов.[53] Они также широко используются для MOS Усилители мощности RF, что позволило осуществить переход мобильные сети от аналогового к цифровому в 1990-е годы. Это привело к широкому распространению беспроводных мобильных сетей, что произвело революцию телекоммуникационные системы.[179] В LDMOS в частности, это наиболее широко используемый усилитель мощности в мобильных сетях, таких как 2G, 3G,[179] 4G, и 5G.[180]Более 50 миллиарда полевых МОП-транзисторов дискретной мощности отгружается ежегодно, по состоянию на 2018 год. Они широко используются для автомобильный, промышленный и системы связи особенно.[192] Силовые МОП-транзисторы обычно используются в автомобильная электроника, особенно как коммутационные устройства в электронные блоки управления,[193] и, как преобразователи мощности в современном электрические транспортные средства.[194] В биполярный транзистор с изолированным затвором (IGBT), гибридный биполярный МОП-транзистор, также используется в самых разных приложениях.[195]
Строительство
Материал ворот
Основным критерием выбора материала ворот является то, что это хороший дирижер. Сильно легированный поликристаллический кремний является приемлемым, но, конечно, не идеальным проводником, а также страдает некоторыми техническими недостатками в своей роли стандартного материала затвора. Тем не менее, есть несколько причин в пользу использования поликремния:
- В пороговое напряжение (и, следовательно, сток к источнику по току) модифицируется рабочая функция разница между материалом затвора и материалом канала. Поскольку поликремний является полупроводником, его работу выхода можно модулировать, регулируя тип и уровень легирования. Кроме того, поскольку поликремний имеет такое же запрещенная зона в качестве основного кремниевого канала довольно просто настроить работу выхода для достижения низких пороговых напряжений как для устройств NMOS, так и для устройств PMOS. Напротив, работу выхода металлов нелегко модулировать, поэтому настройка рабочая функция чтобы получить низкие пороговые напряжения (LVT) становится серьезной проблемой. Кроме того, получение низкопороговых устройств на устройствах PMOS и NMOS иногда требует использования разных металлов для каждого типа устройства. Хотя биметаллические интегральные схемы (т. Е. Один тип металла для электродов затвора NFETS и второй тип металла для электродов затвора PFETS) не распространены, они известны в патентной литературе и дают некоторые преимущества с точки зрения настройки электрических схем в целом. электрические характеристики.
- Кремний-SiO2 Интерфейс хорошо изучен и, как известно, имеет относительно небольшое количество дефектов. Напротив, многие границы раздела металл-изолятор содержат значительные уровни дефектов, которые могут привести к Пиннинг уровня Ферми, зарядка или другие явления, которые в конечном итоге ухудшают производительность устройства.
- В МОП-транзисторе Изготовление ИС В процессе, предпочтительно наносить материал затвора перед определенными высокотемпературными этапами, чтобы получить транзисторы с лучшими характеристиками. Такие высокотемпературные этапы плавили бы некоторые металлы, ограничивая типы металлов, которые можно использовать в процессе на основе металлических затворов.
Хотя ворота из поликремния были стандартом де-факто в течение последних двадцати лет, у них действительно есть некоторые недостатки, которые привели к их вероятной замене в будущем металлическими воротами. К этим недостаткам можно отнести:
- Поликремний не является хорошим проводником (примерно в 1000 раз более резистивным, чем металлы), что снижает скорость распространения сигнала через материал. Удельное сопротивление можно снизить, увеличив уровень легирования, но даже сильно легированный поликремний не так проводит, как большинство металлов. Для дальнейшего улучшения проводимости иногда используют высокотемпературный металл, например вольфрам, титан, кобальт, и совсем недавно никель легирован верхними слоями поликремния. Такой смешанный материал называется силицид. Комбинация силицида и поликремния имеет лучшие электрические свойства, чем один поликремний, и все же не плавится при последующей обработке. Кроме того, пороговое напряжение не намного выше, чем у одного поликремния, потому что силицидный материал не находится вблизи канала. Процесс, в котором силицид образуется как на электроде затвора, так и в областях истока и стока, иногда называют салицид, самовыравнивающийся силицид.
- Когда транзисторы сильно уменьшены в масштабе, необходимо сделать диэлектрический слой затвора очень тонким, около 1 нм в современных технологиях. Здесь наблюдается явление так называемого поли истощение, где обедненный слой формируется в слое поликремния затвора рядом с диэлектриком затвора, когда транзистор находится в инверсии. Чтобы избежать этой проблемы, желательна металлическая калитка. Разнообразные металлические ворота, такие как тантал, вольфрам, нитрид тантала, и нитрид титана используются, как правило, вместе с диэлектрики с высоким КП. Альтернативой является использование затворов из полностью кремниевого кремния, процесс, известный как FUSI.
Современные высокопроизводительные процессоры используют технологию металлических ворот вместе с диэлектрики с высоким КП, комбинация, известная как высокие κ, металлические ворота (HKMG). Недостатки металлических ворот преодолеваются несколькими приемами:[196]
- Пороговое напряжение регулируется путем включения тонкого слоя «металла с работой выхода» между диэлектриком с высоким κ и основным металлом. Этот слой достаточно тонкий, чтобы на полную работу выхода затвора влиять как работа выхода основного металла, так и работа выхода тонкого металла (либо из-за легирования во время отжига, либо просто из-за неполного экранирования тонким металлом). Таким образом, пороговое напряжение можно регулировать толщиной тонкого металлического слоя.
- Диэлектрики с высоким k в настоящее время хорошо изучены, и их дефекты понятны.
- Существуют процессы HKMG, которые не требуют от металлов высокотемпературных отжигов; другие процессы выбирают металлы, которые могут выдержать стадию отжига.
Изолятор
По мере того, как устройства становятся меньше, изолирующие слои становятся тоньше, часто за счет термическое окисление или локализованное окисление кремния (LOCOS ). Для наноразмерных устройств в какой-то момент туннелирование носителей через изолятор от канала до электрода затвора. Чтобы уменьшить полученный утечка тока, изолятор можно сделать тоньше, выбрав материал с более высокой диэлектрической проницаемостью. Чтобы увидеть, как связаны толщина и диэлектрическая проницаемость, обратите внимание, что Закон Гаусса связывает поле с зарядом как:
с Q = плотность заряда, κ = диэлектрическая проницаемость, ε0 = диэлектрическая проницаемость пустого пространства и E = электрическое поле. Из этого закона следует, что такой же заряд может поддерживаться в канале при более низком поле при увеличении κ. Напряжение на затворе определяется по формуле:
с Vграмм = напряжение затвора, Vch = напряжение на стороне канала изолятора, и тins = толщина изолятора. Это уравнение показывает, что напряжение затвора не будет увеличиваться при увеличении толщины изолятора при условии, что κ увеличивается для сохранения тins / κ = константа (см. статью о диэлектриках с высоким κ для более подробной информации, а также раздел этой статьи, посвященный утечка оксида затвора ).
Изолятор в полевом МОП-транзисторе представляет собой диэлектрик, который в любом случае может быть оксидом кремния, образованным LOCOS но используются многие другие диэлектрические материалы. Общий термин для диэлектрика - диэлектрик затвора, поскольку диэлектрик находится непосредственно под электродом затвора и над каналом полевого МОП-транзистора.
Конструкция стыков

Исток-тело и сток-тело перекрестки являются объектом пристального внимания по трем основным причинам: их дизайн влияет на ток – напряжение (I – V) характеристики устройства, снижая выходное сопротивление, а также скорость устройства за счет воздействия нагрузки на переход емкости и, наконец, составляющая рассеиваемой мощности в режиме ожидания из-за утечки через переход.
Сток индуцировал снижение порогового напряжения барьера и модуляция длины канала воздействие на I-V кривые уменьшаются за счет использования неглубоких переходов. Кроме того, гало Можно использовать легирование, то есть добавление очень тонких сильно легированных областей того же типа легирования, что и тело, плотно прилегающее к стенкам перехода, чтобы ограничить степень области истощения.[197]
Емкостные эффекты ограничиваются за счет использования выпуклой геометрии истока и стока, которая делает большую часть границы контактной области толстым диэлектриком вместо кремния.[198]
Показаны эти различные особенности конструкции разветвления (с художественная лицензия ) на рисунке.
Масштабирование
Эта секция написано как личное размышление, личное эссе или аргументированное эссе который излагает личные чувства редактора Википедии или представляет оригинальный аргумент по теме. (Сентябрь 2016) (Узнайте, как и когда удалить этот шаблон сообщения) |


| Полупроводник устройство изготовление |
|---|
 |
(технологические узлы ) |
За последние десятилетия размер полевого МОП-транзистора (который используется для цифровой логики) постоянно уменьшался; типичная длина канала MOSFET когда-то составляла несколько микрометры, но современные интегральные схемы включают полевые МОП-транзисторы с длиной канала в десятки нанометров. Роберт Деннард работает над теория масштабирования сыграло решающую роль в признании того, что продолжающееся сокращение возможно. Полупроводниковая промышленность поддерживает «дорожную карту», ITRS,[199] что задает темп развития MOSFET. Исторически сложилось так, что трудности с уменьшением размера полевого МОП-транзистора были связаны с процессом изготовления полупроводниковых устройств, необходимостью использования очень низких напряжений, а также с более низкими электрическими характеристиками, требующими перепроектирования схемы и инноваций (малые МОП-транзисторы демонстрируют более высокие токи утечки и меньшее выходное сопротивление. ). По состоянию на 2019 год самые маленькие полевые МОП-транзисторы в производстве 5 нм FinFET полупроводниковые узлы, изготовлены по Samsung Electronics и TSMC.[200][201]
Полевые МОП-транзисторы меньшего размера желательны по нескольким причинам. Основная причина уменьшить размер транзисторов - это разместить все больше и больше устройств в определенной области кристалла. В результате получается микросхема с той же функциональностью на меньшей площади или микросхемы с большей функциональностью на той же площади. Поскольку стоимость изготовления полупроводниковая пластина относительно фиксированы, стоимость интегральных схем в основном связана с количеством микросхем, которые могут быть произведены на пластине. Следовательно, меньшие ИС позволяют использовать больше микросхем на пластину, что снижает цену за кристалл. Фактически, за последние 30 лет количество транзисторов на микросхему удваивалось каждые 2-3 года после внедрения нового технологического узла. Например, количество полевых МОП-транзисторов в микропроцессоре, изготовленном в 45 нм технологий может быть вдвое больше, чем в 65 нм чип. Это удвоение плотности транзисторов впервые наблюдал Гордон Мур в 1965 году и обычно упоминается как Закон Мура.[202] Также ожидается, что транзисторы меньшего размера переключаются быстрее. Например, одним из подходов к уменьшению размера является масштабирование полевого МОП-транзистора, которое требует пропорционального уменьшения всех размеров устройства. Основными размерами устройства являются длина канала, ширина канала и толщина оксида. При их уменьшении в равные коэффициенты сопротивление канала транзистора не изменяется, в то время как емкость затвора сокращается этим фактором. Следовательно RC задержка транзистора масштабируется с аналогичным коэффициентом. Хотя это традиционно имело место для старых технологий, для современных полевых МОП-транзисторов уменьшение размеров транзисторов не обязательно приводит к более высокой скорости микросхемы, поскольку задержка из-за межсоединений более значительна.
Производство полевых МОП-транзисторов с длиной канала намного меньше, чем микрометр является проблемой, и трудности производства полупроводниковых устройств всегда являются ограничивающим фактором в развитии технологии интегральных схем. Хотя такие процессы, как ALD улучшили производство небольших компонентов, малый размер полевого МОП-транзистора (менее нескольких десятков нанометров) создал эксплуатационные проблемы:
- Высшая подпороговая проводимость
- Поскольку геометрия полевого МОП-транзистора сужается, напряжение, которое может быть приложено к затвору, должно быть уменьшено для сохранения надежности. Для поддержания производительности необходимо также снизить пороговое напряжение полевого МОП-транзистора. Поскольку пороговое напряжение снижается, транзистор не может быть переключен с полного выключения на полное включение с ограниченным размахом напряжения; схема является компромиссом между сильным током в на корпус и низкий ток в выключенный случае, и приложение определяет, отдавать ли одно предпочтение другому. Допороговая утечка (включая подпороговую проводимость, утечку через оксид затвора и утечку с обратным смещением), которая игнорировалась в прошлом, теперь может потреблять более половины общей потребляемой мощности современных высокопроизводительных микросхем СБИС.[203][204]
- Повышенная утечка оксида затвора
- Оксид затвора, который служит изолятором между затвором и каналом, должен быть как можно более тонким, чтобы увеличить проводимость канала и производительность, когда транзистор включен, и уменьшить подпороговую утечку, когда транзистор выключен. Однако с оксидами на затворе тока толщиной около 1,2нм (что в кремнии составляет ~ 5атомы толстый) квантово-механический феномен электронное туннелирование происходит между затвором и каналом, что приводит к увеличению энергопотребления. Диоксид кремния традиционно использовался в качестве изолятора затвора. Однако диоксид кремния имеет умеренную диэлектрическую проницаемость. Увеличение диэлектрической проницаемости диэлектрика затвора позволяет получить более толстый слой при сохранении высокой емкости (емкость пропорциональна диэлектрической проницаемости и обратно пропорциональна толщине диэлектрика). При прочих равных, более высокая толщина диэлектрика снижает квантовое туннелирование ток через диэлектрик между затвором и каналом. Изоляторы с большей диэлектрическая постоянная чем диоксид кремния (называемый диэлектрики с высоким КП ), такие как силикаты металлов IVb группы, например гафний и цирконий силикаты и оксиды используются для уменьшения утечки затвора, начиная с технологического узла 45 нанометров и далее. С другой стороны, важным фактором является высота барьера нового изолятора ворот; разница в зона проводимости энергия между полупроводником и диэлектриком (и соответствующая разница в валентная полоса энергия) также влияет на уровень тока утечки. Для традиционного оксида затвора, диоксида кремния, первый барьер составляет примерно 8 эВ. Для многих альтернативных диэлектриков это значение значительно ниже, что приводит к увеличению туннельного тока, что несколько сводит на нет преимущество более высокой диэлектрической проницаемости. Максимальное напряжение затвор-исток определяется силой электрического поля, которое может выдерживать диэлектрик затвора до того, как произойдет значительная утечка. По мере того, как изолирующий диэлектрик становится тоньше, напряженность электрического поля внутри него увеличивается до фиксированного напряжения. Это требует использования более низких напряжений с более тонким диэлектриком.
- Повышенная утечка в переходах
- Чтобы сделать устройства меньше, конструкция соединений стала более сложной, что привело к увеличению допинг уровни, более мелкие переходы, легирование "гало" и т. д.,[205][206] все для уменьшения снижения барьера, вызванного дренажем (см. конструкция соединения ). Чтобы сохранить эти сложные переходы на месте, необходимо сократить количество этапов отжига, которые ранее использовались для удаления повреждений и электрически активных дефектов.[207] увеличение утечки в переходах. Более сильное легирование также связано с более тонкими обедненными слоями и большим количеством центров рекомбинации, что приводит к увеличению тока утечки даже без повреждения решетки.
- Снижение дренажного барьера (DIBL) и VТ скатиться
- Из-за эффект короткого канала, формирование канала не полностью выполняется затвором, но теперь сток и исток также влияют на формирование канала. По мере уменьшения длины канала обедненные области истока и стока сближаются и создают пороговое напряжение (VТ) функция длины канала. Это называется VТ скатывание. VТ также становится функцией напряжения стока в исток VDS. По мере увеличения VDSобласти истощения увеличиваются в размерах, и значительная часть заряда истощается за счет VDS. Затем снижается напряжение затвора, необходимое для формирования канала, и, таким образом, VТ уменьшается с увеличением VDS. Этот эффект называется понижением барьера, вызванным стоком (DIBL).
- Более низкое выходное сопротивление
- Для аналоговой работы хорошее усиление требует высокого выходного сопротивления полевого МОП-транзистора, то есть ток полевого МОП-транзистора должен незначительно изменяться в зависимости от приложенного напряжения сток-исток. По мере того, как устройства становятся меньше, влияние стока более успешно конкурирует с влиянием затвора из-за растущей близости этих двух электродов, увеличивая чувствительность тока MOSFET к напряжению стока. Чтобы противодействовать результирующему снижению выходного сопротивления, схемы усложняются, либо требуется больше устройств, например каскод и каскадные усилители, или схемой обратной связи с использованием операционные усилители, например, схема, подобная изображенной на соседнем рисунке.
- Более низкая крутизна
- В крутизна полевого МОП-транзистора определяет его усиление и пропорционально отверстию или подвижность электронов (в зависимости от типа устройства), по крайней мере, для низкого напряжения стока. По мере уменьшения размера полевого МОП-транзистора поля в канале увеличиваются, а уровни легирующих примесей увеличиваются. Оба изменения уменьшают подвижность несущей и, следовательно, крутизну. Поскольку длина канала уменьшается без пропорционального уменьшения напряжения стока, что приводит к увеличению электрического поля в канале, результатом является скоростное насыщение носителей, ограничивающее ток и крутизну.
- Емкость межсоединения
- Традиционно время переключения было примерно пропорционально емкости затвора затворов. Однако, поскольку транзисторы становятся меньше и больше транзисторов размещается на кристалле, межсоединительная емкость (емкость соединений металлического слоя между различными частями микросхемы) становится большим процентом емкости.[208][209] Сигналы должны проходить через межсоединение, что приводит к увеличению задержки и снижению производительности.
- Производство тепла
- Постоянно увеличивающаяся плотность полевых МОП-транзисторов в интегральной схеме создает проблемы значительного локального тепловыделения, которое может ухудшить работу схемы. Цепи работают медленнее при высоких температурах, имеют меньшую надежность и меньший срок службы. Радиаторы и другие охлаждающие устройства и методы теперь требуются для многих интегральных схем, включая микропроцессоры. Силовые МОП-транзисторы находятся под угрозой тепловой разгон. Поскольку их сопротивление в открытом состоянии увеличивается с температурой, если нагрузка является приблизительно постоянной нагрузкой, тогда соответственно возрастают потери мощности, выделяя дополнительное тепло. Когда радиатор не может поддерживать достаточно низкую температуру, температура перехода может быстро и неконтролируемо расти, что приведет к разрушению устройства.
- Варианты процесса
- По мере того, как полевые МОП-транзисторы становятся меньше, количество атомов в кремнии, которые создают многие из свойств транзистора, становится меньше, в результате чего контроль количества и размещения примесей становится более беспорядочным. Во время производства микросхемы случайные изменения процесса влияют на все размеры транзистора: длину, ширину, глубину перехода, толщину оксида. и Т. Д., и увеличиваются в процентах от общего размера транзистора по мере его сжатия. Характеристики транзистора становятся менее определенными, более статистическими. Случайный характер производства означает, что мы не знаем, какой конкретный пример МОП-транзистора на самом деле окажется в конкретном экземпляре схемы. Эта неопределенность вынуждает выбрать менее оптимальную конструкцию, поскольку она должна работать для большого количества возможных компонентных полевых МОП-транзисторов. Видеть вариация процесса, дизайн на технологичность, инженерия надежности, и Статистическое управление процессами.[210]
- Проблемы моделирования
- Современные ИС моделируются на компьютере с целью получения рабочих схем из самой первой произведенной партии. Поскольку устройства миниатюрны, сложность обработки затрудняет точное предсказание того, как будут выглядеть конечные устройства, а моделирование физических процессов также становится более сложной задачей. Кроме того, микроскопические вариации в структуре просто из-за вероятностной природы атомных процессов требуют статистических (а не только детерминированных) предсказаний. Сочетание этих факторов затрудняет адекватное моделирование и изготовление «правильного с первого раза».
Связанное правило масштабирования Закон Эдхольма. В 2004 году Фил Эдхольм заметил, что пропускная способность из телекоммуникационные сети (в том числе Интернет ) удваивается каждые 18 месяцев.[211] В течение нескольких десятилетий пропускная способность сети связи поднялся из бит в секунду к терабит в секунду. Быстрый рост телекоммуникации Полоса пропускания во многом обусловлена тем же масштабированием MOSFET, которое позволяет использовать закон Мура, поскольку телекоммуникационные сети построены на MOSFET.[181]
График
PMOS и NMOS
| Дата | Длина канала | Толщина оксида[212] | МОП-транзистор логика | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|---|
| Июнь 1960 г. | 20000 нм | 100 нм | PMOS | Мохамед М. Аталла, Давон Канг | Bell Telephone Laboratories | [213][214] |
| NMOS | ||||||
| 10,000 нм | 100 нм | PMOS | Мохамед М. Аталла, Давон Канг | Bell Telephone Laboratories | [215] | |
| NMOS | ||||||
| Май 1965 г. | 8000 нм | 150 нм | NMOS | Чи-Тан Сах, Отто Лейстико, А.С. Grove | Fairchild Semiconductor | [216] |
| 5000 нм | 170 нм | PMOS | ||||
| Декабрь 1972 г. | 1000 нм | ? | PMOS | Роберт Х. Деннард, Фриц Х. Гэнсслен, Хва-Ниен Ю | IBM T.J. Исследовательский центр Уотсона | [217][218][219] |
| 1973 | 7500 нм | ? | NMOS | Сохичи Сузуки | NEC | [220][221] |
| 6000 нм | ? | PMOS | ? | Toshiba | [222][223] | |
| Октябрь 1974 г. | 1000 нм | 35 нм | NMOS | Роберт Х. Деннард, Фриц Х. Гэнсслен, Хва-Ниен Ю | IBM T.J. Исследовательский центр Уотсона | [224] |
| 500 нм | ||||||
| Сентябрь 1975 г. | 1500 нм | 20 нм | NMOS | Рёити Хори, Хироо Масуда, Осаму Минато | Hitachi | [218][225] |
| Март 1976 г. | 3000 нм | ? | NMOS | ? | Intel | [226] |
| Апрель 1979 г. | 1000 нм | 25 нм | NMOS | Уильям Р. Хантер, Л. М. Эфрат, Элис Крамер | IBM T.J. Исследовательский центр Уотсона | [227] |
| Декабрь 1984 г. | 100 нм | 5 нм | NMOS | Тосио Кобаяси, Сэйдзи Хоригучи, К. Киучи | Nippon Telegraph and Telephone | [228] |
| Декабрь 1985 г. | 150 нм | 2,5 нм | NMOS | Тосио Кобаяси, Сэйдзи Хоригучи, М. Мияке, М. Ода | Nippon Telegraph and Telephone | [229] |
| 75 нм | ? | NMOS | Стивен Ю. Чоу, Генри И. Смит, Димитри А. Антониадис | Массачусетский технологический институт | [230] | |
| Январь 1986 | 60 нм | ? | NMOS | Стивен Ю. Чоу, Генри И. Смит, Димитри А. Антониадис | Массачусетский технологический институт | [231] |
| Июнь 1987 г. | 200 нм | 3,5 нм | PMOS | Тосио Кобаяси, М. Мияке, К. Дегучи | Nippon Telegraph and Telephone | [232] |
| Декабрь 1993 г. | 40 нм | ? | NMOS | Мизуки Оно, Масанобу Сайто, Такаши Ёситоми | Toshiba | [233] |
| Сентябрь 1996 | 16 нм | ? | PMOS | Хисао Каваура, Тосицугу Сакамото, Тосио Баба | NEC | [234] |
| Июнь 1998 г. | 50 нм | 1,3 нм | NMOS | Халед З. Ахмед, Эффионг Э. Ибок, Мирён Сон | Продвинутые Микроустройства (AMD) | [235][236] |
| Декабрь 2002 г. | 6 нм | ? | PMOS | Брюс Дорис, Омер Докумачи, Мэйкей Ионг | IBM | [237][238][239] |
| Декабрь 2003 г. | 3 нм | ? | PMOS | Хитоши Вакабаяши, Сигехару Ямагами | NEC | [240][238] |
| NMOS |
CMOS (одностворчатый)
| Дата | Длина канала | Толщина оксида[212] | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|
| Февраль 1963 г. | ? | ? | Чи-Тан Сах, Фрэнк Ванласс | Fairchild Semiconductor | [241][242] |
| 1968 | 20,000 нм | 100 нм | ? | RCA лаборатории | [243] |
| 1970 | 10,000 нм | 100 нм | ? | RCA лаборатории | [243] |
| Декабрь 1976 г. | 2000 нм | ? | А. Айткен, Р.Г. Поульсен, A.T.P. Макартур, Дж. Дж. белый | Mitel Semiconductor | [244] |
| Февраль 1978 г. | 3000 нм | ? | Тошиаки Масухара, Осаму Минато, Тошио Сасаки, Ёсио Сакаи | Центральная исследовательская лаборатория Hitachi | [245][246][247] |
| Февраль 1983 г. | 1200 нм | 25 нм | R.J.C. Chwang, M. Choi, D. Creek, S. Stern, P.H. Пелли | Intel | [248][249] |
| 900 нм | 15 нм | Цунео Мано, Дж. Ямада, Дзюнъити Иноуэ, С. Накадзима | Nippon Telegraph and Telephone (NTT) | [248][250] | |
| Декабрь 1983 г. | 1000 нм | 22,5 нм | G.J. Ху, Юань Таур, Роберт Х. Деннард, Чунг-Ю Тин | IBM T.J. Исследовательский центр Уотсона | [251] |
| Февраль 1987 г. | 800 нм | 17 нм | Т. Суми, Цунео Танигучи, Микио Кисимото, Хиросигэ Хирано | Мацусита | [248][252] |
| 700 нм | 12 нм | Цунео Мано, Дж. Ямада, Дзюнъити Иноуэ, С. Накадзима | Nippon Telegraph and Telephone (NTT) | [248][253] | |
| Сентябрь 1987 г. | 500 нм | 12,5 нм | Хусейн И. Ханафи, Роберт Х. Деннард, Юань Таур, Надим Ф. Хаддад | IBM T.J. Исследовательский центр Уотсона | [254] |
| Декабрь 1987 г. | 250 нм | ? | Наоки Касаи, Нобухиро Эндо, Хироши Китадзима | NEC | [255] |
| Февраль 1988 г. | 400 нм | 10 нм | М. Иноуэ, Х. Котани, Т. Ямада, Хироюки Ямаути | Мацусита | [248][256] |
| Декабрь 1990 г. | 100 нм | ? | Гавам Г. Шахиди, Биджан Давари, Юань Таур, Джеймс Д. Варнок | IBM T.J. Исследовательский центр Уотсона | [257] |
| 1993 | 350 нм | ? | ? | Sony | [258] |
| 1996 | 150 нм | ? | ? | Mitsubishi Electric | |
| 1998 | 180 нм | ? | ? | TSMC | [259] |
| Декабрь 2003 г. | 5 нм | ? | Хитоши Вакабаяси, Сигехару Ямагами, Нобуюки Икэдзава | NEC | [240][260] |
Многозатворный полевой МОП-транзистор (MuGFET)
| Дата | Длина канала | MuGFET тип | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|
| Август 1984 г. | ? | ДГМОС | Тосихиро Секигава, Ютака Хаяси | Электротехническая лаборатория (ETL) | [261] |
| 1987 | 2000 нм | ДГМОС | Тосихиро Секигава | Электротехническая лаборатория (ЭТЛ) | [262] |
| Декабрь 1988 г. | 250 нм | ДГМОС | Биджан Давари, Вен-Син Чанг, Мэтью Р. Уордеман, C.S. Oh | IBM T.J. Исследовательский центр Уотсона | [263][264] |
| 180 нм | |||||
| ? | GAAFET | Фудзио Масуока, Хироши Такато, Казумаса Суноути, Н. Окабе | Toshiba | [265][266][267] | |
| Декабрь 1989 г. | 200 нм | FinFET | Диг Хисамото, Тору Кага, Ёсифуми Кавамото, Эйдзи Такеда | Центральная исследовательская лаборатория Hitachi | [268][269][270] |
| Декабрь 1998 | 17 нм | FinFET | Диг Хисамото, Ченмин Ху, Цу-Джэ Кинг Лю, Джеффри Бокор | Калифорнийский университет (Беркли) | [271][272] |
| 2001 | 15 нм | FinFET | Ченмин Ху, Ян-Гю Чой, Ник Линдерт, Цу-Джэ Кинг Лю | Калифорнийский университет (Беркли) | [271][273] |
| Декабрь 2002 г. | 10 нм | FinFET | Шибли Ахмед, Скотт Белл, Сайрус Табери, Джеффри Бокор | Калифорнийский университет (Беркли) | [271][274] |
| Июнь 2006 г. | 3 нм | GAAFET | Хёнджин Ли, Ян-кю Чой, Ли-Ын Ю, Сон-Ван Рю | KAIST | [275][276] |
Другие типы MOSFET
| Дата | Длина канала | Толщина оксида[212] | МОП-транзистор тип | Исследователь (ы) | Организация | Ссылка |
|---|---|---|---|---|---|---|
| Октябрь 1962 г. | ? | ? | TFT | Пол К. Веймер | RCA лаборатории | [277][278] |
| 1965 | ? | ? | GaAs | Х. Беке, Р. Холл, Дж. Уайт | RCA лаборатории | [279] |
| Октябрь 1966 г. | 100000 нм | 100 нм | TFT | Т. Броуди, Е. Куниг | Westinghouse Electric | [280][281] |
| Август 1967 г. | ? | ? | ФГМОС | Давон Канг, Саймон Мин Сзе | Bell Telephone Laboratories | [282] |
| Октябрь 1967 | ? | ? | MNOS | Х.А. Ричард Вегенер, А.Дж. Линкольн, Х. Пао | Sperry Corporation | [283] |
| Июль 1968 г. | ? | ? | БиМОС | Хун-Чан Линь, Рамачандра Р. Айер | Westinghouse Electric | [284][285] |
| Октябрь 1968 г. | ? | ? | BiCMOS | Хун-Чан Линь, Рамачандра Р. Айер, C.T. Хо | Westinghouse Electric | [286][285] |
| 1969 | ? | ? | VMOS | ? | Hitachi | [287][288] |
| Сентябрь 1969 | ? | ? | DMOS | Ю. Таруи, Ю. Хаяси, Тосихиро Секигава | Электротехническая лаборатория (ETL) | [289][290] |
| Октябрь 1970 г. | ? | ? | ISFET | Пит Бергвельд | Университет Твенте | [291][292] |
| Октябрь 1970 г. | 1000 нм | ? | DMOS | Ю. Таруи, Ю. Хаяси, Тосихиро Секигава | Электротехническая лаборатория (ЭТЛ) | [293] |
| 1977 | ? | ? | VDMOS | Джон Луи Молл | Лаборатория HP | [287] |
| ? | ? | LDMOS | ? | Hitachi | [294] | |
| Июль 1979 г. | ? | ? | IGBT | Бантвал Джаянт Балига, Маргарет Лазери | General Electric | [295] |
| Декабрь 1984 г. | 2000 нм | ? | BiCMOS | Х. Хигучи, Горо Кицукава, Такахидэ Икеда, Я. Нишио | Hitachi | [296] |
| Май 1985 г. | 300 нм | ? | ? | К. Дегучи, Кадзухико Комацу, М. Мияке, Х. Намацу | Nippon Telegraph and Telephone | [297] |
| Февраль 1985 г. | 1000 нм | ? | BiCMOS | Х. Момосе, Хидеки Сибата, С. Сайто, Дзюн-ичи Миямото | Toshiba | [298] |
| Ноябрь 1986 | 90 нм | 8,3 нм | ? | Хан-Шэн Ли, L.C. Puzio | Дженерал Моторс | [299] |
| Декабрь 1986 | 60 нм | ? | ? | Гавам Г. Шахиди, Димитрий А. Антониадис, Генри И. Смит | Массачусетский технологический институт | [300][231] |
| Май 1987 г. | ? | 10 нм | ? | Биджан Давари, Чунг-Ю Тинг, Ки Й. Ан, С. Басаваия | IBM T.J. Исследовательский центр Уотсона | [301] |
| Декабрь 1987 г. | 800 нм | ? | BiCMOS | Роберт Х. Хавеманн, Р. Э. Эклунд, Хип В. Тран | Инструменты Техаса | [302] |
| Июнь 1997 г. | 30 нм | ? | EJ-МОП-транзистор | Хисао Каваура, Тосицугу Сакамото, Тосио Баба | NEC | [303] |
| 1998 | 32 нм | ? | ? | ? | NEC | [238] |
| 1999 | 8 нм | |||||
| Апрель 2000 г. | 8 нм | ? | EJ-МОП-транзистор | Хисао Каваура, Тосицугу Сакамото, Тосио Баба | NEC | [304] |
Смотрите также
- BSIM
- ggNMOS
- Транзистор с высокой подвижностью электронов
- Эффект истощения поликремния
- Квантовый эффект Холла
- Модель транзистора
- Собственный диод
Рекомендации
- ^ а б c "Кто изобрел транзистор?". Музей истории компьютеров. 4 декабря 2013 г.. Получено 20 июля 2019.
- ^ Лоус, Дэвид (2 апреля 2018 г.). "13 секстиллионов и счет: длинный и извилистый путь к самому часто производимому человеческому артефакту в истории". Музей истории компьютеров. Получено 5 мая, 2020.
- ^ а б c Эшли, Кеннет Л. (2002). Аналоговая электроника с LabVIEW. Prentice Hall Professional. п. 10. ISBN 978-0130470652.
В недавнем учебнике по аналоговым интегральным схемам (Jorns and Martin, 1997) используется подход, согласно которому в таких схемах в настоящее время полностью доминируют полевые МОП-транзисторы, но включены некоторые приложения BJT. (...) MOSFET постепенно стал самым важным транзистором, с повышенным вниманием к интегральным схемам и улучшенным скоростям.
- ^ а б c d "Основы силового MOSFET" (PDF). Alpha & Omega Semiconductor. Получено 29 июля 2019.
Силовые МОП-транзисторы (полевые транзисторы на основе оксидов металлов и полупроводников) являются наиболее часто используемыми силовыми устройствами из-за их низкой мощности управления затвором, высокой скорости переключения и превосходной возможности параллельного подключения.
- ^ Бакши, У. А .; Годсе, А. П. (2007). "§8.2 Режим истощения MOSFET". Электронные схемы. Технические публикации. п. 812. ISBN 978-81-8431-284-3.
- ^ Лилиенфельд, Юлиус Эдгар (1926-10-08) "Метод и устройство для управления электрическими токами" Патент США 1745175A
- ^ а б c Дело, Брюс Э. (1998). «Основные моменты технологии термического окисления кремния». Кремниевое материаловедение и технология. Электрохимическое общество. п. 183. ISBN 978-1566771931.
- ^ а б c d «1960: Показан металлооксидно-полупроводниковый (МОП) транзистор». Кремниевый двигатель: хронология развития полупроводников в компьютерах. Музей истории компьютеров. Получено 31 августа, 2019.
- ^ а б c d Московиц, Сэнфорд Л. (2016). Передовые инновации в материалах: управление глобальными технологиями в 21 веке. Джон Вили и сыновья. С. 165–67. ISBN 978-0470508923.
- ^ а б c d «Основа современного цифрового мира: триумф МОП-транзистора». Музей истории компьютеров. 13 июля 2010 г.. Получено 21 июля 2019.
- ^ Кристоф Лекюайер; Дэвид С. Брук; Джей Ласт (2010). Создатели микрочипов: документальная история Fairchild Semiconductor. п. 62–63. ISBN 978-0262014243.CS1 maint: использует параметр авторов (связь)
- ^ Клэйс, Кор Л. (2003). ULSI Process Integration III: Материалы международного симпозиума. Электрохимическое общество. п. 27–30. ISBN 978-1566773768.
- ^ а б c d е "Давон Канг". Национальный зал славы изобретателей. Получено 27 июн 2019.
- ^ а б c d "Мартин (Джон) М. Аталла". Национальный зал славы изобретателей. 2009. Получено 21 июн 2013.
- ^ а б c Лойек, Бо (2007). История полупроводниковой техники. Springer Science & Business Media. С. 321–23. ISBN 978-3540342588.
- ^ Хафф, Ховард (2005). Материалы с высокой диэлектрической постоянной: приложения VLSI MOSFET. Springer Science & Business Media. п. 34. ISBN 978-3540210818.
- ^ а б Сах, Чжи-Тан (Октябрь 1988 г.). «Эволюция МОП-транзистора - от концепции до СБИС» (PDF). Труды IEEE. 76 (10): 1280–1326 [1290]. Bibcode:1988IEEEP..76.1280S. Дои:10.1109/5.16328. ISSN 0018-9219.
Те из нас, кто занимался исследованиями кремниевых материалов и устройств в течение 1956–1960 годов, считали эту успешную попытку группы Bell Labs во главе с Аталлой по стабилизации поверхности кремния самым важным и значительным технологическим достижением, проложившим путь, который привел к технологии кремниевых интегральных схем. разработки на втором этапе и объемы производства на третьем этапе.
- ^ Бассетт, Росс Нокс (2007). К веку цифровых технологий: исследовательские лаборатории, начинающие компании и развитие MOS-технологий. Издательство Университета Джона Хопкинса. п. 110. ISBN 978-0801886393.
- ^ Лойек, Бо (2007). История полупроводниковой техники. Springer Science & Business Media. п. 322. ISBN 978-3540342588.
- ^ Питер Робин Моррис (1990). История мировой полупроводниковой промышленности. п. 43. ISBN 9780863412271.
- ^ а б Бассетт, Росс Нокс (2007). К веку цифровых технологий: исследовательские лаборатории, начинающие компании и развитие MOS-технологий. Издательство Университета Джона Хопкинса. п. 22. ISBN 978-0801886393.
- ^ Патент США 3,206,670 (1960)
- ^ Патент США 3102230 (1960)
- ^ «1948 год - концепция переходного транзистора». Кремниевый двигатель: хронология развития полупроводников в компьютерах. Музей истории компьютеров. 2007. Архивировано с оригинал на 2012-04-19. Получено 2007-11-02.
- ^ Патент США 2,953,486
- ^ Аталла, М.; Канг, Д. (Июнь 1960 г.). "Кремний – диоксид кремния поверхностные устройства, индуцированные полем". Конференция IRE-AIEE по исследованиям твердотельных устройств. Издательство Университета Карнеги-Меллона.
- ^ "Устная история: Голди, Хиттингер и Таненбаум". Институт инженеров по электротехнике и электронике. 25 сентября 2008 г.. Получено 22 августа 2019.
- ^ Московиц, Сэнфорд Л. (2016). Передовые инновации в материалах: управление глобальными технологиями в 21 веке. Джон Вили и сыновья. п. 165 и 181. ISBN 978-0470508923.
Несмотря на успех, транзистор с плоским переходом имел свои проблемы, с которыми нужно было бороться. Что наиболее важно, это было довольно громоздкое устройство, которое было трудно производить в массовом производстве, что ограничивало его ряд специализированных приложений. Ученые и инженеры полагали, что только полевой транзистор (FET), тип которого Шокли впервые задумал в конце 1940-х годов, но так и не смог заставить работать должным образом, давал надежду на компактный, действительно массовый транзистор, который можно было бы миниатюризировать для широкий спектр использования. (...) Важным шагом в этом направлении было изобретение «МОП-процесса». (...) Но Мур особенно верил в то, что будущее массового производства недорогих полупроводниковых запоминающих устройств большой емкости за МОП-интегральными микросхемами, то есть интегральными схемами, состоящими из МОП-транзисторов. Он думал, что здесь Intel действительно сможет внести свой вклад в поистине революционное нововведение.
- ^ а б Бассетт, Росс Нокс (2002). К веку цифровых технологий: исследовательские лаборатории, начинающие компании и развитие MOS-технологий. Издательство Университета Джона Хопкинса. С. 53–54. ISBN 978-0-8018-6809-2.
- ^ а б Бутрика, Эндрю Дж. (2015). «Глава 3: Роль НАСА в производстве интегральных схем» (PDF). В Дике, Стивен Дж. (Ред.). Исторические исследования влияния космических полетов на общество. НАСА. С. 149-250 (239-42). ISBN 978-1-62683-027-1.
- ^ Дэвид Л. Мортон; Джозеф Габриэль (2007). Электроника: история жизни технологии. п. 84.CS1 maint: использует параметр авторов (связь)
- ^ а б «1963: изобретена дополнительная конфигурация схемы МОП». Музей истории компьютеров. Получено 6 июля 2019.
- ^ [1], "Полупроводниковая преобразовательная схема", выданная 1964-10-30
- ^ Харрисон, Линден Т. (2005). Источники тока и напряжения: Ссылки A Конструкция Справочник по радиоэлектронике. Эльзевир. п. 185. ISBN 978-0-08-045555-6.
- ^ а б «1968: технология кремниевого затвора, разработанная для ИС». Музей истории компьютеров. Получено 22 июля 2019.
- ^ Бассетт, Росс Нокс (2007). К веку цифровых технологий: исследовательские лаборатории, начинающие компании и развитие MOS-технологий. Издательство Университета Джона Хопкинса. п. 3. ISBN 978-0801886393.
- ^ Клэйс, Кор Л. (2003). ULSI Process Integration III: Материалы международного симпозиума. Электрохимическое общество. п. 46. ISBN 978-1566773768.
- ^ Арнс, Р. Г. (октябрь 1998 г.). «Другой транзистор: ранняя история полевого транзистора металл-оксид-полупроводник». Журнал инженерной науки и образования. 7 (5): 233–40. Дои:10.1049 / esej: 19980509.
- ^ Чан, Йи-Джен (1992). Исследования гетероструктурных полевых транзисторов InAIA / InGaAs и GaInP / GaAs для высокоскоростных приложений. университет Мичигана. п. 1.
Si MOSFET произвел революцию в электронной промышленности и в результате влияет на нашу повседневную жизнь почти всеми мыслимыми способами.
- ^ Кубозоно, Йошихиро; Он, Сюэся; Хамао, Шино; Уэсуги, Эри; Шимо, Юма; Миками, Такахиро; Гото, Хиденори; Камбэ, Такаши (2015). «Применение органических полупроводников к транзисторам». Наноустройства для фотоники и электроники: достижения и приложения. CRC Press. п. 355. ISBN 978-9814613750.
- ^ Malmstadt, Howard V .; Энке, Кристи Дж .; Крауч, Стэнли Р. (1994). Правильное подключение: микрокомпьютеры и электронное оборудование. Американское химическое общество. п. 389. ISBN 978-0841228610.
Относительная простота и требования к низкому энергопотреблению полевых МОП-транзисторов способствовали сегодняшней революции в области микрокомпьютеров.
- ^ а б Маккласки, Мэтью Д.; Галлер, Юджин Э. (2012). Легирующие примеси и дефекты в полупроводниках. CRC Press. п. 3. ISBN 978-1439831533.
- ^ Дэниелс, Ли А. (28 мая 1992 г.). "Доктор Давон Кан, 61 год, изобретатель в области твердотельной электроники". Нью-Йорк Таймс. Получено 1 апреля 2017.
- ^ Голио, Майк; Голио, Джанет (2018). ВЧ и СВЧ пассивные и активные технологии. CRC Press. С. 18–12. ISBN 978-1420006728.
- ^ а б c Колиндж, Жан-Пьер; Грир, Джеймс С. (2016). Нанопроволочные транзисторы: физика устройств и материалов в одном измерении. Издательство Кембриджского университета. п. 2. ISBN 978-1107052406.
- ^ Ламба, В .; Engles, D .; Малик, С. С .; Верма, М. (2009). «Квантовый транспорт в кремниевом МОП-транзисторе с двойным затвором». 2009 2-й Международный семинар по электронным устройствам и полупроводниковым технологиям: 1–4. Дои:10.1109 / EDST.2009.5166116. ISBN 978-1-4244-3831-0. S2CID 10377971.
- ^ а б Sridharan, K .; Пуди, Викрамкумар (2015). Разработка арифметических схем в нанотехнологиях квантовых точечных клеточных автоматов. Springer. п. 1. ISBN 978-3319166889.
- ^ а б Мотоёси, М. (2009). "Через кремниевый переходник (TSV)" (PDF). Труды IEEE. 97 (1): 43–48. Дои:10.1109 / JPROC.2008.2007462. ISSN 0018-9219. S2CID 29105721.
- ^ Лекюер, Кристоф (2006). Создание Кремниевой долины: инновации и рост высоких технологий, 1930-1970 гг.. Фонд химического наследия. п. 273. ISBN 9780262122818.
- ^ а б c Сзе, Саймон Мин. «Полевые транзисторы металл – оксид – полупроводник». Энциклопедия Британника. Получено 21 июля 2019.
- ^ а б «Транзисторы поддерживают закон Мура». EETimes. 12 декабря 2018 г.. Получено 18 июля 2019.
- ^ а б Бапат, Ю. Н. (1992). Электронные схемы и системы: аналоговые и цифровые, 1e. Тата МакГроу-Хилл Образование. п. 119. ISBN 978-0-07-460040-5.
- ^ а б c d «Применение полевых МОП-транзисторов в современных схемах переключения мощности». Электронный дизайн. 23 мая 2016. Получено 10 августа 2019.
- ^ Б. СОМАНАТАН НАИР (2002). Цифровая электроника и логический дизайн. PHI Learning Pvt. ООО п. 289. ISBN 9788120319561.
Цифровые сигналы представляют собой импульсы фиксированной ширины, которые занимают только один из двух уровней амплитуды.
- ^ Джозеф Мигга Кицца (2005). Безопасность компьютерных сетей. Springer Science & Business Media. ISBN 978-0387204734.
- ^ а б c «Черепаха транзисторов побеждает в гонке - революция CHM». Музей истории компьютеров. Получено 22 июля 2019.
- ^ 2000 Решенные проблемы цифровой электроники. Тата МакГроу-Хилл Образование. 2005. с. 151. ISBN 978-0-07-058831-8.
- ^ Франк, Д. Дж .; Dennard, R.H .; Новак, Э .; Соломон, П. М .; Таур, Ю. (2001). «Пределы масштабирования устройства Si MOSFET и их зависимости от приложений». Труды IEEE. 89 (3): 259–88. Дои:10.1109/5.915374. ISSN 0018-9219.
- ^ Климецкий, Пит Иван (2002). Контроль плотности плазмы для уменьшения вариаций реактивного ионного травления в промышленной микроэлектронике. университет Мичигана. п. 2. ISBN 9780493885735.
Возможно, самый важный прорыв в области устройств для компьютерной индустрии произошел в 1960 году, когда Канг и Аталла предложили и изготовили первый полевой транзистор металл-оксид-полупроводник, или MOSFET, с использованием термически окисленной кремниевой структуры.
- ^ Дело, Брюс Э. (1988). «Термическое окисление кремния и других полупроводниковых материалов» (PDF). Справочник по полупроводниковым материалам и технологическим процессам: для очень крупномасштабной интеграции (СБИС) и сверхбольшой интеграции (ULSI). Публикации Нойеса. п. 46. ISBN 978-0815511502.
- ^ Thompson, S.E .; Chau, R. S .; Ghani, T .; Mistry, K .; Тяги, С .; Бор, М. Т. (2005). «В поисках« Forever »транзисторы продолжали масштабировать один новый материал за раз». IEEE Transactions по производству полупроводников. 18 (1): 26–36. Дои:10.1109 / TSM.2004.841816. ISSN 0894-6507. S2CID 25283342.
В области электроники планарный полевой транзистор Si металл – оксид – полупроводник (MOSFET), пожалуй, является наиболее важным изобретением.
- ^ Вонг, Кит По (2009). Электротехника - Том II. Публикации EOLSS. п. 7. ISBN 978-1905839780.
- ^ Реймер, Майкл Г. (2009). Кремниевая паутина: физика для эпохи Интернета. CRC Press. п. 365. ISBN 978-1439803127.
- ^ Фельдман, Леонард С. (2001). "Вступление". Фундаментальные аспекты окисления кремния. Springer Science & Business Media. С. 1–11. ISBN 978-3540416821.
- ^ Домбровски, Ярек; Мюссиг, Ханс-Иоахим (2000). «1.2. Кремниевый век». Поверхности кремния и образование интерфейсов: фундаментальная наука в промышленном мире. Всемирный научный. стр.3–13. ISBN 978-9810232863.
- ^ а б c d «Выступление директора Янку на Международной конференции по интеллектуальной собственности 2019 г.». Ведомство США по патентам и товарным знакам. 10 июня 2019 г. Архивировано с оригинал 17 декабря 2019 г.. Получено 20 июля 2019.
- ^ Fossum, Джерри Дж .; Триведи, Вишал П. (2013). Основы сверхтонких полевых МОП-транзисторов и полевых транзисторов FinFET. Издательство Кембриджского университета. п. vii. ISBN 978-1107434493.
- ^ Чен, Вай Кай (2004). Справочник по электротехнике. Эльзевир. п. 109. ISBN 978-0080477480.
- ^ Франко, Якопо; Качер, Бен; Groeseneken, Гвидо (2013). Надежность высокомобильных полевых МОП-транзисторов с каналом SiGe для будущих приложений КМОП. Springer Science & Business Media. С. 1–2. ISBN 978-9400776630.
- ^ Кресслер, Джон Д .; Mantooth, Х. Алан (2017). Электроника для экстремальных условий окружающей среды. CRC Press. п. 959. ISBN 978-1-351-83280-9.
Хотя биполярный переходной транзистор был первым транзисторным устройством, которое прочно вошло в мир интегральных схем, нет никаких сомнений в том, что появление полевых МОП-транзисторов, аббревиатуры от полевого транзистора металл-оксид-полупроводник, действительно произвело революцию в мире так называемый информационный век. Плотность, с которой могут быть изготовлены эти устройства, позволила целым компьютерам существовать на нескольких небольших микросхемах, а не заполнять комнату.
- ^ а б "13 секстиллионов и счет: длинный и извилистый путь к самому часто производимому человеческому артефакту в истории". Музей истории компьютеров. 2 апреля 2018 г.. Получено 28 июля 2019.
- ^ а б Бейкер, Р. Джейкоб (2011). CMOS: схемотехника, компоновка и моделирование. Джон Вили и сыновья. п. 7. ISBN 978-1118038239.
- ^ Малоберти, Франко; Дэвис, Энтони С. (2016). «История электронных устройств» (PDF). Краткая история схем и систем: от экологически чистых мобильных сетей с повсеместным распространением информации до обработки больших данных. IEEE Circuits and Systems Society. С. 59-70 (65-6). ISBN 978-8793609860.
- ^ Швирц, Франк; Вонг, Хей; Лиу, Джуин Дж. (2010). Нанометр CMOS. Пэн Стэнфорд Паблишинг. п. 5. ISBN 978-9814241083.
- ^ Йе, Пейде; Эрнст, Томас; Харе, Мукеш В. (30 июля 2019 г.). «Нанолистовой транзистор - следующий (и, возможно, последний) шаг в законе Мура». IEEE Spectrum. Дои:10.1109 / MSPEC.2019.8784120. S2CID 199439071. Получено 6 ноября 2019.
- ^ Линдли, Дэвид (15 мая 2015 г.). «В центре внимания: ориентиры - случайное обнаружение приводит к стандарту калибровки». Физика. 8. Дои:10.1103 / Физика.8.46.
- ^ а б c d Уильямс, Дж. Б. (2017). Революция в электронике: изобретая будущее. Springer. С. 245, 249–50. ISBN 978-3319490885.
- ^ Вудалл, Джерри М. (2010). Основы полупроводниковых МОП-транзисторов III-V. Springer Science & Business Media. п. 2. ISBN 978-1441915474.
- ^ а б «Расширенная информация о Нобелевской премии по физике 2000 г.» (PDF). Нобелевская премия. Июнь 2018 г.. Получено 17 августа 2019.
- ^ «Вехи: список вех IEEE». Институт инженеров по электротехнике и электронике. Получено 25 июля 2019.
- ^ "Силиконовая технология Intel 45 нм Hi-k". Архивировано из оригинал 6 октября 2009 г.
- ^ "книга данных компонентов памяти" (PDF). книга данных компонентов памяти. Intel. п. 2–1. Архивировано из оригинал (PDF) 4 марта 2016 г.. Получено 30 августа 2015.
- ^ «Использование полевого МОП-транзистора в качестве переключателя». 090507 brunningsoftware.co.uk
- ^ Шичман, Х. и Ходжес, Д.А. (1968). «Моделирование и моделирование коммутационных схем полевых транзисторов с изолированным затвором». Журнал IEEE по твердотельным схемам. СК-3 (3): 285–89. Bibcode:1968IJSSC ... 3..285S. Дои:10.1109 / JSSC.1968.1049902.
- ^ Например, см. Ченг, Юхуа; Ху, Ченмин (1999). Моделирование MOSFET и руководство пользователя BSIM3. Springer. ISBN 978-0-7923-8575-2.. Самая последняя версия BSIM модель описана в В., Шрирамкумар; Пайдавози, Навид; Лу, Дарсен; Линь Чжун-Сунь; Дунга, Мохан; Яо, Шицзин; Моршед, Танвир; Никнеджад, Али и Ху, Ченмин (2012). "Компактная модель многозатворного полевого МОП-транзистора BSIM-CMG 106.1.0beta" (PDF). Департамент EE и CS, Калифорнийский университет в Беркли. Архивировано из оригинал (PDF) в 2014-07-27. Получено 2012-04-01.
- ^ Gray, P.R .; Hurst, P.J .; Льюис, С. Х. и Мейер, Р. Г. (2001). Анализ и проектирование аналоговых интегральных схем (Четвертое изд.). Нью-Йорк: Вили. С. 66–67. ISBN 978-0471321682.
- ^ van der Meer, P. R .; ван Ставерен, А .; ван Рурмунд, А. Х. М. (2004). Маломощная глубокая субмикронная КМОП-логика: снижение подпорогового тока. Дордрехт: Спрингер. п. 78. ISBN 978-1-4020-2848-9.
- ^ Дегнан, Брайан. "Википедия терпит неудачу".
- ^ Мид, Карвер (1989). Аналоговые СБИС и нейронные системы. Ридинг, Массачусетс: Эддисон-Уэсли. п.370. ISBN 9780201059922.
- ^ Смит, Лесли S .; Гамильтон, Алистер (1998). Нейроморфные системы: инженерия кремния из нейробиологии. World Scientific. С. 52–56. ISBN 978-981-02-3377-8.
- ^ Кумар, Сатиш (2004). Нейронные сети: учебный подход. Тата МакГроу-Хилл. п. 688. ISBN 978-0-07-048292-0.
- ^ Глеснер, Манфред; Зипф, Питер; Реновель, Мишель (2002). Программируемая логика и приложения: 12-я международная конференция. Дордрехт: Спрингер. п. 425. ISBN 978-3-540-44108-3.
- ^ Виттоц, Эрик А. (1996). «Основы проектирования аналоговых микромощностей». В Тумазу, Крис; Баттерсби, Николас С .; Порта, Соня (ред.). Учебники по схемам и системам. Джон Уайли и сыновья. С. 365–72. ISBN 978-0-7803-1170-1.
- ^ Шукла, Сандип К .; Бахар, Р. Айрис (2004). Нано, квантовые и молекулярные вычисления. Springer. п. 10 и рис. 1.4, с. 11. ISBN 978-1-4020-8067-8.
- ^ Шривастава, Ашиш; Сильвестр, Деннис; Блаау, Дэвид (2005). Statistical Analysis and Optimization For VLSI: Timing and Power. Springer. п. 135. ISBN 978-0-387-25738-9.
- ^ Galup-Montoro, C. & M.C., Schneider (2007). MOSFET modeling for circuit analysis and design. London/Singapore: World Scientific. п. 83. ISBN 978-981-256-810-6.
- ^ Malik, Norbert R. (1995). Electronic circuits: analysis, simulation, and design. Энглвуд Клиффс, Нью-Джерси: Prentice Hall. С. 315–16. ISBN 978-0-02-374910-0.
- ^ Gray, P.R .; Hurst, P. J.; Lewis, S. H.; Meyer, R. G. (2001). §1.5.2 p. 45. ISBN 978-0-471-32168-2.
- ^ Sedra, A. S. & Smith, K. C. (2004). Микроэлектронные схемы (Пятое изд.). Нью-Йорк: Оксфорд. п. 552. ISBN 978-0-19-514251-8.
- ^ Sedra, A. S. & Smith, K.C. (2004). п. 250, Eq. 4.14. ISBN 978-0-19-514251-8.
- ^ For a uniformly doped p-type substrate with bulk acceptor doping of NА per unit volume,
- ^ "Body effect". Equars.com. Архивировано из оригинал на 2014-11-10. Получено 2012-06-02.
- ^ «Символы электронных схем». circuitstoday.com. 9 ноября 2011. Архивировано с оригинал 13 октября 2014 г.
- ^ IEEE Std 315-1975 – Graphic Symbols for Electrical and Electronics Diagrams (Including Reference Designation Letters)
- ^ Jaeger, Richard C.; Blalock, Travis N. "Figure 4.15 IEEE Standard MOS transistor circuit symbols" (PDF). Microelectronic Circuit Design.
- ^ Voinigescu, Sorin (2013). High-Frequency Integrated Circuits. Издательство Кембриджского университета. п. 164. ISBN 978-0521873024.
- ^ Зе, Саймон М. (2002). Полупроводниковые приборы: физика и технологии (PDF) (2-е изд.). Вайли. п. 4. ISBN 0-471-33372-7.
- ^ а б c «1978: Двухлуночная быстрая CMOS SRAM (Hitachi)» (PDF). Японский музей истории полупроводников. Архивировано из оригинал (PDF) 5 июля 2019 г.. Получено 5 июля 2019.
- ^ "Computer History Museum – The Silicon Engine | 1963 – Complementary MOS Circuit Configuration is Invented". Computerhistory.org. Получено 2012-06-02.
- ^ Higgins, Richard J. (1983). Electronics with digital and analog integrated circuits. Прентис-Холл. п.101. ISBN 978-0132507042.
The dominant difference is power: CMOS gates can consume about 100,000 times less power than their TTL equivalents!
- ^ "Depletion Mode". Techweb. Techweb. 29 января 2010 г.. Получено 27 ноября 2010.
- ^ "MIS". Semiconductor Glossary.
- ^ Hadziioannou, Georges; Malliaras, George G. (2007). Semiconducting polymers: chemistry, physics and engineering. Wiley-VCH. ISBN 978-3-527-31271-9.
- ^ а б Jones, William (1997). Organic Molecular Solids: Properties and Applications. CRC Press. ISBN 978-0-8493-9428-7.
- ^ Xu, Wentao; Guo, Chang; Rhee, Shi-Woo (2013). "High performance organic field-effect transistors using cyanoethyl pullulan (CEP) high-k polymer cross-linked with trimethylolpropane triglycidyl ether (TTE) at low temperatures". Журнал химии материалов C. 1 (25): 3955. Дои:10.1039/C3TC30134F.
- ^ Д. Канг и С. М. Сзе, "Плавающий затвор и его применение в устройствах памяти", Технический журнал Bell System, т. 46, нет. 4, 1967, стр. 1288–95.
- ^ Baliga, B. Jayant (1996). Силовые полупроводниковые приборы. Бостон: издательская компания PWS. ISBN 978-0-534-94098-0.
- ^ "Power MOSFET Basics: Understanding MOSFET Characteristics Associated With The Figure of Merit". element14. Архивировано из оригинал 5 апреля 2015 г.. Получено 27 ноября 2010.
- ^ "Power MOSFET Basics: Understanding Gate Charge and Using It To Assess Switching Performance". element14. Архивировано из оригинал on 30 June 2014. Получено 27 ноября 2010.
- ^ Ирвин, Дж. Дэвид (1997). Справочник по промышленной электронике. CRC Press. п. 218. ISBN 978-0849383434.
- ^ Hu, Chenming (13 февраля 2009 г.). «МОП-конденсатор» (PDF). Калифорнийский университет в Беркли. Архивировано из оригинал (PDF) на 2016-06-15. Получено 6 октября 2019.
- ^ Сзе, Саймон Мин; Lee, Ming-Kwei (May 2012). "MOS Capacitor and MOSFET". Полупроводниковые приборы: физика и технологии. Джон Вили и сыновья. ISBN 978-0470537947. Получено 6 октября 2019.
- ^ Зе, Саймон М. (2002). Полупроводниковые приборы: физика и технологии (PDF) (2-е изд.). Вайли. п. 214. ISBN 0-471-33372-7.
- ^ Kimizuka, Noboru; Yamazaki, Shunpei (2016). Physics and Technology of Crystalline Oxide Semiconductor CAAC-IGZO: Fundamentals. Джон Вили и сыновья. п. 217. ISBN 978-1119247401.
- ^ Weimer, Paul K. (1962). "The TFT A New Thin-Film Transistor". Труды IRE. 50 (6): 1462–69. Дои:10.1109/JRPROC.1962.288190. ISSN 0096-8390. S2CID 51650159.
- ^ Kawamoto, H. (2012). "The Inventors of TFT Active-Matrix LCD Receive the 2011 IEEE Nishizawa Medal". Журнал Display Technology. 8 (1): 3–4. Bibcode:2012JDisT...8....3K. Дои:10.1109/JDT.2011.2177740. ISSN 1551-319X.
- ^ Castellano, Joseph A. (2005). Жидкое золото: история жидкокристаллических дисплеев и создания индустрии. Всемирный научный. С. 176–77. ISBN 978-9812389565.
- ^ Alvarez, Antonio R. (1990). "Introduction To BiCMOS". BiCMOS Technology and Applications. Springer Science & Business Media. pp. 1-20 (2). Дои:10.1007/978-1-4757-2029-7_1. ISBN 978-0792393849.
- ^ "IGBT Definition". PC Magazine Encyclopedia. Журнал ПК. Получено 17 августа 2019.
- ^ а б c d е ж Bergveld, Piet (Октябрь 1985 г.). "The impact of MOSFET-based sensors" (PDF). Sensors and Actuators. 8 (2): 109–27. Bibcode:1985SeAc .... 8..109B. Дои:10.1016/0250-6874(85)87009-8. ISSN 0250-6874.
- ^ Chris Toumazou; Pantelis Georgiou (December 2011). "40 years of ISFET technology:From neuronal sensing to DNA sequencing". Письма об электронике. Получено 13 мая 2016.
- ^ а б c Schöning, Michael J.; Poghossian, Arshak (10 September 2002). "Recent advances in biologically sensitive field-effect transistors (BioFETs)" (PDF). Аналитик. 127 (9): 1137–51. Bibcode:2002Ana...127.1137S. Дои:10.1039/B204444G. ISSN 1364-5528. PMID 12375833.
- ^ Zeitzoff, P. M.; Hutchby, J. A.; Huff, H. R. (2002). "Figure 12: Simplified cross section of FinFET double-gate MOSFET.". In Park, Yoon-Soo; Shur, Michael; Tang, William (eds.). Frontiers in electronics: future chips : proceedings of the 2002 Workshop on Frontiers in Electronics (WOFE-02), St Croix, Virgin Islands, US, 6–11 January 2002. World Scientific. п. 82. ISBN 978-981-238-222-1.
- ^ Lee, J.-H .; Lee, J.-W.; Jung, H.-A.-R.; Choi, B.-K. (2009). "Comparison of SOI FinFETs and bulk FinFETs: Figure 2". Silicon-on-Insulator Technology and Devices. Электрохимическое общество. п. 102. ISBN 978-1-56677-712-4.
- ^ Colinge, J.P. (2008). FinFETs and Other Multi-Gate Transistors. Springer Science & Business Media. п. 11. ISBN 978-0387717517.
- ^ Sekigawa, Toshihiro; Hayashi, Yutaka (1 August 1984). "Calculated threshold-voltage characteristics of an XMOS transistor having an additional bottom gate". Твердотельная электроника. 27 (8): 827–28. Bibcode:1984SSEle..27..827S. Дои:10.1016/0038-1101(84)90036-4. ISSN 0038-1101.
- ^ Масуока, Фудзио; Takato, H.; Sunouchi, K.; Okabe, N .; Nitayama, A.; Hieda, K .; Horiguchi, F. (December 1988). «Высокопроизводительный КМОП транзистор с окружающим затвором (SGT) для БИС сверхвысокой плотности». Технический дайджест., Международная конференция по электронным устройствам: 222–25. Дои:10.1109 / IEDM.1988.32796. S2CID 114148274.
- ^ Брозек, Томаш (2017). Микро- и наноэлектроника: новые проблемы и решения для устройств. CRC Press. п. 117. ISBN 978-1351831345.
- ^ «Получатели премии IEEE Andrew S. Grove Award». Премия IEEE Эндрю С. Гроув. Институт инженеров по электротехнике и электронике. Получено 4 июля 2019.
- ^ «Прорывное преимущество для ПЛИС с технологией Tri-Gate» (PDF). Intel. 2014. Получено 4 июля 2019.
- ^ Tsu‐Jae King, Liu (11 июня 2012 г.). "FinFET: History, Fundamentals and Future". Калифорнийский университет в Беркли. Symposium on VLSI Technology Short Course. Получено 9 июля 2019.
- ^ Datta, Kanak; Khosru, Quazi D. M. (2018). "III–V tri-gate quantum well MOSFET: Quantum ballistic simulation study for 10nm technology and beyond". Твердотельная электроника. 118: 66–77. arXiv:1802.09136. Bibcode:2016SSEle.118...66D. Дои:10.1016/j.sse.2015.11.034. ISSN 0038-1101. S2CID 101934219.
- ^ Kulkarni, Jaydeep P.; Roy, Kaushik (2010). "Technology/Circuit Co-Design for III-V FETs". In Oktyabrsky, Serge; Ye, Peide (eds.). Основы полупроводниковых МОП-транзисторов III-V. Springer Science & Business Media. pp. 423–42. Дои:10.1007/978-1-4419-1547-4_14. ISBN 978-1-4419-1547-4.
- ^ Lin, Jianqiang (2015). "InGaAs Quantum-Well MOSFETs for logic applications". Массачусетский Институт Технологий. HDL:1721.1/99777. Цитировать журнал требует
| журнал =(помощь) - ^ "WHAT'S NEWS: A review of the latest happenings in electronics", Радиоэлектроника, Gernsback, 62 (5), May 1991
- ^ а б c d Колиндж, Жан-Пьер; Colinge, C. A. (2005). Физика полупроводниковых приборов. Springer Science & Business Media. п. 165. ISBN 978-0387285238.
Without the MOSFET there would be no computer industry, no digital telecommunication systems, no video games, no pocket calculators and no digital wristwatches.
- ^ Куо, Юэ (1 января 2013 г.). «Технология тонкопленочных транзисторов - прошлое, настоящее и будущее» (PDF). The Electrochemical Society Interface. 22 (1): 55–61. Дои:10.1149 / 2.F06131if. ISSN 1064-8208.
- ^ Лойек, Бо (2007). История полупроводниковой техники. Springer Science & Business Media. С. 120, 321–23. ISBN 978-3540342588.
- ^ Бассетт, Росс Нокс (2007). К веку цифровых технологий: исследовательские лаборатории, начинающие компании и развитие MOS-технологий. Издательство Университета Джона Хопкинса. п. 46. ISBN 978-0801886393.
- ^ "Computer History Museum – The Silicon Engine | 1955 – Photolithography Techniques Are Used to Make Silicon Devices". Computerhistory.org. Получено 2012-06-02.
- ^ «1964 год - выпущена первая коммерческая микросхема MOS». Музей истории компьютеров.
- ^ Килби, Дж. С. (2007). «Миниатюрные электронные схемы [Патент США № 3,138,743]». Информационный бюллетень IEEE Solid-State Circuits Society. 12 (2): 44–54. Дои:10.1109 / N-SSC.2007.4785580. ISSN 1098-4232.
- ^ а б Ширрифф, Кен (30 августа 2016 г.). «Удивительная история первых микропроцессоров». IEEE Spectrum. Институт инженеров по электротехнике и электронике. 53 (9): 48–54. Дои:10.1109 / MSPEC.2016.7551353. S2CID 32003640. Получено 13 октября 2019.
- ^ а б Хиттингер, Уильям К. (1973). «Металл – оксид – полупроводники». Scientific American. 229 (2): 48–59. Bibcode:1973SciAm.229b..48H. Дои:10.1038 / scientificamerican0873-48. ISSN 0036-8733. JSTOR 24923169.
- ^ а б Грант, Дункан Эндрю; Говар, Джон (1989). Силовые МОП-транзисторы: теория и приложения. Вайли. п. 1. ISBN 978-0471828679.
The metal–oxide–semiconductor field-effect transistor (MOSFET) is the most commonly used active device in the very-large-scale integration of digital integrated circuits (VLSI). В течение 1970-х годов эти компоненты произвели революцию в электронной обработке сигналов, системах управления и компьютерах.
- ^ Schwarz, A. F. (2014). Handbook of VLSI Chip Design and Expert Systems. Академическая пресса. п. 16. ISBN 978-1483258058.
- ^ «1971: микропроцессор объединяет функции центрального процессора на одном кристалле». Кремниевый двигатель. Музей истории компьютеров. Получено 22 июля 2019.
- ^ Cushman, Robert H. (20 September 1975). "2-1/2-generation μP's-$10 parts that perform like low-end mini's" (PDF). EDN. Архивировано из оригинал (PDF) 24 апреля 2016 г.. Получено 8 августа 2013.
- ^ "Computer History Museum – Exhibits – Microprocessors". Computerhistory.org. Получено 2012-06-02.
- ^ О'Нил, А. (2008). «Асад Абиди получил признание за работу в области RF-CMOS». Информационный бюллетень IEEE Solid-State Circuits Society. 13 (1): 57–58. Дои:10.1109 / N-SSC.2008.4785694. ISSN 1098-4232.
- ^ "Transistors – an overview". ScienceDirect. Получено 8 августа 2019.
- ^ Solid State Design – Vol. 6. Horizon House. 1965 г.
- ^ а б "DRAM". IBM100. IBM. 9 августа 2017 г.. Получено 20 сентября 2019.
- ^ "Роберт Деннард". Энциклопедия Британника. Получено 8 июля 2019.
- ^ «1970: MOS Dynamic RAM конкурирует с памятью на магнитных сердечниках по цене». Музей истории компьютеров. Получено 29 июля 2019.
- ^ "Люди". Кремниевый двигатель. Музей истории компьютеров. Получено 17 августа 2019.
- ^ «1971: введено многоразовое полупроводниковое ПЗУ». Музей истории компьютеров. Получено 19 июн 2019.
- ^ Bez, R .; Пировано, А. (2019). Достижения в энергонезависимой памяти и технологии хранения. Издательство Woodhead Publishing. ISBN 978-0081025857.
- ^ Cherry, Robert William (June 1973). "A calculator option for the Tektronix 4010 computer graphics terminal". Compilation of Abstracts of Dissertations, Theses and Research Papers Submitted by Candidates for Degrees. Военно-морская аспирантура. HDL:10945/16514.
- ^ "Victor 3900". Веб-музей старинных калькуляторов. Получено 15 мая 2020.
- ^ а б c "Hand-held Calculators". Веб-музей старинных калькуляторов. Получено 22 июля 2019.
- ^ Nigel Tout. "Sharp QT-8D "micro Compet"". Веб-музей старинных калькуляторов. Получено 29 сентября, 2010.
- ^ "Design News". Новости дизайна. Издательство "Каннерс". 27 (1–8): 275. 1972.
Today, under contracts with some 20 major companies, we're working on nearly 30 product programs – applications of MOS/LSI technology for automobiles, trucks, appliances, business machines, musical instruments, computer peripherals, cash registers, calculators, data transmission and telecommunication equipment.
- ^ а б c Omura, Yasuhisa; Mallik, Abhijit; Matsuo, Naoto (2017). MOS Devices for Low-Voltage and Low-Energy Applications. Джон Вили и сыновья. п. 53. ISBN 978-1119107354.
- ^ Chen, Tom (1996). "Integrated Circuits". В Уитакере, Джерри К. (ред.). Справочник по электронике. CRC Press. п. 644. ISBN 978-0-8493-8345-8.
- ^ Whiteley, Carol; McLaughlin, John Robert (2002). Technology, Entrepreneurs, and Silicon Valley. Institute for the History of Technology. ISBN 978-0964921719.
These active electronic components, or power semiconductor products, from Siliconix are used to switch and convert power in a wide range of systems, from portable information appliances to the communications infrastructure that enables the Internet. The company's power MOSFETs – tiny solid-state switches, or metal oxide semiconductor field-effect transistors – and power integrated circuits are widely used in cell phones and notebook computers to manage battery power efficiently
- ^ Green, M. M. (November 2010). "An overview on wireline communication systems for high-speed broadband communication". Proceedings of Papers 5th European Conference on Circuits and Systems for Communications (ECCSC'10): 1–8. ISBN 978-1-61284-400-8.
- ^ Оллстот, Дэвид Дж. (2016). "Switched Capacitor Filters" (PDF). В Малоберти, Франко; Дэвис, Энтони С. (ред.). Краткая история схем и систем: от экологически чистых мобильных сетей с повсеместным распространением информации до обработки больших данных. IEEE Circuits and Systems Society. pp. 105–10. ISBN 978-8793609860.
- ^ а б c Балига, Б. Джаянт (2005). Кремниевые высокочастотные силовые МОП-транзисторы. Всемирный научный. ISBN 978-9812561213.
- ^ а б c Асиф, Саад (2018). Мобильная связь 5G: концепции и технологии. CRC Press. pp. 128–34. ISBN 978-0429881343.
- ^ а б Джиндал, Р. П. (2009). "From millibits to terabits per second and beyond – Over 60 years of innovation". 2009 2-й Международный семинар по электронным устройствам и полупроводниковым технологиям: 1–6. Дои:10.1109 / EDST.2009.5166093. ISBN 978-1-4244-3831-0. S2CID 25112828.
- ^ Рай-Чоудхури, П. (2000). Технология и приложения MEMS и MOEMS. SPIE Пресс. pp. ix, 3–4. ISBN 978-0819437167.
- ^ Натансон ХК, Викстрем Р.А. (1965). "Кремниевый поверхностный транзистор с резонансным затвором и высокой добротностью полосы пропускания". Appl. Phys. Lett. 7 (4): 84–86. Bibcode:1965АпФЛ ... 7 ... 84Н. Дои:10.1063/1.1754323.
- ^ Boyle, William S; Smith, George E. (1970). "Charge Coupled Semiconductor Devices". Bell Syst. Tech. J. 49 (4): 587–93. Дои:10.1002/j.1538-7305.1970.tb01790.x.
- ^ Мацумото, Казуя; и другие. (1985). "A new MOS phototransistor operating in a non-destructive readout mode". Японский журнал прикладной физики. 24 (5A): L323. Bibcode:1985JaJAP..24L.323M. Дои:10.1143/JJAP.24.L323.
- ^ Eric R. Fossum (1993), "Active Pixel Sensors: Are CCD's Dinosaurs?" Proc. SPIE Vol. 1900, pp. 2–14, Charge-Coupled Devices and Solid State Optical Sensors III, Morley M. Blouke; Эд.
- ^ Lyon, Richard F. (2014). "The Optical Mouse: Early Biomimetic Embedded Vision". Advances in Embedded Computer Vision. Springer. pp. 3-22 (3). ISBN 978-3319093871.
- ^ Lyon, Richard F. (Август 1981 г.). "The Optical Mouse, and an Architectural Methodology for Smart Digital Sensors" (PDF). In H. T. Kung; Robert F. Sproull; Guy L. Steele (eds.). VLSI Systems and Computations. Computer Science Press. С. 1–19. Дои:10.1007/978-3-642-68402-9_1. ISBN 978-3-642-68404-3.
- ^ Brain, Marshall; Carmack, Carmen (24 April 2000). "How Computer Mice Work". Как это работает. Получено 9 октября 2019.
- ^ "Power Supply Technology – Buck DC/DC Converters". Mouser Electronics. Получено 11 августа 2019.
- ^ Грант, Дункан Эндрю; Говар, Джон (1989). Силовые МОП-транзисторы: теория и приложения. Вайли. п. 239. ISBN 9780471828679.
- ^ Карбоне, Джеймс (сентябрь – октябрь 2018 г.). «Покупатели могут рассчитывать на 30-недельное время выполнения заказа и более высокие метки для полевых МОП-транзисторов» (PDF). Поиск электроники: 18–19.
- ^ "Автомобильные силовые МОП-транзисторы" (PDF). Fuji Electric. Получено 10 августа 2019.
- ^ Госден, Д.Ф. (Март 1990 г.). «Современные технологии электромобилей с использованием двигателя переменного тока». Журнал электротехники и электроники. Институт инженеров Австралии. 10 (1): 21–27. ISSN 0725-2986.
- ^ «Член NIHF Бантвал Джаянт Балига изобрел технологию IGBT». Национальный зал славы изобретателей. Получено 17 августа 2019.
- ^ "ReVera's FinFET Control". revera.com. Архивировано из оригинал 19 сентября 2010 г.
- ^ Колиндж, Жан-Пьер; Колиндж, Синтия А. (2002). Физика полупроводниковых приборов. Дордрехт: Спрингер. п. 233, рисунок 7.46. ISBN 978-1-4020-7018-1.
- ^ Weber, Eicke R .; Домбровски, Ярек, ред. (2004). Прогностическое моделирование обработки полупроводников: состояние и проблемы. Дордрехт: Спрингер. п. 5, рисунок 1.2. ISBN 978-3-540-20481-7.
- ^ «Международная технологическая дорожная карта для полупроводников». Архивировано из оригинал на 2015-12-28.
- ^ Шилов, Антон. «Samsung завершает разработку 5-нм технологического процесса EUV». www.anandtech.com. Получено 2019-05-31.
- ^ Шилов, Антон. «TSMC: первые 7-нанометровые чипы EUV, производство 5-нанометрового риска во втором квартале 2019 года».
- ^ «1965 -« Закон Мура «предсказывает будущее интегральных схем» ». Музей истории компьютеров.
- ^ Рой, Кошик; Йео, Киат Сенг (2004). Подсистемы СБИС низкого напряжения малой мощности. McGraw-Hill Professional. Рис. 2.1, стр. 44, рис. 1.1, с. 4. ISBN 978-0-07-143786-8.
- ^ Василеска, Драгица; Гудник, Стивен (2006). Вычислительная электроника. Морган и Клейпул. п. 103. ISBN 978-1-59829-056-1.
- ^ "Frontier Semiconductor Paper" (PDF). Архивировано из оригинал (PDF) 27 февраля 2012 г.. Получено 2012-06-02.
- ^ Чен, Вай-Кай (2006). Справочник СБИС. CRC Press. Рис. 2.28, стр. 2–22. ISBN 978-0-8493-4199-1.
- ^ Lindsay, R .; Павляк; Киттл; Хенсон; Торрегиани; Джангранди; Сурдеану; Вандерворст; Маюр; Росс; Маккой; Гельпей; Эллиотт; Страницы; Сатта; Лауэрс; Столк; Maex (2011). «Сравнение Spike, Flash, SPER и лазерного отжига для 45 нм CMOS». MRS Proceedings. 765. Дои:10.1557 / PROC-765-D7.4.
- ^ «Емкость проводки СБИС» (PDF). Журнал исследований и разработок IBM.[мертвая ссылка ]
- ^ Soudris, D .; Pirsch, P .; Барке, Э., ред. (2000). Проектирование интегральных схем: моделирование, оптимизация и моделирование мощности и времени (10-й международный семинар). Springer. п.38. ISBN 978-3-540-41068-3.
- ^ Оршанский, Михаил; Нассиф, Сани; Бонинг, Дуэйн (2007). Дизайн для технологичности и статистический дизайн: конструктивный подход. Нью-Йорк 309284: Спрингер. ISBN 978-0387309286.CS1 maint: location (связь)
- ^ Черри, Стивен (2004). «Закон Эдхольма полосы пропускания». IEEE Spectrum. 41 (7): 58–60. Дои:10.1109 / MSPEC.2004.1309810. S2CID 27580722.
- ^ а б c "Ангстрем". Словарь английского языка Коллинза. Получено 2019-03-02.
- ^ Зе, Саймон М. (2002). Полупроводниковые приборы: физика и технологии (PDF) (2-е изд.). Wiley. п. 4. ISBN 0-471-33372-7.
- ^ Аталла, Мохамед М.; Канг, Давон (Июнь 1960 г.). "Кремний – диоксид кремния поверхностные устройства, индуцированные полем". Конференция IRE-AIEE по исследованиям твердотельных устройств. Издательство Университета Карнеги-Меллона.
- ^ Войнигеску, Сорин (2013). Высокочастотные интегральные схемы. Издательство Кембриджского университета. п. 164. ISBN 9780521873024.
- ^ Сах, Чжи-Тан; Лейстико, Отто; Гроув, А. С. (май 1965 г.). «Подвижность электронов и дырок в инверсионных слоях на термически окисленных поверхностях кремния». Транзакции IEEE на электронных устройствах. 12 (5): 248–254. Bibcode:1965 год ... 12..248л. Дои:10.1109 / T-ED.1965.15489.
- ^ Деннард, Роберт Х.; Gaensslen, Fritz H .; Ю, Хва-Ниен; Кун, Л. (декабрь 1972 г.). «Разработка микронных коммутационных аппаратов MOS». 1972 г. - Международная конференция по электронным устройствам: 168–170. Дои:10.1109 / IEDM.1972.249198.
- ^ а б Хори, Рёичи; Масуда, Хироо; Минато, Осаму; Нисимацу, Сигеру; Сато, Кикудзи; Кубо, Масахару (сентябрь 1975 г.). «Короткоканальная МОП-ИС, основанная на точной конструкции двумерного устройства». Японский журнал прикладной физики. 15 (S1): 193. Дои:10.7567 / JJAPS.15S1.193. ISSN 1347-4065.
- ^ Кричлоу, Д. Л. (2007). «Воспоминания о масштабировании MOSFET». Информационный бюллетень IEEE Solid-State Circuits Society. 12 (1): 19–22. Дои:10.1109 / N-SSC.2007.4785536.
- ^ «1970-е: Развитие и эволюция микропроцессоров» (PDF). Японский музей истории полупроводников. Получено 27 июн 2019.
- ^ «NEC 751 (uCOM-4)». Страница коллекционера антикварных фишек. Архивировано из оригинал на 2011-05-25. Получено 2010-06-11.
- ^ "1973: 12-разрядный микропроцессор управления двигателем (Toshiba)" (PDF). Японский музей истории полупроводников. Получено 27 июн 2019.
- ^ Белзер, Джек; Хольцман, Альберт Г .; Кент, Аллен (1978). Энциклопедия компьютерных наук и технологий: том 10 - Линейная и матричная алгебра микроорганизмов: идентификация с помощью компьютера. CRC Press. п. 402. ISBN 9780824722609.
- ^ Деннард, Роберт Х.; Gaensslen, F.H .; Ю, Хва-Ниен; Райдаут, В. Л .; Bassous, E .; ЛеБлан, А. Р. (октябрь 1974 г.). «Разработка ионно-имплантированных МОП-транзисторов с очень маленькими физическими размерами» (PDF). Журнал IEEE по твердотельным схемам. 9 (5): 256–268. Bibcode:1974IJSSC ... 9..256D. CiteSeerX 10.1.1.334.2417. Дои:10.1109 / JSSC.1974.1050511.
- ^ Кубо, Масахару; Хори, Рёичи; Минато, Осаму; Сато, Кикудзи (февраль 1976 г.). «Схема управления пороговым напряжением для интегральных схем MOS с коротким каналом». 1976 Международная конференция IEEE по твердотельным схемам. Сборник технических статей. XIX: 54–55. Дои:10.1109 / ISSCC.1976.1155515.
- ^ «Краткое руководство по микропроцессору Intel». Intel. Получено 27 июн 2019.
- ^ Хантер, Уильям Р .; Ephrath, L.M .; Крамер, Алиса; Grobman, W. D .; Osburn, C.M .; Crowder, B.L .; Лун, Х. Э. (апрель 1979 г.). «Технология 1 / spl mu / m MOSFET VLSI. V. Одноуровневая технология поликремния с использованием электронно-лучевой литографии». Журнал IEEE по твердотельным схемам. 14 (2): 275–281. Дои:10.1109 / JSSC.1979.1051174.
- ^ Кобаяси, Тошио; Хоригути, Сейджи; Киучи, К. (декабрь 1984 г.). «Глубоко-субмикронные характеристики полевого МОП-транзистора с оксидом затвора 5 нм». 1984 Международное совещание по электронным устройствам: 414–417. Дои:10.1109 / IEDM.1984.190738.
- ^ Кобаяси, Тошио; Хоригути, Сейджи; Miyake, M .; Ода, М .; Киучи, К. (декабрь 1985 г.). «Чрезвычайно высокая крутизна (более 500 мСм / мм) MOSFET с оксидом затвора 2,5 нм». 1985 Международная конференция по электронным устройствам: 761–763. Дои:10.1109 / IEDM.1985.191088.
- ^ Чоу, Стивен Ю.; Antoniadis, Dimitri A .; Смит, Генри I. (декабрь 1985 г.). «Наблюдение за выбросом скорости электронов в кремниевых МОП-транзисторах с каналом менее 100 нм». Письма об электронных устройствах IEEE. 6 (12): 665–667. Bibcode:1985IEDL .... 6..665C. Дои:10.1109 / EDL.1985.26267.
- ^ а б Чоу, Стивен Ю.; Смит, Генрих I; Антониадис, Дмитрий А. (январь 1986 г.). «Транзисторы с длиной канала менее 100 нм, изготовленные с использованием рентгеновской литографии». Журнал вакуумной науки и технологий B: Обработка и явления микроэлектроники. 4 (1): 253–255. Bibcode:1986JVSTB ... 4..253C. Дои:10.1116/1.583451. ISSN 0734-211X.
- ^ Кобаяси, Тошио; Miyake, M .; Дегучи, К .; Kimizuka, M .; Хоригути, Сейджи; Киучи, К. (1987). «Половинные микрометровые полевые МОП-транзисторы с p-каналом и оксидом затвора 3,5 нм, изготовленные с использованием рентгеновской литографии». Письма об электронных устройствах IEEE. 8 (6): 266–268. Bibcode:1987ИЭДЛ .... 8..266М. Дои:10.1109 / EDL.1987.26625.
- ^ Оно, Мизуки; Сайто, Масанобу; Ёситоми, Такаши; Фигна, Клаудио; Огуро, Тацуя; Иваи, Хироши (декабрь 1993 г.). "N-МОП-транзисторы с длиной затвора менее 50 нм с фосфорными переходами истока и стока 10 нм". Труды международной конференции по электронным устройствам IEEE: 119–122. Дои:10.1109 / IEDM.1993.347385. ISBN 0-7803-1450-6.
- ^ Каваура, Хисао; Сакамото, Тосицугу; Баба, Тошио; Очиай, Юкинори; Фудзита, Дзюнъити; Мацуи, Синдзи; Соне, Дзюнъити (1997). «Предложение MOSFET с псевдоисточником и стоком для оценки полевых МОП-транзисторов с длиной волны 10 нм». Японский журнал прикладной физики. 36 (3С): 1569. Bibcode:1997JaJAP..36.1569K. Дои:10.1143 / JJAP.36.1569. ISSN 1347-4065.
- ^ Ахмед, Халед З .; Ibok, Effiong E .; Сон, Мирён; Да, Джеффри; Сян, Ци; Bang, Дэвид С .; Линь, Мин-Рен (1998). «Производительность и надежность полевых МОП-транзисторов размером менее 100 нм с ультратонкими оксидами затвора прямого туннелирования». Симпозиум 1998 г. по сборнику технических документов по технологии СБИС (Кат. № 98CH36216): 160–161. Дои:10.1109 / VLSIT.1998.689240. ISBN 0-7803-4770-6.
- ^ Ахмед, Халед З .; Ibok, Effiong E .; Сон, Мирён; Да, Джеффри; Сян, Ци; Bang, Дэвид С .; Линь, Мин-Рен (1998). «Полевые МОП-транзисторы размером менее 100 нм с прямым туннелированием термических оксидов азота и азота». Дайджест 56-й ежегодной конференции по исследованиям устройств (каталожный номер 98TH8373): 10–11. Дои:10.1109 / DRC.1998.731099. ISBN 0-7803-4995-4.
- ^ Дорис, Брюс Б.; Dokumaci, Omer H .; Ieong, Meikei K .; Мокута, Анда; Чжан, Инь; Канарский, Томас С .; Рой, Р. А. (декабрь 2002 г.). «Экстремальное масштабирование с помощью сверхтонких полевых МОП-транзисторов с кремниевым каналом». Дайджест. Международная конференция по электронным устройствам: 267–270. Дои:10.1109 / IEDM.2002.1175829. ISBN 0-7803-7462-2.
- ^ а б c Швирц, Франк; Вонг, Хей; Лиу, Джуин Дж. (2010). Нанометр CMOS. Пэн Стэнфорд Паблишинг. п. 17. ISBN 9789814241083.
- ^ «IBM заявляет, что самый маленький в мире кремниевый транзистор - TheINQUIRER». Theinquirer.net. 2002-12-09. Получено 7 декабря 2017.
- ^ а б Вакабаяси, Хитоши; Ямагами, Шигехару; Икэдзава, Нобуюки; Огура, Ацуши; Нарихиро, Мицуру; Arai, K .; Ochiai, Y .; Takeuchi, K .; Ямамото, Т .; Могами, Т. (декабрь 2003 г.). «Планарно-объемные КМОП-устройства размером менее 10 нм с контролем бокового перехода». IEEE International Electron Devices Meeting, 2003 г.: 20.7.1–20.7.3. Дои:10.1109 / IEDM.2003.1269446. ISBN 0-7803-7872-5.
- ^ «1963: изобретена дополнительная конфигурация схемы МОП». Музей истории компьютеров. Получено 6 июля 2019.
- ^ Сах, Чжи-Тан; Ванласс, Фрэнк (Февраль 1963 г.). «Нановаттная логика с использованием полевых триодов металл-оксид полупроводник». 1963 Международная конференция IEEE по твердотельным схемам. Сборник технических статей. VI: 32–33. Дои:10.1109 / ISSCC.1963.1157450.
- ^ а б Лойек, Бо (2007). История полупроводниковой техники. Springer Science & Business Media. п. 330. ISBN 9783540342588.
- ^ Aitken, A .; Poulsen, R.G .; MacArthur, A. T. P .; Уайт, Дж. Дж. (Декабрь 1976 г.). «Процесс CMOS, полностью имплантированный плазменным травлением и ионами». 1976 Международное совещание по электронным устройствам: 209–213. Дои:10.1109 / IEDM.1976.189021.
- ^ «1978: Двухлуночная быстрая CMOS SRAM (Hitachi)» (PDF). Японский музей истории полупроводников. Получено 5 июля 2019.
- ^ Масухара, Тошиаки; Минато, Осаму; Сасаки, Тошио; Сакаи, Йошио; Кубо, Масахару; Ясуи, Токумаса (февраль 1978 г.). «Высокоскоростная статическая ОЗУ Hi-CMOS 4K с низким энергопотреблением». 1978 Международная конференция по твердотельным схемам IEEE. Сборник технических статей. XXI: 110–111. Дои:10.1109 / ISSCC.1978.1155749.
- ^ Масухара, Тошиаки; Минато, Осаму; Сакаи, Йоши; Сасаки, Тошио; Кубо, Масахару; Ясуи, Токумаса (сентябрь 1978 г.). «Короткоканальное устройство Hi-CMOS и схемы». ESSCIRC 78: 4-я Европейская конференция по твердотельным схемам - Дайджест технических статей: 131–132.
- ^ а б c d е Джеалоу, Джеффри Карл (10 августа 1990 г.). «Влияние технологии обработки на конструкцию усилителя чувствительности DRAM» (PDF). ОСНОВНОЙ. Массачусетский Институт Технологий. стр. 149–166. Получено 25 июн 2019.
- ^ Chwang, R.J.C .; Choi, M .; Creek, D .; Stern, S .; Pelley, P.H .; Schutz, Joseph D .; Bohr, M. T .; Warkentin, P.A .; Ю. К. (февраль 1983 г.). «КМОП DRAM высокой плотности 70 нс». 1983 Международная конференция по твердотельным схемам IEEE. Сборник технических статей. XXVI: 56–57. Дои:10.1109 / ISSCC.1983.1156456.
- ^ Мано, Цунео; Yamada, J .; Иноуэ, Джуничи; Накадзима, С. (февраль 1983 г.). «Субмикронные схемы памяти СБИС». 1983 Международная конференция по твердотельным схемам IEEE. Сборник технических статей. XXVI: 234–235. Дои:10.1109 / ISSCC.1983.1156549.
- ^ Hu, G.J .; Таур, Юань; Деннард, Роберт Х.; Терман, Л. М .; Тинг, Чанг-Ю (декабрь 1983 г.). «Самовыравнивающаяся КМОП-технология 1 мкм для СБИС». 1983 Международное собрание электронных устройств: 739–741. Дои:10.1109 / IEDM.1983.190615.
- ^ Суми, Т .; Танигучи, Цунео; Кишимото, Микио; Хирано, Хиросигэ; Курияма, H .; Nishimoto, T .; Oishi, H .; Тетакава, С. (1987). «DRAM 60 нс 4 Мб в DIP 300 мил». 1987 Международная конференция IEEE по твердотельным схемам. Сборник технических статей. XXX: 282–283. Дои:10.1109 / ISSCC.1987.1157106.
- ^ Мано, Цунео; Yamada, J .; Иноуэ, Джуничи; Nakajima, S .; Мацумура, Тоширо; Минегиши, К .; Миура, К .; Matsuda, T .; Хашимото, К .; Намацу, Х. (1987). «Схемотехника для 16 Мб DRAM». 1987 Международная конференция IEEE по твердотельным схемам. Сборник технических статей. XXX: 22–23. Дои:10.1109 / ISSCC.1987.1157158.
- ^ Ханафи, Хусейн I .; Деннард, Роберт Х.; Таур, Юань; Haddad, Nadim F .; Sun, J. Y. C .; Родригес, М. Д. (сентябрь 1987 г.). «Разработка и описание устройства КМОП 0,5 мкм». ESSDERC '87: 17-я Европейская конференция по исследованиям твердотельных устройств: 91–94.
- ^ Касаи, Наоки; Эндо, Нобухиро; Китайдзима, Хироши (декабрь 1987 г.). «Технология CMOS 0,25 мкм с использованием PMOSFET с поликремниевым затвором P +». 1987 Международная конференция по электронным устройствам: 367–370. Дои:10.1109 / IEDM.1987.191433.
- ^ Inoue, M .; Kotani, H .; Yamada, T .; Ямаути, Хироюки; Fujiwara, A .; Matsushima, J .; Акамацу, Хиронори; Фукумото, М .; Кубота, М .; Nakao, I .; Аой (1988). «Драм размером 16 МБ с открытой битовой архитектурой». 1988 Международная конференция по твердотельным схемам IEEE, 1988 ISSCC. Сборник технических статей: 246–. Дои:10.1109 / ISSCC.1988.663712.
- ^ Шахиди, Гавам Г.; Давари, Биджан; Таур, Юань; Варнок, Джеймс Д.; Wordeman, Matthew R .; McFarland, P.A .; Mader, S. R .; Родригес, М. Д. (декабрь 1990 г.). «Изготовление КМОП на ультратонких КНИ, полученных методом латерального эпитаксиального наращивания и химико-механической полировки». Международный технический дайджест по электронным устройствам: 587–590. Дои:10.1109 / IEDM.1990.237130.
- ^ "Объем памяти". STOL (Полупроводниковые технологии в Интернете). Получено 25 июн 2019.
- ^ «Технология 0,18 мкм». TSMC. Получено 30 июн 2019.
- ^ «NEC производит самый маленький транзистор в мире». Thefreelibrary.com. Получено 7 декабря 2017.
- ^ Секигава, Тосихиро; Хаяси, Ютака (август 1984 г.). «Расчетные пороговые характеристики XMOS-транзистора с дополнительным нижним затвором». Твердотельная электроника. 27 (8): 827–828. Bibcode:1984ССЭле..27..827С. Дои:10.1016/0038-1101(84)90036-4. ISSN 0038-1101.
- ^ Койке, Ханпей; Накагава, Тадаши; Секигава, Тоширо; Suzuki, E .; Цуцуми, Тосиюки (23 февраля 2003 г.). «Основные соображения по компактному моделированию полевых МОП-транзисторов с четырьмя выводами» (PDF). Краткие сведения о TechConnect. 2 (2003): 330–333.
- ^ Давари, Биджан; Чанг, Вэнь-Син; Wordeman, Matthew R .; О, С. С .; Таур, Юань; Петрилло, Карен Э .; Родригес, М. Д. (декабрь 1988 г.). «Высокопроизводительная КМОП-технология 0,25 мкм». Технический дайджест., Международная конференция по электронным устройствам: 56–59. Дои:10.1109 / IEDM.1988.32749.
- ^ Давари, Биджан; Wong, C.Y .; Сунь, Джек Юань-Чен; Таур, Юань (декабрь 1988 г.). «Легирование поликремния n / sup + / и p / sup + / в процессе CMOS с двумя затворами». Технический дайджест., Международная конференция по электронным устройствам: 238–241. Дои:10.1109 / IEDM.1988.32800.
- ^ Масуока, Фудзио; Такато, Хироши; Суноути, Казумаса; Okabe, N .; Нитайма, Акихиро; Hieda, K .; Хоригути, Фумио (декабрь 1988 г.). «Высокопроизводительный КМОП транзистор с окружающим затвором (SGT) для БИС сверхвысокой плотности». Технический дайджест., Международная конференция по электронным устройствам: 222–225. Дои:10.1109 / IEDM.1988.32796.
- ^ Брозек, Томаш (2017). Микро- и наноэлектроника: новые проблемы и решения для устройств. CRC Press. п. 117. ISBN 9781351831345.
- ^ Исикава, Фумитаро; Буянова, Ирина (2017). Новые композитные полупроводниковые нанопроволоки: материалы, устройства и приложения. CRC Press. п. 457. ISBN 9781315340722.
- ^ Колиндж, Дж. П. (2008). FinFET и другие транзисторы с несколькими затворами. Springer Science & Business Media. п. 11. ISBN 9780387717517.
- ^ Хисамото, Диг; Кага, Тору; Кавамото, Ёсифуми; Такеда, Эйдзи (декабрь 1989 г.). «Полностью обедненный транзистор с обедненным каналом (ДЕЛЬТА) - новый вертикальный ультратонкий КНИ МОП-транзистор». Международный технический дайджест по электронным устройствам: 833–836. Дои:10.1109 / IEDM.1989.74182.
- ^ «Получатели премии IEEE Andrew S. Grove Award». Премия IEEE Эндрю С. Гроув. Институт инженеров по электротехнике и электронике. Получено 4 июля 2019.
- ^ а б c Цу ‐ Джэ Кинг, Лю (11 июня 2012 г.). «FinFET: история, основы и будущее». Калифорнийский университет в Беркли. Краткий курс симпозиума по технологии СБИС. В архиве из оригинала 28 мая 2016 г.. Получено 9 июля 2019.
- ^ Хисамото, Диг; Ху, Ченмин; Лю, Цу-Джэ Кинг; Бокор, Джеффри; Ли, Вен-Чин; Кедзерский, Якуб; Андерсон, Эрик; Такеучи, Хидеки; Асано, Казуя (декабрь 1998 г.). «Полевой МОП-транзистор с загнутым каналом для эры глубиной менее десятых микрон». International Electron Devices Meeting 1998. Технический дайджест (Кат. № 98CH36217): 1032–1034. Дои:10.1109 / IEDM.1998.746531. ISBN 0-7803-4774-9.
- ^ Ху, Ченмин; Чой, Ян-Гю; Lindert, N .; Xuan, P .; Tang, S .; Имел.; Андерсон, Э .; Bokor, J .; Цу-Джэ Кинг, Лю (декабрь 2001 г.). «Технологии FinFET CMOS менее 20 нм». Международная конференция по электронным устройствам. Технический дайджест (Кат. № 01CH37224): 19.1.1–19.1.4. Дои:10.1109 / IEDM.2001.979526. ISBN 0-7803-7050-3.
- ^ Ахмед, Шибли; Белл, Скотт; Табери, Сайрус; Бокор, Джеффри; Кайсер, Дэвид; Ху, Ченмин; Лю, Цу-Джэ Кинг; Ю, Бин; Чанг, Лиланд (декабрь 2002 г.). «Масштабирование FinFET до длины затвора 10 нм» (PDF). Дайджест. Международная конференция по электронным устройствам: 251–254. CiteSeerX 10.1.1.136.3757. Дои:10.1109 / IEDM.2002.1175825. ISBN 0-7803-7462-2.
- ^ Ли, Хёнджин; Чой, Ян-Гю; Ю, Ли-Ын; Рю, Сон Ван; Хан, Джин Ву; Jeon, K .; Jang, D.Y .; Ким, Кук-Хван; Ли, Джу-Хён; и другие. (Июнь 2006 г.), "Sub-5nm All-Around Gate FinFET for Ultimate Scaling", Симпозиум по технологии СБИС, 2006 г.: 58–59, Дои:10.1109 / VLSIT.2006.1705215, HDL:10203/698, ISBN 978-1-4244-0005-8
- ^ «Тихая комната на дне (нанометровый транзистор, разработанный Ян-кю Чой из Корейского передового института науки и технологий)», Новости наночастиц, 1 апреля 2006 г., архивировано из оригинал 6 ноября 2012 г.
- ^ Веймер, Пол К. (Июнь 1962 г.). «Новый тонкопленочный транзистор TFT». Труды IRE. 50 (6): 1462–1469. Дои:10.1109 / JRPROC.1962.288190. ISSN 0096-8390.
- ^ Куо, Юэ (1 января 2013 г.). «Технология тонкопленочных транзисторов - прошлое, настоящее и будущее» (PDF). Интерфейс электрохимического общества. 22 (1): 55–61. Дои:10.1149 / 2.F06131if. ISSN 1064-8208.
- ^ Ye, Peide D .; Сюань, И; У, Яньцин; Сюй, Мин (2010). «Металл-оксид-полупроводники с осаждением атомного слоя с высоким содержанием k / III-V и коррелированная эмпирическая модель». В Октябрьском, Серж; Е, Пейде (ред.). Основы полупроводниковых МОП-транзисторов III-V. Springer Science & Business Media. С. 173–194. Дои:10.1007/978-1-4419-1547-4_7. ISBN 978-1-4419-1547-4.
- ^ Brody, T. P .; Куниг, Х. Э. (октябрь 1966 г.). «ТОНКОПЛЕННЫЙ ТРАНЗИСТОР INAs с высоким коэффициентом усиления». Письма по прикладной физике. 9 (7): 259–260. Bibcode:1966АпФЛ ... 9..259Б. Дои:10.1063/1.1754740. ISSN 0003-6951.
- ^ Вудалл, Джерри М. (2010). Основы полупроводниковых МОП-транзисторов III-V. Springer Science & Business Media. С. 2–3. ISBN 9781441915474.
- ^ Канг, Давон; Сзе, Саймон Мин (Июль – август 1967 г.). «Плавающий затвор и его применение в устройствах памяти». Технический журнал Bell System. 46 (6): 1288–1295. Bibcode:1967ITED ... 14Q.629K. Дои:10.1002 / j.1538-7305.1967.tb01738.x.
- ^ Wegener, H.A.R .; Линкольн, А. Дж .; Pao, H.C .; О'Коннелл, М. Р .; Oleksiak, R.E .; Лоуренс, Х. (октябрь 1967). «Транзистор с переменным порогом, новое электрически изменяемое неразрушающее запоминающее устройство, доступное только для чтения». Международная конференция по электронным устройствам 1967 г.. 13: 70. Дои:10.1109 / IEDM.1967.187833.
- ^ Линь, Хунг Чанг; Айер, Рамачандра Р. (июль 1968 г.). «Монолитный биполярный усилитель звука». Транзакции IEEE на радиовещательных и телевизионных приемниках. 14 (2): 80–86. Дои:10.1109 / TBTR1.1968.4320132.
- ^ а б Альварес, Антонио Р. (1990). «Введение в BiCMOS». Технология и приложения BiCMOS. Springer Science & Business Media. С. 1–20 (2). Дои:10.1007/978-1-4757-2029-7_1. ISBN 9780792393849.
- ^ Линь, Хунг Чанг; Iyer, Ramachandra R .; Хо, К. Т. (октябрь 1968 г.). «Дополнительная МОП-биполярная структура». 1968 г. - Международная конференция по электронным устройствам: 22–24. Дои:10.1109 / IEDM.1968.187949.
- ^ а б "Достижения в области дискретных полупроводников идут вперед". Технология силовой электроники. Информация: 52–6. Сентябрь 2005 г. В архиве (PDF) из оригинала 22 марта 2006 г.. Получено 31 июля 2019.
- ^ Окснер, Э. С. (1988). Технология и применение Fet. CRC Press. п. 18. ISBN 9780824780500.
- ^ Tarui, Y .; Hayashi, Y .; Секигава, Тосихиро (сентябрь 1969 г.). «Diffusion Self-Aligned MOST; новый подход к высокоскоростным устройствам». Труды 1-й конференции по твердотельным устройствам.. Дои:10.7567 / SSDM.1969.4-1.
- ^ McLintock, G.A .; Томас, Р. Э. (декабрь 1972 г.). «Моделирование двойных диффузоров МОСТ с самовыравнивающимися затворами». 1972 г. - Международная конференция по электронным устройствам: 24–26. Дои:10.1109 / IEDM.1972.249241.
- ^ Бергвельд, П. (январь 1970 г.). «Разработка ионно-чувствительного твердотельного устройства для нейрофизиологических измерений». IEEE Transactions по биомедицинской инженерии. БМЕ-17 (1): 70–71. Дои:10.1109 / TBME.1970.4502688. PMID 5441220.
- ^ Крис Тумазу; Пантелис Георгиу (декабрь 2011 г.). «40 лет технологии ISFET: от нейронального зондирования до секвенирования ДНК». Письма об электронике. Дои:10.1049 / эл.2011.3231. Получено 13 мая 2016.
- ^ Tarui, Y .; Hayashi, Y .; Секигава, Тосихиро (октябрь 1970 г.). «Улучшение DSA - истощение MOS IC». 1970 г. - Международная конференция по электронным устройствам: 110. Дои:10.1109 / IEDM.1970.188299.
- ^ Дункан, Бен (1996). Усилители мощности аудио высокого качества. Эльзевир. стр.177–8, 406. ISBN 9780080508047.
- ^ Балига, Б. Джаянт (2015). Устройство IGBT: физика, конструкция и применение биполярного транзистора с изолированным затвором. Уильям Эндрю. С. XXVIII, 5–12. ISBN 9781455731534.
- ^ Higuchi, H .; Кицукава, Горо; Икеда, Такахиде; Nishio, Y .; Sasaki, N .; Огиуэ, Кацуми (декабрь 1984 г.). «Характеристики и структура уменьшенных биполярных устройств, объединенных с CMOSFET». 1984 Международное совещание по электронным устройствам: 694–697. Дои:10.1109 / IEDM.1984.190818.
- ^ Дегучи, К .; Komatsu, Kazuhiko; Miyake, M .; Namatsu, H .; Секимото, М .; Хирата, К. (1985). «Пошаговая гибридная рентгеновская / фото-гибридная литография для устройств Mos 0.3 мкм». 1985 Симпозиум по технологии СБИС. Сборник технических статей: 74–75.
- ^ Momose, H .; Шибата, Хидеки; Saitoh, S .; Миямото, Дзюн-ичи; Канзаки, К .; Кохьяма, Сусуму (1985). «1.0- / spl mu / m n-Well CMOS / Bipolar Technology». Журнал IEEE по твердотельным схемам. 20 (1): 137–143. Bibcode:1985IJSSC..20..137M. Дои:10.1109 / JSSC.1985.1052286.
- ^ Ли, Хан-Шэн; Puzio, L.C. (Ноябрь 1986 г.). "Электрические свойства полевых МОП-транзисторов с длиной затвора менее четверти микрометра". Письма об электронных устройствах IEEE. 7 (11): 612–614. Bibcode:1986IEDL .... 7..612H. Дои:10.1109 / EDL.1986.26492.
- ^ Шахиди, Гавам Г.; Antoniadis, Dimitri A .; Смит, Генри I. (декабрь 1986 г.). «Выброс скорости электронов при 300 К и 77 К в кремниевых МОП-транзисторах с субмикронной длиной канала». 1986 Международное совещание по электронным устройствам: 824–825. Дои:10.1109 / IEDM.1986.191325.
- ^ Давари, Биджан; Тинг, Чунг-Ю; Ahn, Kie Y .; Basavaiah, S .; Ху, Чао-Кун; Таур, Юань; Wordeman, Matthew R .; Абоэльфото, О. (май 1987 г.). «Субмикронный МОП-транзистор с вольфрамовым затвором и оксидом затвора 10 нм». 1987 Симпозиум по технологии СБИС. Сборник технических статей: 61–62.
- ^ Havemann, Роберт Х .; Eklund, R.E .; Tran, Hiep V .; Haken, R.A .; Скотт, Д. Б.; Fung, P.K .; Ham, T. E .; Favreau, D.P .; Виркус, Р. Л. (декабрь 1987 г.). «Технология 0.8 # 181; м 256K BiCMOS SRAM». 1987 Международная конференция по электронным устройствам: 841–843. Дои:10.1109 / IEDM.1987.191564.
- ^ Каваура, Хисао; Сакамото, Тосицугу; Баба, Тошио; Очиай, Юкинори; Фудзита, Дзюн-ичи; Мацуи, Синдзи; Соне, Дж. (1997). «Транзисторные операции в EJ-MOSFET с длиной затвора 30 нм». Дайджест 55-й ежегодной конференции по исследованиям устройств, 1997 г.: 14–15. Дои:10.1109 / DRC.1997.612456. ISBN 0-7803-3911-8.
- ^ Каваура, Хисао; Сакамото, Тосицугу; Баба, Тошио (12 июня 2000 г.). "Наблюдение прямого туннельного тока исток-сток в полевых транзисторах металл-оксид-полупроводник с электрически регулируемым мелким переходом с затвором 8 нм". Письма по прикладной физике. 76 (25): 3810–3812. Bibcode:2000АпФЛ..76.38 10К. Дои:10.1063/1.126789. ISSN 0003-6951.
внешняя ссылка
Эта статья использование внешняя ссылка может не следовать политикам или рекомендациям Википедии. (Сентябрь 2016) (Узнайте, как и когда удалить этот шаблон сообщения) |
- Как работают полупроводники и транзисторы (МОП-транзисторы) WeCanFigureThisOut.org
- «Общие сведения о параметрах паспорта мощных полевых МОП-транзисторов - заметка по применению в формате PDF для Nexperia AN11158» (PDF).
- "Введение в полевые МОП-транзисторы в режиме истощения". Архивировано из оригинал 28 сентября 2008 г.
- "Силовые МОП-транзисторы".
- «Критерии успешного выбора модулей IGBT и MOSFET». Архивировано из оригинал на 2012-11-12. Получено 2018-12-16.
- "Процесс MOSFET шаг за шагом". Архивировано из оригинал на 2009-08-22. Получено 2016-02-06. Флэш-слайд, подробно показывающий процесс изготовления полевого МОП-транзистора.
- "Калькулятор MOSFET". Архивировано из оригинал на 2008-05-27. Получено 2008-06-03.
- «Расширенные проблемы с MOSFET». ecee.colorado.edu. 27 ноября 2010 г.
- "Аплет MOSFET".
- Николай, Ульрих; Рейманн, Тобиас; Петцольдт, Юрген; Лутц, Йозеф (1998). Руководство по применению Силовые модули IGBT и MOSFET (1-е изд.). ISLE Verlag. ISBN 978-3-932633-24-9. Архивировано из оригинал 2 марта 2012 г.
- Винтрих, Арендт; Николай, Ульрих; Турский, Вернер; Рейманн, Тобиас (2011). PDF-версия (PDF) (2-е изд.). Нюрнберг: Семикрон. ISBN 978-3-938843-66-6. Архивировано из оригинал (PDF) 3 сентября 2013 г.
- "MIT Open Courseware 6.002 - Весна 2007".
- «Открытые курсы MIT 6.012 - осень 2009 г.».
- "Технологии Джорджии, BJT и FET слайды".
- "CircuitDesign: MOS Diffusion Parasitics".
- Марк Лундстрем, Марк Лундстрем (2008). "Курс на Физика наноразмерных транзисторов". Архивировано из оригинал на 2012-02-24. Получено 2010-05-09. Цитировать журнал требует
| журнал =(помощь) - Д-р Лундстрем (2005). «Примечания по баллистическим полевым МОП-транзисторам». Архивировано из оригинал на 2012-02-24. Получено 2010-05-18. Цитировать журнал требует
| журнал =(помощь)



















![{ displaystyle I _ { text {D}} = mu _ {n} C _ { text {ox}} { frac {W} {L}} left [ left (V _ { text {GS}} -V _ { rm {th}} right) V _ { text {DS}} - { frac {{V _ { text {DS}}} ^ {2}} {2}} right] (1+ lambda V_ {DS})}](https://wikimedia.org/api/rest_v1/media/math/render/svg/a213928719f4f0d6f821a69f29aa50a1d1e48782)



![{ displaystyle I _ { text {D}} = { frac { mu _ {n} C _ { text {ox}}} {2}} { frac {W} {L}} left [V_ { text {GS}} - V _ { text {th}} right] ^ {2} left [1+ lambda (V _ { text {DS}} - V _ { text {DSsat}}) right ].}](https://wikimedia.org/api/rest_v1/media/math/render/svg/f6593b8932bc4a92e53bfce27d1c29b1254b0ed3)









