Диэлектрик с высоким κ - High-κ dielectric
Период, термин диэлектрик с высоким κ относится к материалу с высоким диэлектрическая постоянная (κ, каппа ), по сравнению с диоксид кремния. Диэлектрики с высоким κ используются в производство полупроводников процессы, в которых они обычно используются для замены диоксида кремния затвор диэлектрик или другой диэлектрический слой устройства. Внедрение диэлектриков затвора с высоким κ является одной из нескольких стратегий, разработанных для обеспечения дальнейшей миниатюризации микроэлектронных компонентов, в просторечии называемой расширением Закон Мура Иногда эти материалы называют «high-k» (в разговорной речи «high kay») вместо «high-κ» (высокая каппа).
Потребность в материалах с высоким κ
Диоксид кремния (SiO2) использовался как оксид ворот материал на десятилетия. Так как Полевые транзисторы металл-оксид-полупроводник (Полевые МОП-транзисторы) уменьшились в размерах, толщина диэлектрика затвора из диоксида кремния неуклонно уменьшалась, чтобы увеличить емкость затвора и, таким образом, управляющий ток, что повысило производительность устройства. Поскольку толщина шкалы ниже 2 нм, токи утечки из-за туннелирование резко увеличиваются, что приводит к высокому энергопотреблению и снижению надежности устройства. Замена диэлектрика затвора из диоксида кремния материалом с высоким κ позволяет увеличить емкость затвора без связанных с этим эффектов утечки.
Первые принципы
Оксид затвора в МОП-транзистор можно смоделировать как конденсатор с параллельными пластинами. Игнорирование квантово-механических эффектов и эффектов истощения от Si подложка и ворота, емкость C этой параллельной пластины конденсатор дан кем-то
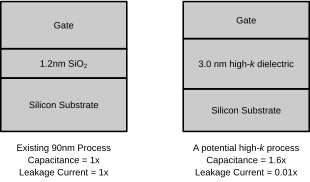
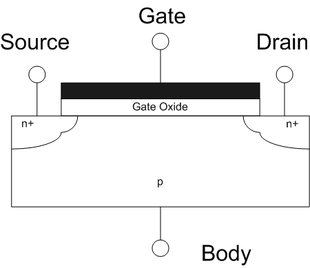
куда
- А площадь конденсатора
- κ - это относительная диэлектрическая проницаемость материала (3,9 для диоксид кремния )
- ε0 это диэлектрическая проницаемость свободного пространства
- т толщина оксидного изолятора конденсатора
Поскольку ограничение утечки сдерживает дальнейшее сокращение тальтернативным методом увеличения емкости затвора является изменение κ путем замены диоксида кремния материалом с высоким κ. В таком сценарии можно использовать более толстый оксидный слой затвора, который может уменьшить ток утечки протекает через структуру, а также улучшает диэлектрик затвора надежность.
Влияние емкости затвора на ток привода
Ток стока яD для МОП-транзистор можно записать (используя приближение постепенного канала) как
куда
- W ширина канала транзистора
- L длина канала
- μ - подвижность несущей канала (здесь предполагается постоянной)
- Cinv - плотность емкости, связанная с диэлектриком затвора, когда нижележащий канал находится в инвертированном состоянии
- Vг напряжение, приложенное к затвору транзистора
- Vth это пороговое напряжение
Период, термин Vг - Vth ограничен в диапазоне из-за надежности и рабочих ограничений при комнатной температуре, так как слишком большой Vг создаст нежелательное сильное электрическое поле через оксид. Более того, Vth не может быть легко уменьшено ниже 200 мВ, потому что токи утечки из-за повышенной утечки оксидов (то есть при условии, что диэлектрики с высоким κ недоступны) и подпороговая проводимость повысить энергопотребление в режиме ожидания до неприемлемого уровня. (См. Дорожную карту отрасли,[1] который ограничивает порог до 200 мВ, а Рой и другие. [2]). Таким образом, согласно этому упрощенному списку факторов, повышенная яD, сб требует уменьшения длины канала или увеличения диэлектрической емкости затвора.
Материалы и соображения
Замена диэлектрика затвора из диоксида кремния другим материалом усложняет производственный процесс. Диоксид кремния может быть образован окисляющий базовый кремний, обеспечивающий однородный конформный оксид и высокое качество интерфейса. Как следствие, усилия разработчиков были сосредоточены на поиске материала с необходимой высокой диэлектрической проницаемостью, который можно было бы легко интегрировать в производственный процесс. Другие ключевые соображения включают: группа согласование с кремний (что может изменить ток утечки), морфологию пленки, термостабильность, поддержание высокого мобильность носителей заряда в канале и минимизация электрических дефектов в пленке / интерфейсе. Материалы, которым было уделено значительное внимание: силикат гафния, силикат циркония, диоксид гафния и диоксид циркония, обычно депонируется с использованием осаждение атомного слоя.
Ожидается, что дефектные состояния в диэлектрике с высоким k могут влиять на его электрические свойства. Состояния дефектов могут быть измерены, например, с помощью термостимулированного тока с нулевым смещением и термостимулированного тока с нулевым градиентом температуры. современная спектроскопия,[3][4] или неупругая электронная туннельная спектроскопия (IETS).
Использование в промышленности
В отрасли задействовано оксинитрид затворные диэлектрики с 1990-х годов, в которых диэлектрик из оксида кремния, сформированный традиционным способом, пропитан небольшим количеством азота. Содержание нитрида незначительно увеличивает диэлектрическую проницаемость и, как считается, дает другие преимущества, такие как сопротивление диффузии легирующей примеси через диэлектрик затвора.
В 2000 г. Гуртей Сингх Сандху и Трунг Т. Доан из Микронная технология инициировал разработку осаждение атомного слоя высокий-к фильмы для DRAM запоминающие устройства. Это помогло стимулировать рентабельное внедрение полупроводниковая память, начиная с 90-нм узел DRAM.[5][6]
В начале 2007 г. Intel объявил о развертывании гафний диэлектрики на основе high-k в сочетании с металлическим затвором для компонентов, построенных на 45 нм технологий, и поставил его в серии процессоров 2007 под кодовым названием Penryn.[7][8] В то же время, IBM объявила о планах перехода на материалы с высоким коэффициентом k, также на основе гафния, для некоторых продуктов в 2008 году. Хотя это не определено, наиболее вероятными диэлектриками, используемыми в таких приложениях, являются некоторые формы азотированных силикатов гафния (HfSiON). HfO2 и HfSiO подвержены кристаллизации во время активационного отжига допанта. NEC Электроника также объявила об использовании диэлектрика HfSiON в 55 нм. UltimateLowPower технологии.[9] Однако даже HfSiON чувствителен к токам утечки, связанным с ловушкой, которые имеют тенденцию увеличиваться с увеличением нагрузки в течение срока службы устройства. Этот эффект утечки становится более серьезным по мере увеличения концентрации гафния. Однако нет никаких гарантий, что гафний станет де-факто основой для будущих high-k диэлектриков. 2006 год ITRS В дорожной карте прогнозировалось, что к 2010 году внедрение материалов высокого разрешения станет обычным явлением в отрасли.
Смотрите также
использованная литература
- ^ «Интеграция процессов, устройства и структуры» (PDF). Международная дорожная карта развития технологий для полупроводников: обновление 2006 г.. Архивировано из оригинал (PDF) на 2007-09-27.
- ^ Каушик Рой, Киат Сенг Йео (2004). Низковольтные маломощные подсистемы СБИС. McGraw-Hill Professional. Рис. 2.1, стр. 44. ISBN 978-0-07-143786-8.
- ^ Lau, W. S .; Чжун, Л .; Ли, Аллен; См. C. H .; Хан, Тэджун; Sandler, N.P .; Чонг, Т. К. (1997). «Обнаружение дефектных состояний, ответственных за ток утечки в ультратонких пленках пятиокиси тантала (Ta [sub 2] O [sub 5]), методом спектроскопии термостимулированного тока с нулевым смещением» ». Письма по прикладной физике. 71 (4): 500. Bibcode:1997АпФЛ..71..500л. Дои:10.1063/1.119590.
- ^ Lau, W. S .; Вонг, К. Ф .; Хан, Тэджун; Сандлер, Натан П. (2006). «Применение термостимулированной токовой спектроскопии с нулевым градиентом температуры и нулевым смещением для определения характеристик сверхтонких диэлектрических пленок с высокой диэлектрической проницаемостью». Письма по прикладной физике. 88 (17): 172906. Bibcode:2006АпФЛ..88q2906L. Дои:10.1063/1.2199590.
- ^ «Получатели премии IEEE Andrew S. Grove Award». Премия IEEE Эндрю С. Гроув. Институт инженеров по электротехнике и электронике. Получено 4 июля 2019.
- ^ Сандху, Гуртей; Доан, Чунг Т. (22 августа 2001 г.). «Аппарат и метод легирования атомного слоя». Патенты Google. Получено 5 июля 2019.
- ^ "Страница технологии кремния Intel 45nm High-k". Intel.com. Получено 2011-11-08.
- ^ «IEEE Spectrum: решение High-k». Архивировано из оригинал на 2007-10-26. Получено 2007-10-25.
- ^ "UltimateLowPower Technology | Advanced Process Technology | Technology | NEC Electronics". Necel.com. Архивировано из оригинал на 2010-02-19. Получено 2011-11-08.
дальнейшее чтение
- Обзорная статья автор Wilk и другие. в Журнал прикладной физики
- Хоусса, М. (ред.) (2003) High-k диэлектрики Институт Физики ISBN 0-7503-0906-7 CRC Press Online
- Хафф, Х.Р., Гилмер, округ Колумбия (ред.) (2005) Материалы с высокой диэлектрической постоянной: приложения VLSI MOSFET Springer ISBN 3-540-21081-4
- Демков А.А., Навроцкий А. (Ред.) (2005) Материалы Основы затворных диэлектриков Springer ISBN 1-4020-3077-0
- «Оксиды затвора с высокой диэлектрической проницаемостью для металлооксидных Si-транзисторов» Робертсон, Дж. (Rep. Prog. Phys. 69 327-396 2006) Издательство Института Физики Дои:10.1088 / 0034-4885 / 69/2 / R02 Оксиды затвора с высокой диэлектрической постоянной]
- Освещение в СМИ объявлений Intel / IBM в марте 2007 г. BBC NEWS | Технологии | Чипы проталкиваются через нанобарьер, Статья NY Times (27.01.07)
- Гусев, Е. П. (ред.) (2006) "Дефекты в диэлектрических стеках с высоким k затвором: наноэлектронные полупроводниковые устройства", Springer ISBN 1-4020-4366-X


