Плазменное травление - Plasma etching
Эта статья нужны дополнительные цитаты для проверка. (Декабрь 2008 г.) (Узнайте, как и когда удалить этот шаблон сообщения) |
Плазменное травление это форма плазменная обработка используется для изготовления интегральные схемы. Он включает в себя высокоскоростной поток тлеющего разряда (плазма ) соответствующей газовой смеси, обстреливаемой (импульсами) по образцу. Источник плазмы, известный как частицы травления, может быть заряжен (ионы ) или нейтральный (атомы и радикалы ). Во время процесса плазма генерирует летучие продукты травления при комнатной температуре из химические реакции между элементами протравленного материала и реактивными частицами, генерируемыми плазмой. В конце концов, атомы элемента выстрела встраиваются в поверхность мишени или чуть ниже нее, таким образом изменяя физические свойства цели.[1]
Механизмы
Генерация плазмы
Плазма - это высокоэнергетическое состояние, в котором может происходить множество процессов. Эти процессы происходят из-за электронов и атомов. Для образования плазмы электроны должны быть ускорены, чтобы получить энергию. Электроны с высокой энергией передают энергию атомам путем столкновений. Из-за этого столкновения могут произойти три разных процесса:[2][3]
В плазме присутствуют различные частицы, такие как электроны, ионы, радикалы и нейтральные частицы. Эти виды постоянно взаимодействуют друг с другом. Плазменное травление можно разделить на два основных типа взаимодействия:[4]
- генерация химических веществ
- взаимодействие с окружающими поверхностями
Без плазмы все эти процессы происходили бы при более высокой температуре. Существуют разные способы изменить химический состав плазмы и получить различные виды плазменного травления или плазменного осаждения. Одним из методов возбуждения для образования плазмы является использование высокочастотного возбуждения источника питания с частотой 13,56 МГц.
Режим работы плазменной системы изменится при изменении рабочего давления. Кроме того, он отличается для разных конструкций реакционной камеры. В простом случае структура электрода симметрична, и образец помещается на заземленный электрод.
Влияния на процесс
Ключом к разработке успешных сложных процессов травления является поиск подходящего химического состава газового травления, при котором образуются летучие продукты с материалом, подлежащим травлению, как показано в таблице 1.[3] Для некоторых сложных материалов (например, магнитных материалов) летучесть может быть достигнута только при повышении температуры пластины. Основные факторы, влияющие на плазменный процесс:[2][3][5]
- Источник электронов
- Давление
- Виды газа
- Вакуум
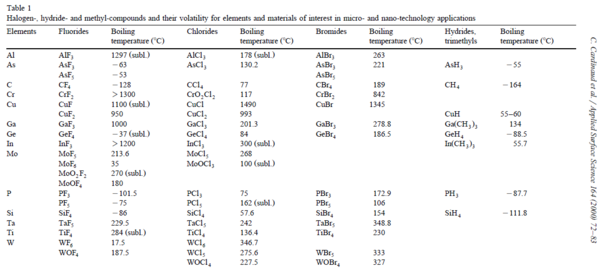
Поверхностное взаимодействие
Реакция продуктов зависит от вероятности реакции разнородных атомов, фотонов или радикалов с образованием химических соединений. Температура поверхности также влияет на реакцию продуктов. Адсорбция происходит, когда вещество способно собираться и достигать поверхности в конденсированном слое различной толщины (обычно это тонкий окисленный слой). Летучие продукты десорбируются в плазменной фазе и помогают процессу плазменного травления, поскольку материал взаимодействует с образцом. стены. Если продукты не летучие, на поверхности материала образуется тонкая пленка. Различные принципы, влияющие на способность образца к плазменному травлению:[3][6]
- Волатильность
- Адсорбция
- Химическое сродство
- Ионная бомбардировка
- Распыление
Плазменное травление может изменить углы смачивания поверхности, например, от гидрофильного до гидрофобного или наоборот. Сообщается, что травление аргоновой плазмой увеличивает угол смачивания с 52 до 68 градусов,[7] и травление кислородной плазмой для уменьшения угла смачивания с 52 до 19 градусов для композитов из углепластика для изготовления костных пластин. Сообщалось, что плазменное травление снижает шероховатость поверхности с сотен нанометров до 3 нм для металлов.[8]
Типы
Давление влияет на процесс плазменного травления. Для плазменного травления в камере должно быть низкое давление, менее 100 Па. Для создания плазмы низкого давления газ должен быть ионизирован. Ионизация происходит за счет тлеющего заряда. Эти возбуждения происходят от внешнего источника, который может обеспечивать мощность до 30 кВт и частоты от 50 Гц (постоянный ток), более 5–10 Гц (импульсный постоянный ток) до радио- и микроволновых частот (МГц-ГГц).[2][9]
СВЧ-плазменное травление
Микроволновое травление происходит с источниками возбуждения на микроволновой частоте, то есть между МГц и ГГц. Здесь показан один из примеров плазменного травления.[10]

Травление водородной плазмой
Одной из форм использования газа в качестве плазменного травления является водородное плазменное травление. Следовательно, подобная экспериментальная установка может быть использована:[5]

Приложения
Плазменное травление в настоящее время используется для обработки полупроводниковых материалов с целью их использования в производстве электроники. Небольшие детали могут быть вытравлены на поверхности полупроводникового материала для повышения эффективности или улучшения определенных свойств при использовании в электронных устройствах.[3] Например, плазменное травление можно использовать для создания глубоких канавок на поверхности кремния для использования в микроэлектромеханические системы. Это приложение предполагает, что плазменное травление также может сыграть важную роль в производстве микроэлектроники.[3] Точно так же в настоящее время проводятся исследования того, как процесс можно отрегулировать до нанометрового масштаба.[3]
В частности, травление водородной плазмой имеет и другие интересные приложения. При использовании в процессе травления полупроводников, травление водородной плазмой оказалось эффективным для удаления части природных оксидов, обнаруженных на поверхности.[5] Травление водородной плазмой также имеет тенденцию оставлять чистую и химически сбалансированную поверхность, которая идеально подходит для ряда применений.[5]
Кислородно-плазменное травление может быть использовано для анизотропного глубокого травления алмазных наноструктур путем приложения высокого смещения в реакторе индуктивно-связанной плазмы / реактивного ионного травления (ICP / RIE).[11]. С другой стороны, использование плазмы смещения кислорода 0 В может быть использовано для изотропного поверхностного торцевания поверхности алмаза с концевыми группами C-H.[12]
Смотрите также
Рекомендации
- ^ «Плазменное травление - плазменное травление». oxinst.com. Получено 2010-02-04.
- ^ а б c Маттокс, Дональд М. (1998). Справочник по обработке методом физического осаждения из паровой фазы (PVD). Вествуд, Нью-Джерси: Публикация Нойес.
- ^ а б c d е ж грамм Кардино, Кристоф; Пеньон, Мари-Клод; Тесье, Пьер-Ив (01.09.2000). «Плазменное травление: принципы, механизмы, применение в микро- и нанотехнологиях». Прикладная наука о поверхности. Наука о поверхности в микро- и нанотехнологиях. 164 (1–4): 72–83. Bibcode:2000ApSS..164 ... 72C. Дои:10.1016 / S0169-4332 (00) 00328-7.
- ^ Coburn, J. W .; Уинтерс, Гарольд Ф. (1979-03-01). «Плазменное травление - обсуждение механизмов». Журнал вакуумной науки и технологий. 16 (2): 391–403. Bibcode:1979JVST ... 16..391C. Дои:10.1116/1.569958. ISSN 0022-5355.
- ^ а б c d Чанг, Р. П. Х .; Chang, C.C .; Дарак, С. (1 января 1982 г.). «Водородно-плазменное травление полупроводников и их оксидов». Журнал вакуумной науки и технологий. 20 (1): 45–50. Bibcode:1982JVST ... 20 ... 45C. Дои:10.1116/1.571307. ISSN 0022-5355.
- ^ Coburn, J. W .; Уинтерс, Гарольд Ф. (1979-05-01). «Ионная и электронная химия поверхности газа - важный эффект при плазменном травлении». Журнал прикладной физики. 50 (5): 3189–3196. Bibcode:1979JAP .... 50.3189C. Дои:10.1063/1.326355. ISSN 0021-8979. S2CID 98770515.
- ^ Zia, A. W .; Wang, Y. -Q .; Ли, С. (2015). «Влияние физического и химического плазменного травления на смачиваемость поверхности полимерных композитов, армированных углеродным волокном, для применения в костных пластинах». Достижения в полимерной технологии. 34: н / д. Дои:10.1002 / adv.21480.
- ^ Васи, А .; Балакришнан, Г .; Lee, S. H .; Kim, J. K .; Kim, D.G .; Kim, T. G .; Песня, Дж. И. (2014). «Обработка металлической подложки аргоновой плазмой и влияние на свойства покрытия из алмазоподобного углерода (DLC)». Кристалл исследования и технологии. 49: 55–62. Дои:10.1002 / crat.201300171.
- ^ Буншах, Ройнтан Ф. (2001). Технологии осаждения пленок и покрытий. Нью-Йорк: Публикация Нойес.
- ^ Кейдзо Сузуки; Садаюки Окудаира; Норриюки Сакудо; Ичиро Каномата (11 ноября 1977 г.). «Микроволновое плазменное травление». Японский журнал прикладной физики. 16 (11): 1979–1984. Bibcode:1977ЯЯП..16.1979С. Дои:10.1143 / jjap.16.1979.
- ^ Радтке, Мариуш; Нельц, Ричард; Слаблаб, Абдаллах; Ной, Эльке (2019). «Надежное нано-изготовление монокристаллических алмазных фотонных наноструктур для наномасштабного зондирования». Микромашины. 10 (11): 718. arXiv:1909.12011. Bibcode:2019arXiv190912011R. Дои:10.3390 / mi10110718. PMID 31653033. S2CID 202889135.
- ^ Радтке, Мариуш; Рендер, Лара; Нельц, Ричард; Ной, Эльке (2019). «Плазменная обработка и фотонные наноструктуры для центров мелких вакансий азота в алмазе». Оптические материалы Экспресс. 9 (12): 4716. arXiv:1909.13496. Bibcode:2019arXiv190913496R. Дои:10.1364 / OME.9.004716. S2CID 203593249.
